-
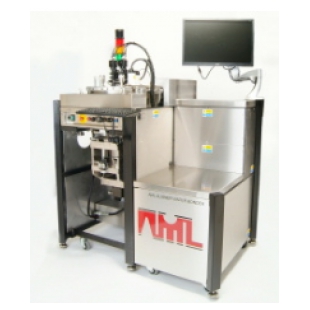
-
英国AML 邦定机AWB 04 & 08 Platform


- 品牌:英国AML
- 型号: AWB 04 & 08 Platform
- 产地:英国
- 供应商报价: 面议
-
深圳市蓝星宇电子科技有限公司
 更新时间:2024-04-22 10:51:12
更新时间:2024-04-22 10:51:12 -
企业性质生产商
入驻年限第6年
营业执照已审核
- 同类产品邦定机(1件)
联系方式:廖敬强0755-81776600
联系我们时请说明在仪器网(www.yiqi.com)上看到的!
-
为您推荐
- 详细介绍
AWB具有执行对齐功能:
阳极,共晶,直接(高温和低温)玻璃熔块,粘合剂,焊料和热压晶片焊接。
新的“无粘合剂”临时粘接
在一台机器上对中和粘接
In-situ 对齐 accuracy. 1 微米
10-6mbar Vacuum 2 条 过程 ?特高压选项
Voltage 2.5 kV.
Temperature 560 ° C.
Forces 40 kN.
结合 周期 / 高 throughput. Market 领xian 快
2 “ 8 ". Wafer 大小
In-situ UV cure.
自动PC控制和数据采集
实时控制所有键参数或全自动配方。所有的键合参数,如电流、电压、集成电荷、温度、室压、力、晶圆分离、运行参数、配方、SPC晶圆批号、事件日志等,都自动存储在文件中,用于图形绘制和趋势分析。机器也可以联网,并由AML远程询问,以帮助发现故障。全自动配方,包括在生产环境中自动对齐除雾操作。
对齐方式:
手动和自动对齐。原位对齐比其他焊接(在粘结室外进行对齐)具有优势。'一键'对齐和键合。可见光和红外光谱。广泛间隔的三维对齐标记的图像捕获。
校准可进行热或冷:
这消除了由于热膨胀和晶圆片、机器部件和压板之间的不匹配而导致的对准误差。
大晶片分离:
允许晶圆片之间存在较大的温差,这是通过工艺气体(如成形气体)更好地活化或原位氧化还原晶圆片的理想选择。也允许快速,高真空和良好定义的焊接环境。
现场系统:
还可以在粘接过程之前直观地确认所需的对齐仍在进行中。
晶片尺寸:
2 ", 3", 4", 5 ", 6 "和8 "。(芯片和形状奇怪的基板,但没有对齐)。
机械手:
使晶圆片在真空和高温下能够原位对准。
接触力:通过手动或电动液压提供,最大可达40kN。
精密晶圆平行度调整。
1μm对准精度。
光学:
双显微镜-通过镜头照明的照相机系统。两个CCD相机并排显示图像。包括红外功能。同时显示晶圆片的分离力和键合力,实现对中控制。
成键
环境:
真空,或工艺气体。全自动干式涡轮泵送系统~ 1x10- 6mbar至2bar绝 对压力。特高压选项
温度:
上下压板均可独立调节,在1°C的步骤。加热和冷却速度可编程。zui高温度是560℃。
电极(阳极键合):
全尺寸加热板,用于上下电极,以获得更好的粘结均匀性。0-2.5千伏直流可达40毫安。恒流或恒压运行,改善过程控制和应力管理。
AWB-04可以粘合3到6英寸的晶圆片和芯片
AWB-08可以粘合6英寸和8英寸的晶片
其他选项:
Auto alignment.
Triple 堆栈 结合 tool.
Powered lid.
Pressure control.
CMOS compatible.
High 精度 系统 1 μm alignment.
低温 激活 bonding. RAD 工具
In-situ UV Cure.
Motorised X, Y, Ǿ & Z movement.
Image capture.
Process support.
AML - AWB 04 & 08 Platform
The AWB has the versatility to perform aligned:
Anodic, Eutectic, Direct (High & Low Temperature) Glass frit, Adhesive, Solder & Thermo-compression wafer bonding.
New 'Adhesive free' temporary Bonding
Alignment & bonding in one machine
In-situ alignment 1 micron accuracy.
10-6mbar Vacuum to 2bar process gas. UHV Option
Voltage up to 2.5kV.
Temperature up to 560° C.
Forces up to 40kN.
Market leading fast bonding cycle times / high throughput.
Wafer sizes 2"- 8".
In-situ UV cure.
Automatic PC Control & Data acquisition
Live control of all bond parameters or fully automated recipes. All the bonding parameters e.g. current, voltage, integrated charge, temperature, chamber pressure, force, wafer separation, run parameters, recipes, wafer batch No for SPC and event logs are automatically stored in files for graph plotting and trend analysis. Machines can also be networked and remotely interrogated by AML to aid fault finding. Fully automatic recipe, including auto alignment to deskill operation in a production environment.
Alignment:
Manual and auto alignment. In-situ alignment has advantages over other bonders (where alignment is made outside the bond chamber).‘One click’ align and bond. Visible and IR. Image capture for widely spaced 3D alignment marks.
Alignment can be carried out hot or cold:
This eliminates alignment inaccuracies due to thermal expansion & mismatch between wafers, machine parts & platens.
Large wafer separation:
Allows large temperature difference between wafers – ideal for better activation or in-situ oxide reduction via process gas e.g. forming gas. Also allows fast, high vacuum & well defined bonding environment.
In-situ system:
Also enables visual confirmation just before the bonding process that the desired alignment is still being achieved.
Wafer sizes:
2”, 3", 4", 5”, 6” & 8”. (Also chips & odd shaped substrates, but without alignment).
Manipulator:
Enables in-situ alignment of wafers under vacuum and at elevated temperature.
Contact force: up to 40kN provided via manual or motorised hydraulics.
Precise wafer parallelism adjustment.
Alignment accuracy 1 μm.
Optics:
Twin Microscope – camera system with throughthe-lens illumination. Two CCD cameras and side-by-side display of images. Including IR capability. Simultaneous display of wafer separation & bonding force for complete alignment control.
Bonding
Environment:
Vacuum, or process gas. Fully automated dry turbo pumping system ~ 1x10-6 mbar to 2bar absolute pressure. UHV option
Temperature:
Both Upper & Lower Platens independently adjustable in 1 °C steps. Heating & Coo领 rates are programmable. Max Temperature is 560°C.
Electrodes:(for Anodic Bonding)
Full size heated platens for both upper andlower electrodes for better bond uniformity. 0-2.5 kV DC up to 40 mA. Constant current or voltage operation, for improved process control & stress management.
The AWB-04 can bond 3” to 6” wafers and chips
The AWB-08 can bond 6” and 8” wafers
Additional Options:
Auto alignment.
Triple stack bonding tool.
Powered lid.
Pressure control.
CMOS compatible.
High accuracy system for 1μm alignment.
RAD tool for low temperature activated bonding.
In-situ UV Cure.
Motorised X, Y, Ǿ & Z movement.
Image capture.
Process support.- 产品优势
- 实时控制所有键参数或全自动配方。所有的键合参数,如电流、电压、集成电荷、温度、室压、力、晶圆分离、运行参数、配方、SPC晶圆批号、事件日志等,都自动存储在文件中,用于图形绘制和趋势分析。机器也可以联网,并由AML远程询问,以帮助发现故障。全自动配方,包括在生产环境中自动对齐除雾操作。
-
 英国Nanobean NB5 电子束光刻机
英国Nanobean NB5 电子束光刻机
-
 英国Oxford 反应离子刻蚀机PlasmaPro 800 RIE
英国Oxford 反应离子刻蚀机PlasmaPro 800 RIE
-
 英国HHV科研用真空镀膜系统 Auto500,Ats500
英国HHV科研用真空镀膜系统 Auto500,Ats500
-
 实验室纯水|实验室超纯水系统OmniaPure专家-英国普拉勒
实验室纯水|实验室超纯水系统OmniaPure专家-英国普拉勒
-
 英国普拉勒实验室纯水 OmniaTap
英国普拉勒实验室纯水 OmniaTap
-
 英国普拉勒实验室纯水 OmniaLabED 20
英国普拉勒实验室纯水 OmniaLabED 20
-
 英国普拉勒实验室纯水 OmniaLabED 40
英国普拉勒实验室纯水 OmniaLabED 40
-
 英国爱丁堡仪器科研级定制化显微共焦拉曼光谱RMS1000
英国爱丁堡仪器科研级定制化显微共焦拉曼光谱RMS1000
-
 英国普拉勒全能型实验室纯水 OmniaTap UV
英国普拉勒全能型实验室纯水 OmniaTap UV
-
 英国普拉勒实验室纯水 OmniaLabUP20
英国普拉勒实验室纯水 OmniaLabUP20
-
 英国普拉勒大容量实验室纯水系统 OmniaLab RO20
英国普拉勒大容量实验室纯水系统 OmniaLab RO20
-
 英国普拉勒实验室纯水 OmniaLabUP40
英国普拉勒实验室纯水 OmniaLabUP40