PECVD原理及应用
PECVD(Plasma Enhanced Chemical Vaper Deposition)是等离子增强化学气相淀积,该技术是在低气压下,利用低温等离子体在工艺腔体的阴极上(即样品放置的托盘)产生辉光放电,利用辉光放电(或另加发热体)使样品升温到预定的温度,然后通入适量的工艺气体,这些气体经一系列化学反应和等离子体反应,最终在样品表面形成固态薄膜。
所谓等离子体,是指气体在一定条件下受到高能激发,发生电离,部分外层电子脱离原子核,形成电子、正离子和中性粒子混合组成的一种形态,这种形态就称为等离子态。
PECVD的工艺原理:在反应过程中,反应气体从进气口进入炉腔,逐渐扩散至样品表面,在射频源激发的电场作用下,反应气体分解成电子、离子和活性基团等。这些分解物发生化学反应,生成形成膜的初始成分和副反应物,这些生成物以化学键的形式吸附到样品表面,生成固态膜的晶核,晶核逐渐生长成岛状物,岛状物继续生长成连续的薄膜。在薄膜生长过程中,各种副产物从膜的表面逐渐脱离,在真空泵的作用下从出口排出。
首先,在非平衡等离子体中,电子与反应气体发生初级反应,使得反应气体发生分解,形成离子和活性基团的混合物;其次,各种活性基团向薄膜生长表面和管壁扩散运输,同时发生各反应物之间的次级反应;最后,达到生长表面的各种初级反应和次级反应产物被吸附并与表面发生反应,同时伴随有气相分子物的再放出。
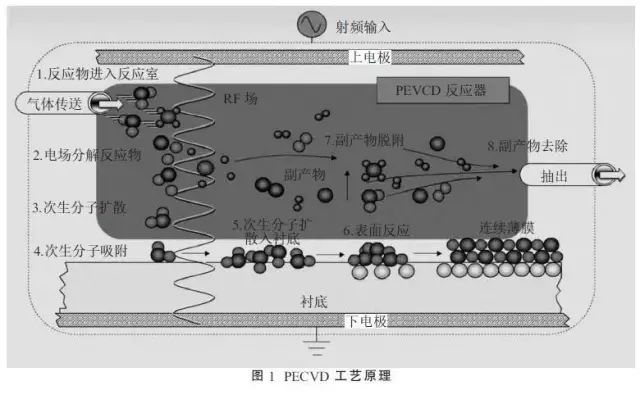
PECVD的优势:
1、基本温度低(300-500°C);
2、沉积速率快;
3、成膜质量好,针孔少,不易龟裂
PECVD设备的基本结构:
PECVD设备主要由真空和压力控制系统、淀积系统、气体及流量控制、系统安全保护系统、计算机控制等部分组成。其设备结构框图如图2所示。
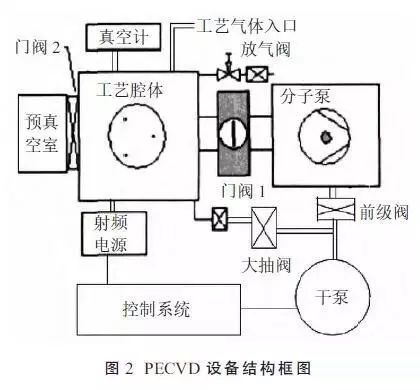
1、真空和压力控制系统
真空和压力控制系统包括机械泵、分子泵、粗抽阀、前级阀、闸板阀、真空计等。为了减少氮气、氧气以及水蒸气对淀积工艺的影响,真空系统一般采用干泵和分子泵进行抽气,干泵用于抽低真空,与常用的机械油泵相比,可以避免油泵中的油气进入真空室污染基片。在干泵抽到一定压力以下后,打开闸板阀,用分子泵抽高真空。分子泵的特点是抽本体真空能力强,尤其是除水蒸汽的能力非常强。
2、淀积系统
淀积系统由射频电源、水冷系统、基片加热装置等组成。它是PECVD的核心部分。射频电源的作用是使反应气体离子化。水冷系统主要为PECVD系统的机械泵、罗茨泵、干泵、分子泵等提供冷却,当水温超过泵体要求的温度时,它会发出报警信号。冷却水的管路采用塑料管等绝缘材料,不可用金属管。基片加热装置的作用使样品升温到工艺要求温度,除掉样品上的水蒸气等杂质,以提高薄膜与样品的附着力。
3、气体及流量控制系统
PECVD系统的气源几乎都是由气体钢瓶供气,这些钢瓶被放置在有许多安全保护装置的气柜中,通过气柜上的控制面板、管道输送到PECVD的工艺腔体中。
在淀积时,反应气体的多少会影响淀积的速率及其均匀性等,因此需要严格控制气体流量,通常采用质量流量计来实现精确控制。
影响工艺的因素:
影响PECVD工艺质量的因素主要有以下几个方面:
1、极板间距和反应室尺寸
PECVD腔体极板间距的选择要考虑两个因素:
(1)起辉电压:间距的选择应使起辉电压尽量低,以降低等离子电位,减少对衬底的损伤。
(2)极板间距和腔体气压:极板间距较大时,对衬底的损伤较小,但间距不宜过大,否则会加重电场的边缘效应,影响淀积的均匀性。反应腔体的尺寸可以增加生产率,但是也会对厚度的均匀性产生影响。
2、射频电源的工作频率
射频PECVD通常采用50kHz~13.56MHz频段射频电源,频率高,等离子体中离子的轰击作用强,淀积的薄膜更加致密,但对衬底的损伤也比较大。高频淀积的薄膜,其均匀性明显好于低频,这时因为当射频电源频率较低时,靠近极板边缘的电场较弱,其淀积速度会低于极板中心区域,而频率高时则边缘和中心区域的差别会变小。
3、射频功率
射频的功率越大离子的轰击能量就越大,有利于淀积膜质量的改善。因为功率的增加会增强气体中自由基的浓度,使淀积速率随功率直线上升,当功率增加到一定程度,反应气体完全电离,自由基达到饱和,淀积速率则趋于稳定。
4、气压
形成等离子体时,气体压力过大,单位内的反应气体增加,因此速率增大,但同时气压过高,平均自由程减少,不利于淀积膜对台阶的覆盖。气压太低会影响薄膜的淀积机理,导致薄膜的致密度下降,容易形成针状态缺陷;气压过高时,等离子体的聚合反应明显增强,导致生长网络规则度下降,缺陷也会增加。
5、衬底温度
衬底温度对薄膜质量的影响主要在于局域态密度、电子迁移率以及膜的光学性能,衬底温度的提高有利于薄膜表面悬挂键的补偿,使薄膜的缺陷密度下降。
衬底温度对淀积速率的影响小,但对薄膜的质量影响很大。温度越高,淀积膜的致密性越大,高温增强了表面反应,改善了膜的成分。
PECVD等离子增强化学气相沉积应用:
等离子诱导表面改性:就是通常所说的用等离子实现表面改性(如亲水性、疏水性等)
等离子清洗:去除有机污染物
等离子聚合:对材料表面产生聚合反应
沉积二氧化硅(SiO2)、氮化硅(Si3N4)、DLC(类金刚石),以及其它薄膜
CNT(碳纳米管)和石墨烯的选择性生长:在需要的位置生长CNT或石墨烯
PECVD经典应用:
PECVD的经典应用之一是在晶体硅太阳能电池上沉积SiNx减反射薄膜,可以充分吸收太阳光,降低反射,并且氮化硅膜有钝化的作用,保护电池片不受污染。
1、减反射
利用光的干涉原理,通过调整膜厚与折射率,使得R1与R2相消干涉,达到减反射的目的。要达到此目的,对膜厚和折射率的要求如下:
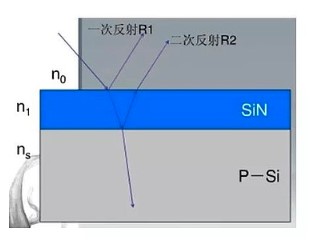

2、钝化
由于生成的氮化硅薄膜含有大量的氢,可以很好的钝化硅中的位错、表面悬挂键,从而提高了硅片中载流子迁移率,一般要提高20%左右,同时由于SiN薄膜对单晶硅表面有非常明显的钝化作用。
面钝化的主要作用是保护半导体器件表面不受污染物质的影响,表面钝化可降低表面态密度。
体钝化在SiN减反射膜中存在大量的H,在烧结过程中会钝化晶体内部悬挂键。
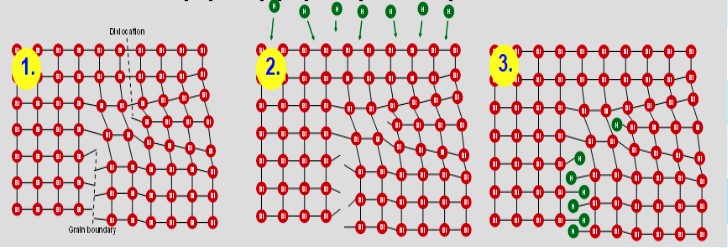
求: 压力传感器的基本工作原理、应用 和设计 方面的资料 谢谢 !
氧化诱导时间测试仪是一种用于测定高分子材料氧化诱导时间的仪器。该仪器通过测量材料在高温氧化环境中诱导期的时间
低场核磁共振技术与应用概述1. 什么是低场核磁共振;核磁共振仪器按磁场强度可分为以下几类:>
举出至少4中PCR技术的原理及应用。 不要只说出名字,我要原理和应用 谢谢 Z好当作考试回答。。100
气体渗透测试属于材料的阻隔性能检测。主要分为对气体(氧气、氮气、二氧化碳等)透过率测试与水蒸气透过率测试这两
伟业计量线上研讨会,老时间,老地方,每周五上午九点半伟业计量直播间来相见! 2021年
昊量光电邀您参加2022年01月19日锁相放大器工作原理及应用和Moku产品介绍网络研讨会。由Liquid I
电解池如何区分阴阳极,工作原理,有何应用 这个看电源的电极,与正极链接的是阳极,与负极链接的是阴极。 工
要求是:详细介绍瞬间变电磁法得原理,Z好教授发表的论文,做到图文并茂,有计算公式。在应用方面,列举一两个实
热重分析仪(ThermoGravimetricAnalyzer)是一种利