

TEM 制样方法中:FIB制样的优势和缺陷
01 TEM 制样方法概述
透射电子显微镜能够精细地观察样品的结构,甚至可以观察到仅由一列原子构成的结构。其分辨率比光学显微镜高出许多,可达到 0.1~0.2 nm,放大倍数可达几万至百万倍,使得我们能够深入研究并理解样品的微观结构和特性。

透射电镜工作原理
TEM 的测试原理是利用透过样品的电子进行成像和结构分析,由于电子的穿透能力较弱,样品的厚度、导电性、磁性和分散性等特征对测试结果的好坏起到直接的影响。因此,透射电镜的制样更加复杂和精细。
TEM 的制样原则是:简单、不破坏样品表面、获得尽量大的可观测薄区。常用的制样方法分可分为粉末样品制样法和块状样品制样法。
粉末样品的制样方法可分为:溶液分散-滴落法,胶粉混合法。
块状样品的制备方法可分为:树脂包埋法,机械减薄法,超薄切片法,离子减薄法,电解抛光减薄法,聚焦离子束切割法(FIB)。
其中,聚焦离子束(Focused ion beam milling, FIB)扫描电镜双束系统是在 SEM 的基础上增加了聚焦离子束镜筒的双束设备,使用 FIB-SEM 切割薄片是获取TEM 样品的一种非常常用手段。
02 FIB 制样方式介绍
2.1 FIB 制样原理及优势
FIB 制样的原理是利用电透镜将离子源(大多数 FIB 都用镓(Ga),也有设备具有氦(He)和氖(Ne)离子源)产生的离子束经过离子枪加速,聚焦后作用于样品表面,实现样品材料的铣削、沉积、注入和成像。将扫描电子显微镜(SEM)与 FIB 集成为一个系统,可充分发挥各自的优点,加工过程中可利用电子束实时监控样品加工进度,从而更好的控制加工精度,成为了纳米级分析、制造的主要方法。
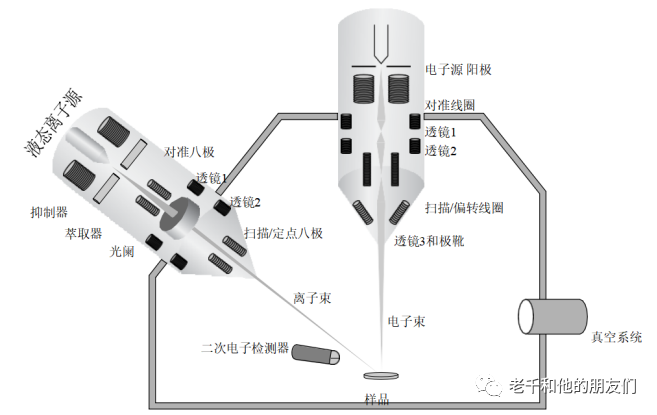
FIB 结构示意图,图片来源于公众号:老千和他的朋友们
2.2 FIB 制样缺陷
尽管 FIB 系统在样品制备中有其优势,但也存在一些值得注意的缺点。特别是,使用离子束时可能会引起一些意想不到的样品损伤,改变了样品表面的特性。举例来说,在 30 kV 的镓离子束作用下,大部分材料表面约 30 nm 深度范围内都会受到镓注入的影响,这会导致原本存在的原子结构被改变或者破坏。
这样的非晶层或损伤层在使用 FIB 系统制备的 TEM 样品中非常明显,可能会影响到最终的观察结果。因此,研究人员在使用 FIB 制样时需要特别关注和考虑这种潜在的损伤效应,并采取措施来较大程度地保留样品的原始结构和特性。

FIB 制样后产生的损伤层(非晶层)
2.3 FIB 制样缺陷解决方案
FIB 制样诱导的非晶层的深度取决于射束能量、射束角度和被研磨的材料,通常用于减少 TEM 样品中的这种非晶层损伤有下列几种技术:
1.气体辅助蚀刻:虽然提高了研磨速率,但是增加了结晶-非晶界面的粗糙度,这会进一步损害了 TEM 图像;
2.低能量 FIB:在这些能量下蚀刻速率和位置的分辨率会受到影响,但是束能量的减少可以使损伤深度最小化;
3.氩离子研磨精修:原始的 FIB 损伤层,可以通过氩离子精修去除,去除的效果取决于氩离子的能量,角度和时间。
本文主要介绍 TEM 制样中常用的 FIB 聚焦离子束制备方法,探讨了其难以避免的非晶层生成问题,如何解决FIB制样中的非晶层生成问题呢?
下一篇我们主要介绍通过氩离子精修仪和低能离子枪(LEG to FIB)两种技术来修复非晶层问题的解决方案。
本文提出了一种高通量方法,该方法根据EPA 200.8评估饮用水中的26种元素。通过使用与NexION ICP-
水是生命之源,占人体的80%。由于污染和土地干扰的增加,大量潜在有害元素被转移到饮用水源中,例如河流、湖泊和
网格压痕是一种适用于多种多相材料的特殊纳米压痕技术,但是此方法非常耗时,它需要进 . 行很 多的压痕测试。An
本实验采用Clarus SQ 8T GC/MS系统的EI模式实现。表1中.给出了实验条件.重现了EPA 8270D方
溴酸盐是公共饮用水体系经臭氧消毒产生的一类无机消毒副产物 .研究表明 ,当人终生饮用含5 0 g•
离子色谱法在测定饮用水中痕量溴酸盐标准方法中的应 用 刘勇建 牟世芬 (ZG科学院生态环境研究ZX,Dio
微波加热萃取法:1984 and 1986先驱者Ganzler, Bati 和Valko发表了**篇有关微波
北京谱朋科技有限公司是一家服务于实验室分析仪器领域内设备及备品配件的高科技公司公司秉承着专业诚信值得信赖的经
公司地址:厦门软件园二期望海路23号成立日期:2002年1月18日企业性质:留学人员创业企业,高新技术企业,