自3月18日起,赛默飞“XPS系列网络讲座”连续开讲,每周一个新领域,听赛家应用工程师为您解析赛默飞XPS系列产品的不同精彩。
“XPS表面分析技术在能源电池和环境材料表征中的应用”&“ XPS表面分析技术在半导体器件表征中的应用”,现已在众多听者的积极参与下,wan美落幕。赛默飞“XPS系列网络讲座”4月课程还将火热进行,请您持续关注!


“XPS系列网络讲座”前两讲课件部分内容
But!
这么的线上讲座
已经错过2场了
怎么办?
不用急!
干货提炼+精彩回放看这里!
先让我们来看看在线听众的11条答疑汇总,快!
知识点get起来!图文详解!超全实用!
1
Q:
①XPS设备是否都具备深度剖析功能?
②怎么得到不同材料相对准确的刻蚀速率参数?
③深度剖析时,怎么相对准确的得到不同材料的刻蚀深度?
①目前,商业化的XPS设备都有深度剖析功能,这是XPS设备的一个基本功能。目前,赛默飞在售的K-ALPHA、NEXSA、ESCALAB Xi+三款XPS设备,都有深度剖析功能,可很好满足深度剖析测试需求。
②不同材料做深度剖析测试时,通常得到的是不同元素及其化学态随刻蚀时间的变化图;刻蚀时间越长,代表刻蚀深度越深,如下图所示。

在不清楚对应材料刻蚀速率参数情况下,不建议将深度剖析数据转换成不同元素及其化学态随刻蚀深度的变化图;否则,转化的深度数据不能代表样品实际的深度,没有参考意义,反而对数据分析造成困扰。
那么如何得到不同材料相对准确的刻蚀速率参数呢?可从以下两个方面着手:
a).对于有条件的实验室,可制备已知厚度的标样。在某一刻蚀参数下进行深度剖析测试。刻蚀完成后,记录刻蚀时间,就可得到刻蚀速率参数。比如,制备一个100nm厚的标样,在某一刻蚀参数下,刻蚀400s将100nm刻蚀掉,那么此材料对应的刻蚀速率为0.25nm/s。此方法操作起来相对复杂,但得到刻蚀速率参数相对准确。
b).实验室条件有限,制备已知厚度标样困难,可通过其它表征手段,比如,电镜、卢瑟福背散射(RBS)等方法得到材料厚度信息。然后,在某一刻蚀参数下进行深度剖析。刻蚀完成后,记录刻蚀时间,就可得到刻蚀速率参数。
③a).首先需要得到对应材料相对准确的刻蚀速率参数。如何得到此参数?可参考上一问答案。
b).得到材料刻蚀速率参数后,如何将深度剖析数据转换成不同元素及其化学态随刻蚀深度的变化图,得到样品相对准确深度信息?通过赛默飞专业XPS数据处理软件Avantage,可实现一键转换,操作简单快捷,如下图所示。
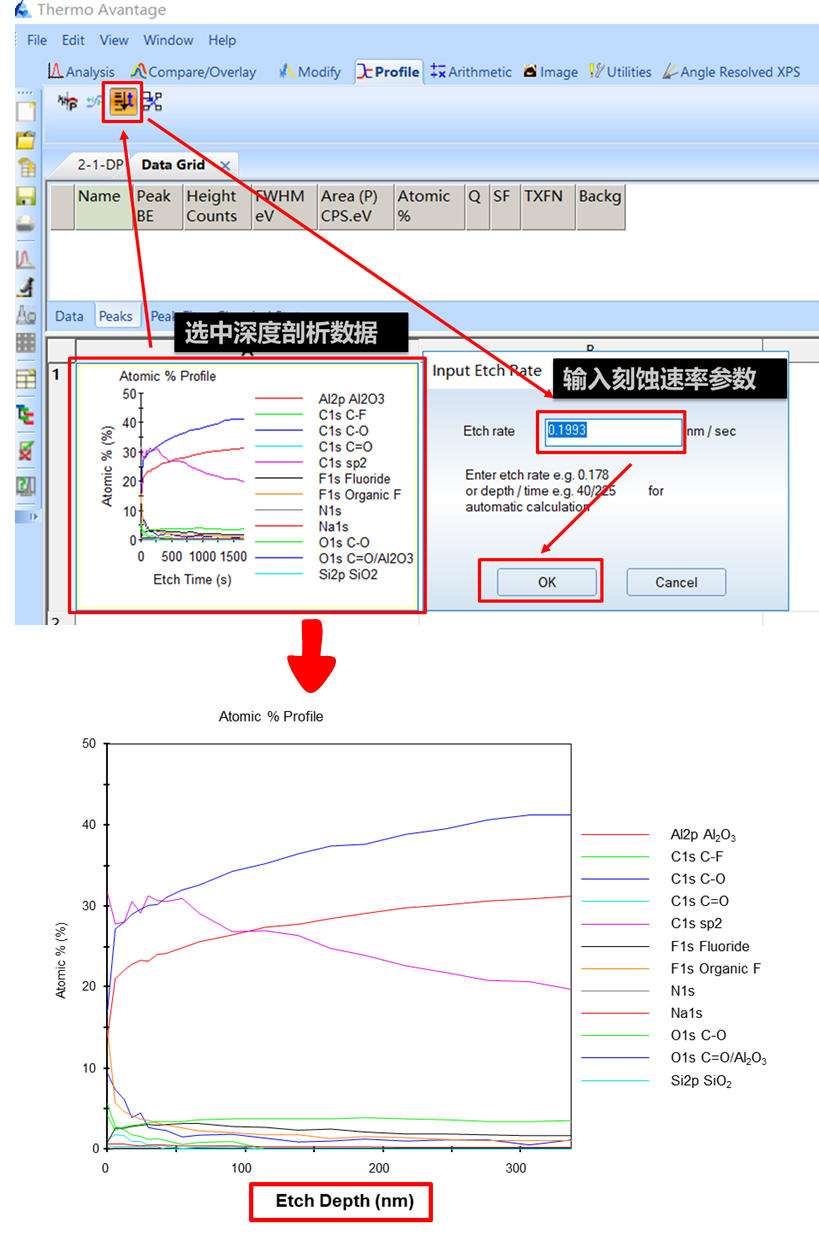
2
Q:
①一些金属氧化物,采用单粒子模式刻蚀会存在将金属氧化物还原现象。对于同时含有金属氧化物和单质态这类型样品,在刻蚀时怎么准确得到氧化态和单质态相对含量?
②含磁性元素的样品,进行深度剖析测试对仪器有损害吗?
①对于一些金属氧化物,采用单粒子模式的离子枪进行刻蚀时,由于单粒子模式离子枪能量较高,在刻蚀过程中存在溅射还原效应,会将金属氧化物还原。所以,对于同时含有金属氧化物和单质态类型样品,单粒子模式离子枪进行刻蚀时,可能会存在溅射还原,就不能准确得到氧化态和单质态相对含量变化信息。在深度剖析时,单粒子模式离子枪不合适。
那么,对于这类型的样品能否进行深度剖析测试?答案是肯定的!
如果设备配备有团簇模式离子枪,采用团簇模式的离子枪进行刻蚀,可解决这个问题,能够准确地获得氧化态和单质态相对含量变化的信息。由于团簇模式离子枪单粒子能量较小,刻蚀过程中对样品损伤小,减少了溅射还原效应,比较适合金属氧化物、有机材料样品刻蚀。
②对于含磁性元素样品的深度剖析,要分以下三个情况来处理:
a).含磁性元素的样品不一定有磁性,样品没磁性。对于这类样品可以正常测试,测试过程中不会损伤仪器。
b).含磁性元素的样品具有弱磁性。对于这类样品,制样时需要对样品进行消磁处理,消磁后将样品粘牢实,就可以进行正常测试,测试过程中同样也不会损伤仪器。
c).含磁性元素的样品具有强磁性。对于这类样品,不建议进行测试。消磁处理消不掉样品本身的磁性,测试过程中样品自身的磁场会影响出射光电子,进而影响测试谱图。
3
Q:
请问固体粉末材料怎样做深度剖析?
对于固体粉末材料深度剖析,要分以下两个情况来处理:
a)如果粉末材料颗粒度较大,X射线束斑能聚焦到单个颗粒物上,可以进行深度剖析测试。
b)如果粉末材料颗粒度较小,X射线束斑不能聚焦到单个颗粒物上,进行深度剖析测试意义不大,不建议进行深度剖析测试。由于粉末为堆叠状态,样品表面不密实平整,这也使粉末样品吸附更多污染碳成分;同时,深度剖析测试中,X射线束斑照射区域可能会有多个颗粒物,不同颗粒情况不同、颗粒间还存在空隙且随着刻蚀的进行堆叠在下面的新颗粒可能会重新露出了。这些因素使得到深度剖析的结果不能反映粉末颗粒中元素变化的情况,反而会起到误导作用。
综上,对于粉末材料,通常其颗粒较小,不建议进行深度剖析测试。深度剖析测试通常适用于薄膜、固体、金属等类型样品。
4
Q:
怎样从Avantage软件中找标准物质的XPS数据?
(同问:请问Avantage软件中有Li到U元素组成的常见化合物的标准数据吗?如果有的话在哪里能找到呢?)
为了方便用户快速上手XPS数据分析,赛默飞专业XPS数据处理软件Avantage中集成了一个独有的Knowledge View数据库,用户数据分析时可随时调用。具体调用操作如下图所示。

对于参考数据,如果没有Avantage软件,也可以参考赛默飞在线数据库https://xpssimplified.com/elements/zinc.php以及https://srdata.nist.gov/xps/selEnergyType.aspx(NIST数据库),不仅仅给出简单的结合能信息,还有更多的图谱讲解。
5
Q:
对于复杂谱图NLLSF拟合,收集标样的参考谱图,因标样情况、仪器状态及采集条件不同,会使采集标样峰形、峰位会有差异,怎么把标样参考谱图加入复杂图谱中进行拟合呢?
对于复杂谱图的分析拟合,赛默飞专业XPS数据处理软件Avantage中集成了一个特有拟合功能—非线性Z小二乘拟合(NLLSF),能取得较好拟合效果。具体怎么把标样参考谱图加入复杂图谱中进行拟合,我们有一篇专门的小文章介绍如何进行NLLSF拟合。大家可以扫描下面二维码进行学习了解。

6
Q:
请问做ARXPS的时候,是如何将角度与深度关联的?可以在软件里直接完成吗?
赛默飞专业XPS数据处理软件Avantage,可很好的完成对ARXPS数据分析处理。通过软件中集成的ARXPS数据处理功能来实现,完成角度和深度的关联。简单的转化过程,如下图所示:

详细的操作步骤,Avantage软件中有详细介绍,可按下图步骤进行学习。
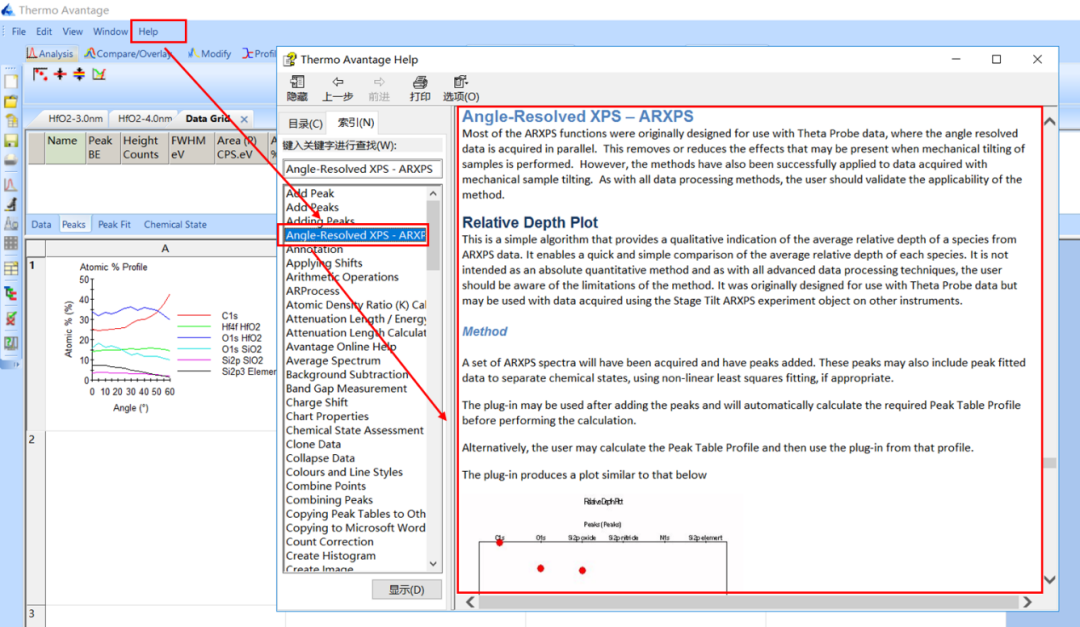
7
Q:
对于聚丙烯酸酯材料,怎么判断C元素窄扫谱图中C-C、C-O、C=O等不同价态C有多少来自C污染,有多少来自材料本身?
对于聚丙烯酸酯材料,接触空气吸附的污染C成分通常表现为C-C、C-O、C=O等价态形式,这就与聚丙烯酸中不同价态C谱图重合。由于材料污染程度无法判断,这就给判断材料中不同价态C有多少来自材料本身,有多少来自污染C带来困难。对于此情况,可通过除去材料表面污染C成分,来得到材料中不同价态相对准确C含量信息,可从以下两个方面着手除去材料表面污染C成分:
a)用新鲜制备的样品进行测试。Z好将制备好的新鲜样品在惰性气氛中保护,尽快放进设备进行测试,这样能在一定程度减少空气中污染C成分的影响。
b)聚丙烯酸材料为有机物材料,如果设备配有团簇模式离子枪,可选择缓和的团簇模式对样品表面清洁,将材料表面的污染成分去除掉,可排除污染C成分对材料中不同价态C的影响。此方式除去材料表面污染C成分的效果Z好。
8
Q:
C的校正,现在有文章指出不同环境下C 1s的位置会移动。那么现在有更可靠的校正方法吗?
对于谱图的荷电校正,通常选择污染碳来进行校正。这是因为暴露在大气中样品表面一般都会吸附一些污染碳,污染碳的化学态(C-C键)比较稳定。对于您所说的C1s位置的移动,要结合样品实际情况来分析,可能是因为样品表面C元素处在不同价态,使其结合能发生变化,导致其位置移动;而样品表面吸附的污染C成分比较稳定,其结合能不会发生变化。
具体来说,荷电校正选择C进行校正,根据样品的材料,可分以下两种情况:
①对于非碳材料样品,暴露在大气中样品的表面一般都会吸附一些污染碳,污染碳吸附的厚度一般为1~2nm。这些污染碳的化学态(C-C键)比较稳定,所以在校正时一般以污染碳来作为参考标准,污染碳的结合能(Binding Energy)一般为284.8ev。谱图拟合完后,计算C元素谱峰Z右边C-C峰位与284.8ev的差值,以此差值为基准,完成C元素和其它元素的校正。
②对于一些含有sp2杂化碳(C=C)的碳材料样品,比如石墨、石墨烯等碳材料。虽然也有污染碳存在,但较多的sp2杂化碳的峰会掩盖污染碳峰,这时候就不能用污染碳来作为参考了,用sp2杂化碳的峰来作为参考,其结合能为284.4ev,谱峰呈现非对称状。谱图拟合完后,计算C元素谱峰Z右边sp2杂化碳峰位与284.4ev的差值,以此差值为基准,完成C元素和其它元素的校正。
9
Q:
请问赛默飞XPS数据处理软件Avtange能一起处理好几个样品的数据吗?比如3个样品数据拟合类似,我拟合好了样品1,能不能将1号样品的拟合结果复制给2和3样品,然后稍微调节一下2和3样品的拟合数据?
赛默飞Avantage软件是一款专业的XPS数据处理软件,能很好满足用户对XPS数据分析的需求。在批量XPS数据分析处理上,为提升用户数据分析的效率,Avantage软件中一键调用类似样品拟合数据功能,能快速解决批量数据处理问题,极大提升数据分析拟合的效率。具体操作如下图所示:
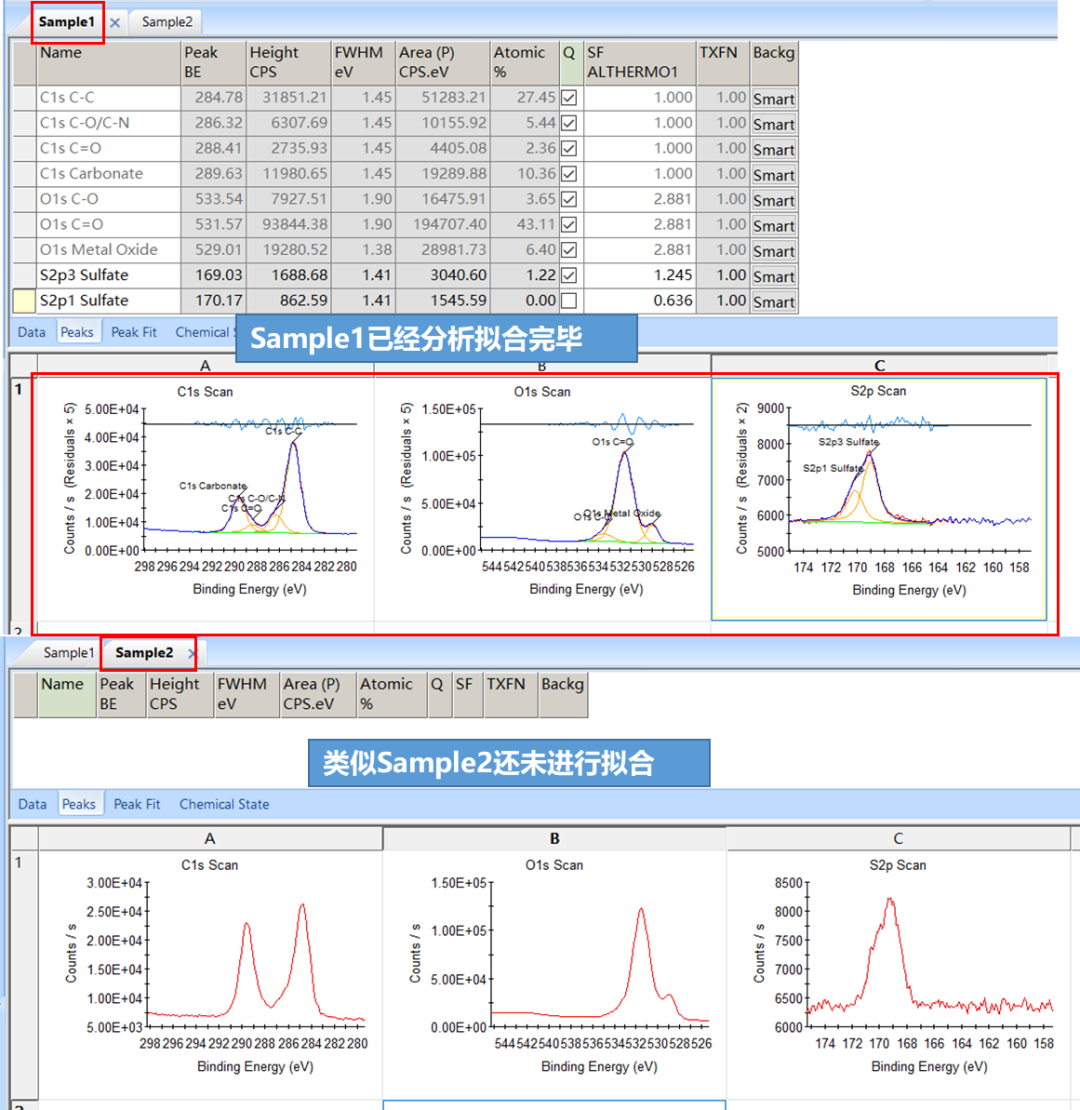
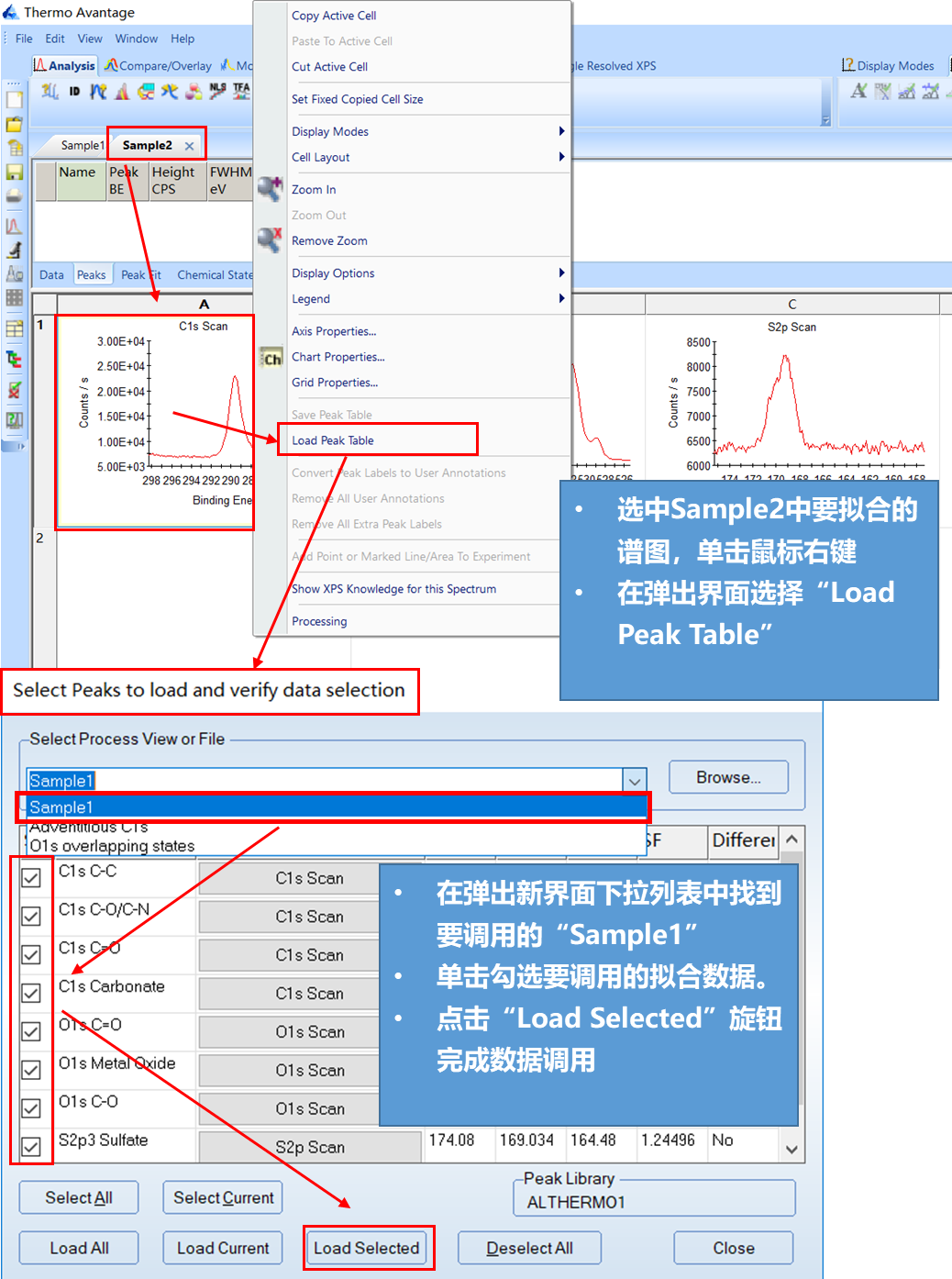

10
Q:
赛默飞K-ALPHA/NEXSA/ESCALAB Xi+型号的XPS设备可以使用真空转移附件进行样品测试吗?
为了满足空气敏感型样品的测试需求,赛默飞K-ALPHA/NEXSA/ESCALAB Xi+三款XPS设备都有真空转移附件供客户选配,都能满足空气敏感型样品测试。
K-ALPHA/NEXSA两型号XPS设备的真空转移附件一样,如下图所示:

ESCALAB Xi+型号XPS设备的真空转移附件,如下图所示:

11
Q:
请问如果没有选配UPS附件,XPS可以测价带谱吗?
如果没有选配UPS附件,XPS也可以测试价带谱。但与UPS测试价带谱相比,XPS得到价带谱信号强度比较弱,需要很长的时间才能得到信噪比好的谱图。
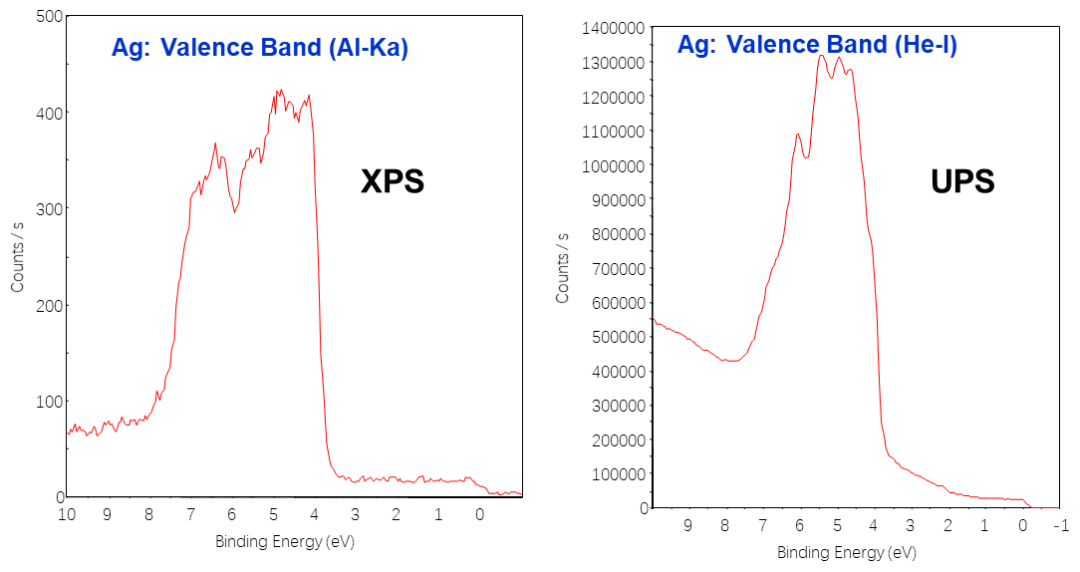
XPS/UPS测试Ag价带谱图比较
问题解答:赛默飞表面分析应用专家 孙文武
Z后!您要的回放地址在这里!
请填写表单,即可获取完整讲座视频回放方式,还可加入我们的课后微信交流群哦!我们将以邮件的形式diyi时间为您发送!
表单地址:http://thermofisher.mikecrm.com/CPIyZW8
友情提示
已报名的老师无需再次填写表单,点击直播观看链接,输入报名预留手机号,即可观看回放。
求 第五届海洋知识竞赛中学生知识点 海洋技术 1.海洋技术可以分为哪几类? 海洋技术主要可以分为以下几个
发给我一些生物必修一diyi单元显微镜的知识点,该注意什么。Z好详细的给我把显微镜的知识点详细说明下,谢谢
高一化学常考知识点... 高一化学常考知识点 展开 答:非金属及其化合物一、硅元素:无机非金属材料
例如谁发现质子,谁发现中子啊电子什么的,波尔贡献是什么等等,我们老师说这叫物理基础知识,要掌握,高考会考,
快期末了,我想要一份高二diyi学期数学的知识点整理,要求:各章ZD讲解同公式,而且要有各式例题。越详细越
希望各位结合高考理科综合的实际情况提供整理一下有关于三聚氰胺的知识点,比如三聚氰胺的分子式,化学性质之类的
“PHI CHINA表面分析技术网络讲堂之光电子能谱ZT”在上周已经开讲两
知识点一:定义VOCs是挥发性有机化合物,关于VOC的定义,不同的标准有不同的定义。1.美国ASTM D396
天津本生-离心管相关知识点! 离心管相关知识点!本生(天津)健康科技有限公司供应:移液器吸嘴,ELISA试剂盒
关于实验室移液器吸头,您要掌握的知识点! 1.使用合适的吸头: 为确保更好的准确性和精度,建议移液量在吸头的35