交流C-V测试可以揭示材料的氧化层厚度,晶圆工艺的界面陷阱密度,掺杂浓度,掺杂分布以及载流子寿命等,通常使用交流C-V测试方式来评估新工艺,材料, 器件以及电路的质量和可靠性等。比如在MOS结构中, C-V测试可以方便的确定二氧化硅层厚度dox、衬底 掺杂浓度N、氧化层中可动电荷面密度Q1、和固定电 荷面密度Qfc等参数。
C-V测试要求测试设备满足宽频率范围的需求,同时连线简单,系统易于搭建,并具备系统补偿功能,以补偿系统寄生电容引入的误差。
进行C-V测量时,通常在电容两端施加直流偏压,同时利用一个交流信号进行测量。一般这类测量中使用的交流信号频率在10KHz到10MHz之间。所加载的 直流偏压用作直流电压扫描,扫描过程中测试待测器件待测器件的交流电压和电流,从而计算出不同电压下的电容值。
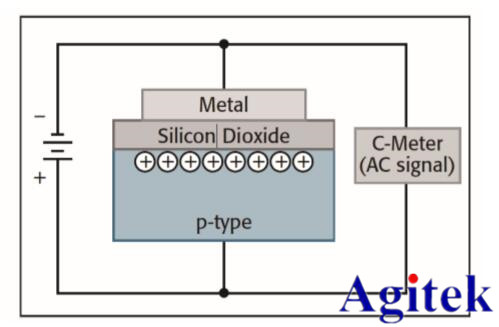
在CV特性测试方案中,同时集成了美国吉时利公司源表(SMU)和合作伙伴针对CV测试设计的专用精 密LCR分析仪。源表SMU可以输出正负电压,电压 输出分辨率高达500nV。同时配备的多款LCR表和 CT8001 直流偏置夹具,可以覆盖 100Hz~ 1MHz 频 率和正负200V电压范围内的测试范围。
方案特点:
★包含C-V(电容-电压),C-T(电容-时间),C-F (电容-频率)等多项测试测试功能,C-V测试可同时支持测试四条不同频率下的曲线
★测试和计算过程由软件自动执行,能够显示数据和 曲线,节省时间
★提供外置直流偏压盒,偏压支持到正负200V, 频率范围 100Hz - 1MHz。
★支持使用吉时利24XX/26XX系列源表提供偏压
测试功能:
电压-电容扫描测试
频率-电容扫描测试
电容-时间扫描测试
MOS器件二氧化硅层厚度、衬底掺杂浓度等参数的计算
原始数据图形化显示和保存
MOS电容的 C-V 特性测试方案
系统结构:
系统主要由源表、LCR 表、探针台和上位机软件组成。 LCR 表支持的测量频率范围在0.1Hz~ 30MHz。源表 (SMU)负责提供可调直流电压偏置,通过偏置夹具盒 CT8001加载在待测件上。
LCR 表测试交流阻抗的方式是在 HCUR 端输出交流电 流,在 LCUR 端测试电流,同时在 HPOT 和 LPOT 端 测量电压值。电压和电流通过锁相环路同步测量,可 以精确地得到两者之间的幅度和相位信息,继而可以推算出交流阻抗参数。


典型方案配置:


系统参数:
下表中参数以 PCA1000 LCR 表和 2450 源表组成的 C-V测试系统为例:
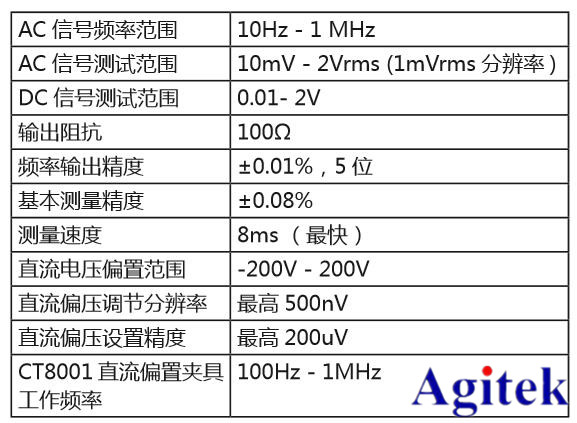
安泰测试已为西安多所院校、企业和研究所提供吉时利源表现场演示,并获得客户的高度认可,安泰测试将和泰克吉时利厂家一起,为客户提供更优质的服务和全面的测试方案,为客户解忧。
电阻率是决定半导体材料电学特性的重要参数,为了表征工艺质量以及材料的掺杂情况,需要测试材料的电阻率。四探针法
近期有很多用户在网上咨询I-V特性测试, I-V特性测试是很多研发型企业和高校研究的对象,分立器件I-V特性测
众所周知,我国半导体事业的发展,相对于欧美大多数国家,是偏晚的。但是我国又是半导体原料储量和需求量大国。因此
书上说 半导体二极管的正向伏安特性曲线说明如下: 当U>0,即处于正向特性区域。正向区又分为三段:
半导体业务中的典型供应链, 显示了需要材料表征、材料选择、质量控制、工艺优化和失效分析的不同工艺步
洞察需求,提供解决方案提供分析设备,加快缺陷识别,实现良率提升进入21世纪以来,半导体行业迎来了高速发展的黄
第七届ZG国际半导体高层峰会(简称“CISES”)于2020年10月12日-13日在上海波特曼丽思卡尔顿酒店
在“监控半导体芯片生产中离子污染的神器——ICS 6000离子色谱”一文中我们主要介绍了半导体行业中关于芯片生
Bruker Dektak XT台阶仪在半导体芯片中的应用台阶仪(探针式轮廓仪)通过记录探针在物体表面的垂直位移
随着半导体制造工艺节点的不断缩小,集成度不断提升,对于 28nm 及其以下先进制程中的工艺技术要求也越来越高,尤