-
产品文章
-
XRD检测-纳米多层薄膜物相随深度变化
发布:束蕴仪器(上海)有限公司浏览次数:5引言
掠入射X射线衍射(GID)是表征薄膜材料的有效手段。通过控制不同的入射角度,进而控制X射线在薄膜中的穿透深度,可以确定薄膜材料的结构随深度变化的信息。
实例 45nm NiO/355nm SnO2/玻璃 薄膜的GID测试
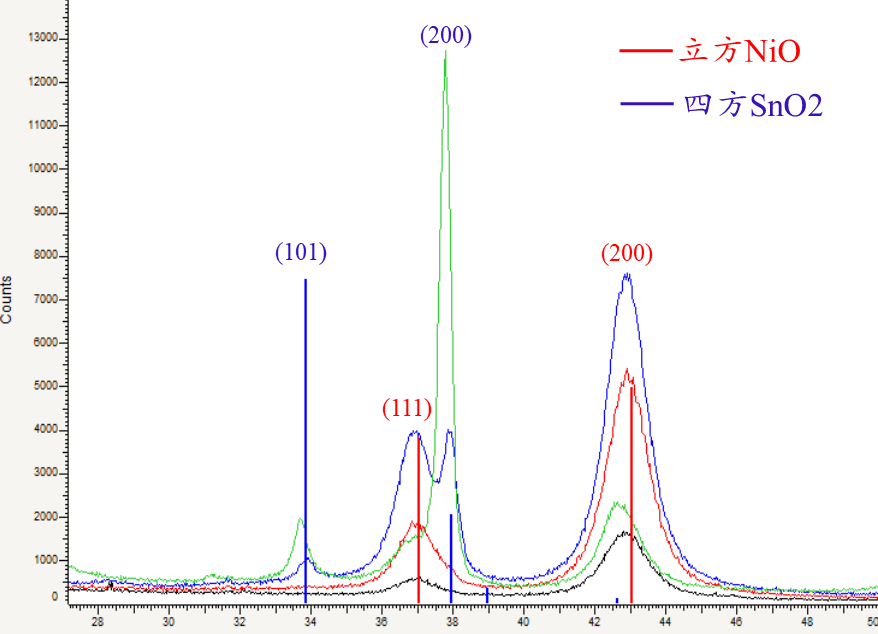
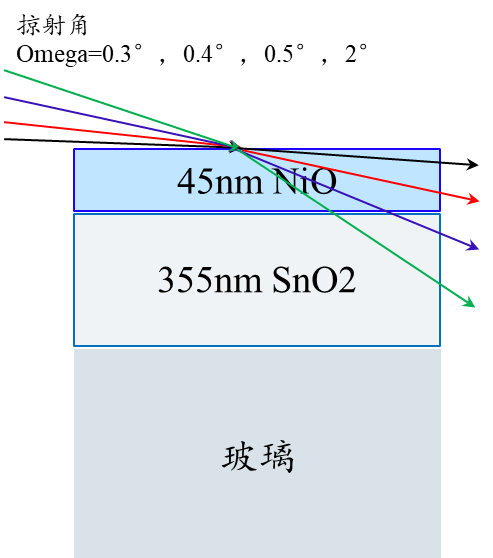
左图:不同入射角时,薄膜的GID图谱。右图:薄膜结构示意图及掠入射角度。
低角度入射时,先看到薄膜 上层的立方NiO。当入射角omega=0.5°时,有四方SnO2的衍射峰出现,入射角进一步增见,则SnO2的信号增加明显,说明X射线照射到SnO2的信号更多。同时,两物相衍射峰的相对强度与卡片对比(左图)可以知道,NiO和SnO2均有一定程度的取向。其中SnO2的强度差别更大,说明取向更强。
2022-06-17相关仪器 -
免责声明
①本网刊载上述内容,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任
②若本站内容侵犯到您的合法权益,请及时告诉,我们马上修改或删除。邮箱:hezou_yiqi

-
 仪网通银牌会员 第
7 年
仪网通银牌会员 第
7 年束蕴仪器(上海)有限公司
认证:工商信息已核实
- 产品分类
- 品牌分类
- (德国)德国布鲁克
- (德国)德国艾力蒙塔
- (美国)美国ICDD
- (闵行区)束蕴仪器
- (美国)美国MDI
- (德国)德国默克
- (美国)Ionoptika
- (英国)英国赫尔
- (美国)美国麦克默瑞提克
- (法国)日本堀场
- (美国)美国PHI
- (美国)Ionoptika
- (英国)英国HEL
- (德国)德国克吕士
- (美国)弗莱贝格
- (德国)德国Freiberg
-
仪企号
 束蕴仪器(上海)有限公司
束蕴仪器(上海)有限公司
-
友情链接
-
手机版开启全新的世界m.yiqi.com/zt9828/



















