在芯片制造的1000+制程步骤中,化学气相沉积(CVD)占据约35%的工艺环节,是实现绝缘层、半导体层、金属层沉积的核心技术。其中,等离子增强CVD(PECVD) 和低压CVD(LPCVD) 是两大主流工艺,因技术路径差异被行业戏称为“激进派”与“保守派”——前者以低温快速为核心,后者以高纯均匀为优势,二者的选择直接影响芯片良率与性能。
PECVD通过在低压环境(0.1-10Torr)下引入射频等离子体,利用高能电子碰撞反应气体分子,降低化学反应活化能(较传统CVD降低30%-50%),实现低温沉积。
芯片后端工艺:SiO₂钝化层、Si₃N₄抗反射层(ARL)、低k介质层沉积。
LPCVD依赖低压环境(1-100Pa)下反应气体的扩散作用,无等离子体参与,反应仅发生在晶圆表面吸附位点,薄膜生长更均匀。
芯片前端工艺:多晶硅栅极、TEOS-SiO₂栅介质层、Si₃N₄硬掩模沉积。
| 工艺类型 | 沉积温度范围 | 平均沉积速率 | 台阶覆盖性 | 薄膜纯度 | 典型应用 | 适用场景 |
|---|---|---|---|---|---|---|
| PECVD | 300-400℃ | 500nm/min | 中等(2:1) | 99.9% | SiO₂钝化层、Si₃N₄抗反射层 | 后端量产、低温兼容 |
| LPCVD | 600-900℃ | 50nm/min | 优异(10:1+) | 99.99%+ | 多晶硅栅极、TEOS-SiO₂ | 前端高纯、研发小批量 |
温度兼容性优先:
若制程涉及后端金属互连(如Cu、Co),必须选PECVD(避免高温破坏金属结构);若为前端未集成金属的工艺(如栅极制备),LPCVD是高纯需求的首选。
薄膜质量需求:
需低应力、高纯度薄膜(如栅极多晶硅)→ LPCVD;需快速量产、成本可控→ PECVD。
产能与成本平衡:
量产线(月产能>10万片)选PECVD(速率优势覆盖设备成本);研发线(小批量试产)选LPCVD(设备成本低40%)。
PECVD与LPCVD无绝对“优劣”,本质是制程需求与技术特性的匹配:前者适配芯片后端量产效率,后者支撑前端高纯性能。近年虽有PECVD-ALD融合、LPCVD低压等离子体优化等技术,但二者的核心差异仍主导芯片制造的工艺选择。
全部评论(0条)
 微波等离子化学气相沉积系统
微波等离子化学气相沉积系统
报价:€65000 已咨询 6659次
 等离子体增强化学气相沉积系统
等离子体增强化学气相沉积系统
报价:面议 已咨询 1057次
 微波等离子化学气相沉积系统-MPCVD
微波等离子化学气相沉积系统-MPCVD
报价:面议 已咨询 2443次
 1700度高真空CVD化学气相沉积系统
1700度高真空CVD化学气相沉积系统
报价:面议 已咨询 955次
 NPE-3500 PECVD等离子体化学气相沉积系统
NPE-3500 PECVD等离子体化学气相沉积系统
报价:面议 已咨询 464次
 等离子体增强化学气相沉积系统
等离子体增强化学气相沉积系统
报价:面议 已咨询 3374次
 德国IPLAS 微波等离子化学气相沉积系统CYRANNUS
德国IPLAS 微波等离子化学气相沉积系统CYRANNUS
报价:¥4980000 已咨询 129次
 低压化学气相沉积系统(LPCVD)
低压化学气相沉积系统(LPCVD)
报价:面议 已咨询 4884次
 荧光定量PCR的技术原理和化学方法
荧光定量PCR的技术原理和化学方法
2025-10-23
 spr传感化学技术
spr传感化学技术
2025-10-22
 表面等离子共振传感化学技术
表面等离子共振传感化学技术
2025-10-17
 同位素质谱仪的生物学和化学研究
同位素质谱仪的生物学和化学研究
2025-10-23
 气相沉积系统特点
气相沉积系统特点
2025-10-21
 气相沉积系统应用
气相沉积系统应用
2025-10-22

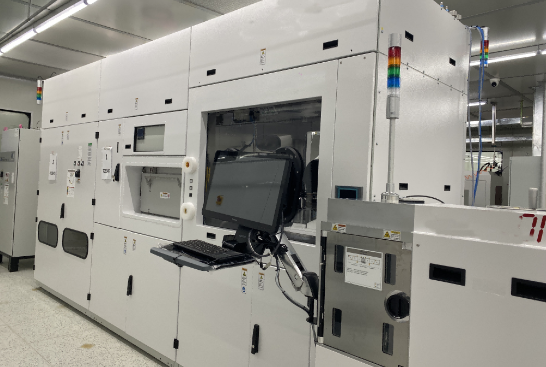

①本文由仪器网入驻的作者或注册的会员撰写并发布,观点仅代表作者本人,不代表仪器网立场。若内容侵犯到您的合法权益,请及时告诉,我们立即通知作者,并马上删除。
②凡本网注明"来源:仪器网"的所有作品,版权均属于仪器网,转载时须经本网同意,并请注明仪器网(www.yiqi.com)。
③本网转载并注明来源的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品来源,并自负版权等法律责任。
④若本站内容侵犯到您的合法权益,请及时告诉,我们马上修改或删除。邮箱:hezou_yiqi
 安全红线:卧式高压灭菌锅必须了解的5道安全联锁与合规数据追溯功能
安全红线:卧式高压灭菌锅必须了解的5道安全联锁与合规数据追溯功能
参与评论
登录后参与评论