点击蓝字 关注我们
研究背景
基于超细晶硅纳米沟道的围栅晶体管(GAA-FETs)因其卓越的静电控制能力,已成为3 nm以下工艺节点的主流器件架构。然而,为实现更高集成密度的单片三维集成架构,需要在缺少单晶硅衬底的堆叠层中,仅依赖全低温工艺(<450 oC)直接制备超细晶硅沟道和高性能GAA-FET器件——这也成为突破高性能三维集成硅基逻辑/存储的核心障碍之一。因此,针对传统微缩刻蚀(Etching)制备工艺所面临的技术挑战,探索一条与之互补的催化生长(Growth)集成制备新策略具有重要的意义。
https://doi.org/10.1007/s40820-025-01674-8
本文亮点
2. 创新的悬空接触策略:开发了一种独特悬空技术,成功固定并释放超细 SiNWs 作为准一维通道,悬空长度可超 500 nm,为全栅结构提供了理想条件。
3. 高性能GAA-FETs突破:首次基于催化SiNWs沟道实现高性能GAA-FETs,开关比达10?,亚阈值摆幅低至66 mV/dec,接近理论极限。
内容简介
图文导读
I 硅纳米线生长与悬空技术
图1a对比了传统EUV光刻和催化生长方式制备的GAA-FET结构。图1b详细描述了IPSLS纳米线生长及悬空释放过程:首先通过光刻和循环交替刻蚀形成密排引导台阶,随后沉积40 nm Al?O?牺牲层;然后沉积4 nm铟(In)催化剂条带,在PECVD中用氢等离子处理形成直径70 ± 11 nm的铟液滴(图1c);最后垫积7 nm非晶硅并在真空中退火,使液滴沿台阶吸收非晶硅并生长硅纳米线。图1d的扫描电镜(SEM)图像显示,生长出的硅纳米线均匀分布于台阶根部,直径约21 nm。图1e对其他区域生长的纳米线直径进行了统计,进一步确认纳米线直径为 22.4 ± 2.4 nm,具有高均匀性,适合用于构建高性能GAA-FET器件。
图1. a) 通过EUV光刻及催化生长集成的GAA结构示意图。b) IPSLS纳米线生长及悬空示意图。c) 催化剂区域和d) SiNWs的典型SEM图像。e) 不同区域IPSLS SiNWs的直径统计。
图2a列举了GAA-FET的完整制造流程程,突出显示了沟道悬空释放和介电层沉积两个关键步骤(虚线框)。图2b示意了通过稀释碱溶液(2.5%)蚀刻 Al?O?牺牲层释放纳米线沟道的过程。图2c中统计表明,纳米线最大悬空长度与其直径相关。例如,直径28 nm的纳米线悬空长度可达 700 nm,即使对于直径18 nm的纳米线,其悬空长度也大于500 nm。图2d-e展示了悬空纳米线及其沉积介质层后的SEM图像。
图2. a) SiNW GAA-FETs的制造流程。b) 湿法释放和介电层沉积步骤的示意图。c) 不同直径SiNW沟道的悬空长度统计。d-e) 悬空SiNWs及沉积3 nm Al?O?和7 nm HfO?后的SEM图像。
图4a为GAA-FET的SEM图像,其沟道长度为300 nm,S/D电极为Pt/Au电极(12/55 nm)。图4b中的转移特性曲线表明,在VDS = -0.1 V时,GAA-FET 的开关比可达10?,SS为66 mV/dec,漏电流低于0.1 pA;相比之下,普通FET 的SS为150 mV/dec。图4c和图4e系统比较了两种器件在不同源/漏电流以及电压下的SS,GAA-FET在各种情况下均展现了更好的性能。图4f对比了文献中催化纳米线与自上而下工艺制备的SiNW-FETs的SS和开关比。可以看到,本研究中的GAA-FET性能远超催化生长的纳米线器件,媲美采用电子束光刻(EBL)和极紫外光刻(EUV)的先进GAA-FETs。
图4. a) GAA-FET的SEM图像。普通FET和GAA-FET:b) 转移曲线,c) SS?IDS 曲线,e) SS?VDS曲线。d) GAA-FET的转移曲线。f) 器件性能对比:基于文献中催化SiNW和自上而下蚀刻SiNW/NS沟道的FET。
图5a-d比较了Ti/Au和Pt/Au接触下的GAA-FET转移特性。其中,Ti/Au 接触开关比仅为103,尽管SS仅为62 mV/dec;而Pt/Au接触器件开关比提高了近四个量级,达10?,SS为65 mV/dec。图5b-e的输出特性显示,Pt/Au接触更接近欧姆特性,开态电阻(2.2×10? Ω)远低于Ti/Au(1.2×10? Ω)。图 5c-f的能带图解释了这一差异:Ti(功函数4.3 eV)接触存在较大的肖特基势垒,从而限制了器件电流;而Pt(5.6 eV)形成反向肖特基势垒,有利于提升驱动电流。
图5. Ti/Au接触GAA-FET的电学性能:a) 迟滞曲线,b) 输出曲线,c) 不同栅偏压条件下的能带图。Pt/Au接触GAA FET的电学性能:d)迟滞曲线,e) 输出曲线,f) 不同栅极偏压条件下的能带图。
本文通过 IPSLS 技术制备了直径 22.4 ± 2.4 nm、线间距 90 nm 的有序硅纳米线阵列,并首次将其用于高性能 GAA-FETs。通过创新的悬空接触策略和优化的源/漏接触,使器件实现了10?的开关比和66 mV/dec的亚阈值摆幅,性能媲美自上而下EBL和EUV光刻制备的先进GAA-FETs。相比传统工艺,这种催化生长硅纳米线GAA-FET具有更高的灵活性和兼容性,能够更好地融入现有制造流程。同时,由于该技术无需依赖预先存在的单晶硅晶圆,且可在低温条件下完成,因此特别适合于堆叠式3D集成电路的设计与制造。随着该技术的进一步优化和成熟,有望推动高性能、低功耗和高集成度电子器件的快速发展,并在人工智能、感存算一体芯片等需要多层堆叠的先进领域实现广泛应用。
作者简介
本文通讯作者
▍个人简介
全部评论(0条)
 合成反应器-幂方科技 Auto SR100 自动合成反应器
合成反应器-幂方科技 Auto SR100 自动合成反应器
报价:面议 已咨询 1079次
 微电子打印机-幂方科技 MF-MP1100 微电子打印机
微电子打印机-幂方科技 MF-MP1100 微电子打印机
报价:面议 已咨询 1053次
 微电子打印机-幂方科技 MF-MP2200 多功能微电子打印机
微电子打印机-幂方科技 MF-MP2200 多功能微电子打印机
报价:面议 已咨询 1090次
 微电子打印机-幂方科技 MF-MP3300多功能微电子打印机
微电子打印机-幂方科技 MF-MP3300多功能微电子打印机
报价:面议 已咨询 1151次
 微电子打印机-幂方科技 MF-DB300多功能柔性电子打印机
微电子打印机-幂方科技 MF-DB300多功能柔性电子打印机
报价:面议 已咨询 1116次
 电子电路打印机-幂方科技 MF-EM400 电子电路印刷设备
电子电路打印机-幂方科技 MF-EM400 电子电路印刷设备
报价:面议 已咨询 1100次
 曲面共形打印机-幂方科技 MF-DBCS500 多功能柔性电子曲面共形打印机
曲面共形打印机-幂方科技 MF-DBCS500 多功能柔性电子曲面共形打印机
报价:面议 已咨询 1074次
 柔性电子器件制备-幂方科技 MF-AP300 自动后处理平台
柔性电子器件制备-幂方科技 MF-AP300 自动后处理平台
报价:面议 已咨询 1073次
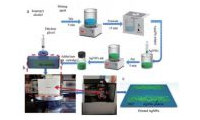







①本文由仪器网入驻的作者或注册的会员撰写并发布,观点仅代表作者本人,不代表仪器网立场。若内容侵犯到您的合法权益,请及时告诉,我们立即通知作者,并马上删除。
②凡本网注明"来源:仪器网"的所有作品,版权均属于仪器网,转载时须经本网同意,并请注明仪器网(www.yiqi.com)。
③本网转载并注明来源的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品来源,并自负版权等法律责任。
④若本站内容侵犯到您的合法权益,请及时告诉,我们马上修改或删除。邮箱:hezou_yiqi
参与评论
登录后参与评论