-
公司新闻
-
技术文章分享: 半导体和电子器件的AFM失效分析
发布:Park System Corp.浏览次数:1072扫码下载
技术文章 ❣

SSRM AFM,
用于半导体失效分析的最 佳选择
Park NX-Hivac上提供的高真空扫描扩展电阻显微镜(SSRM),可实现新一代设备的2D载体轮廓分析,并在高真空条件下测量高分辨率SSRM图像,以提高产品良率。高真空SSRM测量显示出比一般环境条件下更高的精度和分辨率。由于对电流信号具有极高的灵敏度和响应能力,SSRM可确保精确的测量和高重复性,为半导体失效分析提供了一个高水平工具。此外,将称为 PinPoint™ 的新操控AFM模式与SSRM集成在一起,可以同时获取形貌,电学和机械性能数据。并且,与标准的SSRM相比,以接近-缩回方式操作可大大减少摩擦和针尖磨损。
SSRM 可实现:
• 与一般环境条件相比,高真空条件下的灵敏度和分辨率会更高;
• 更高的测量精度和重复性;
• 同时获取多种特性数据(电学、机械、形貌);
• 在 PinPoint™模式下执行操作时,针尖寿命会延长,并且会减少样品损坏;
• 在 PinPoint™ 模式下进行无摩擦成像。
利用SSRM对器件进行失效分析

SSRM 大气中 vs 高真空中
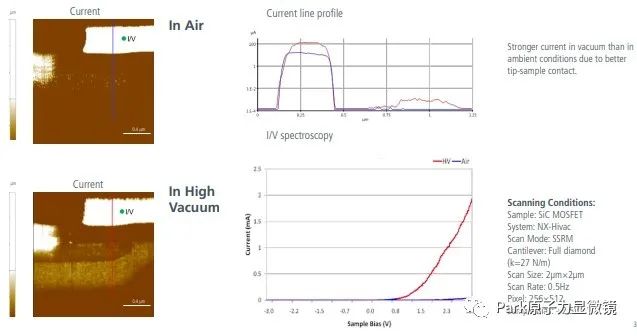
利用导电AFM 对电子器件进行失效分析
C-AFM 通过使用 AFM 探针作为纳米级电探针,能够同时测量样品的形貌和电学特性(电导率)。更具体地说,当施加偏压时,它监视导电针尖和样品之间的电流流动。同时,当针尖在样品表面上扫描时,它会记录悬臂挠度。可以在接触模式,轻敲模式或 PinPoint™ 模式下进行测量。后者以接近-收回的方式工作,确保无摩擦操作,从而消除了在扫描器移动期间由于连续的针尖样-品接触而产生的侧向力。通过控制针尖和样品表面之间的接触时间和接触力,可以获得准确和可再现的数据,因此,这是连续较小电子器件缺陷测试的关键特征。用于改进材料分析的高真空C-AFM在高真空(HV)中执行C-AFM测量可显著提高图像质量。特别是,与环境条件相比,测得的电流增加了三个数量级,具有高均匀性。在高压下扫描的当前形貌显示的细节明显多于在空气中扫描的。
C-AFM 可实现:
• 同时获得高质量的形貌和电流测量数据;
• 高分辨率成像,因为在 PinPoint™模式下执行时消除了摩擦力;
• 在 PinPoint™模式下执行时,由于能够控制接触力和时间,因此能够精确绘制表面电流变化图;
• 与一般环境条件相比,在高真空条件下进行时,信号均匀且电流较高。C-AFM对半导体器件的失效分析
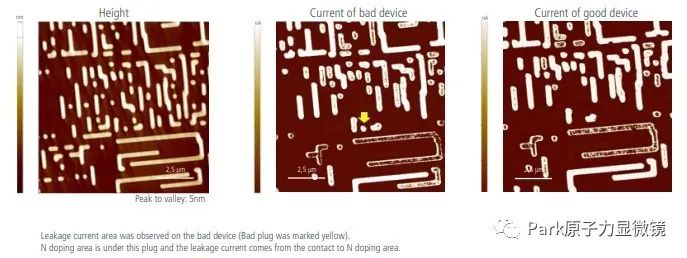
C-AFM 大气中 vs 高真空中

利用扫描电容显微镜(SCM)
对半导体器件进行电学表征
利用高空间分辨率进行电学特性表征是理解半导体器件功能的关键。扫描电容显微镜(SCM)由于其非破坏性的扫描能力和高精度的纳米级特征测量,是表征半导体器件的有力方法。SCM可以在不改变针尖的情况下,以高横向分辨率和高对比度绘图同时获取形貌和电学特性数据。在半导体制造中,SCM提供有助于故障分析和设计改进的掺杂剂分布。此外,Park的新QuickStep SCM模式提供了半导体器件结构的精确掺杂剂分布,比其他的SCM原子力显微镜系统快五到十倍。它在保证最快扫描速度的同时,且不会影响信号灵敏度、空间分辨率或数据精度。SCM 提供了测量定性二维掺杂剂分布的独特能力。
SCM 可实现:
• 无损扫描能力;
• 由于针尖样品相互作用力小使得针尖寿命更长且不会损坏样品;
• 具有高信号灵敏度、空间分辨率和数据准确性的超快扫描速度;
• 准确测量二维掺杂剂分布;
• 基于连续缩放到目标位置期间最小化的漂移效应所带来的高效性。SCM进行的纳米级失效分析
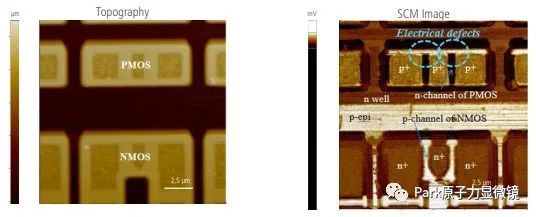
PMOS和 NMOS晶体管的形貌图(左)
SCM 数据(右):低掺杂 p- 型区域以亮色显示, n- 型掺杂剂以深色显示。高度掺杂的 p+ 型或 n+ 型区域显示出中等颜色对比度,例如淡黄色。QuickStep SCM vs. 传统 SCM
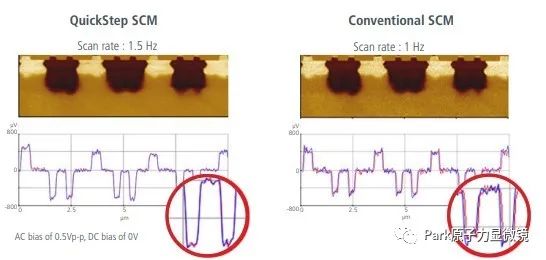
更高质量的 SCM 图像 - 高通量 QuickStep 扫描比传统的 SCM 扫描快 5~10 倍,且不会影响信号灵敏度、空间分辨率或数据准确性。
利用扫描热显微镜 (SThM)
进行失效分析
扫描热显微镜 (SThM) 研究各种纳米结构材料的热性能。由于能够检测样品表面热点引起的故障,SThM 成为以高空间分辨率分析半导体材料和器件的强大工具。SThM 测量的关键部分是带有电阻元件的纳米结构的热探针,可通过独特的信号检测模式实现前所未有的高空间,热分辨率和灵敏度。
SThM 操作模式:
• 温度对比模式(TCM)- 测量样品表面的温度变化;
• 电导率对比模式(CCM)- 测量样品表面的热导率变化;
SThM可以覆盖RT~150°C的温度范围,温度分辨率为0.1°C。SThM 可实现:
• 测量局部热特性( 温度、局部热导率 );
• 前所未有的高空间和热分辨率;
• 具有独特信号检测方案的灵敏度。SThM– 玻璃上的Si 纳米线
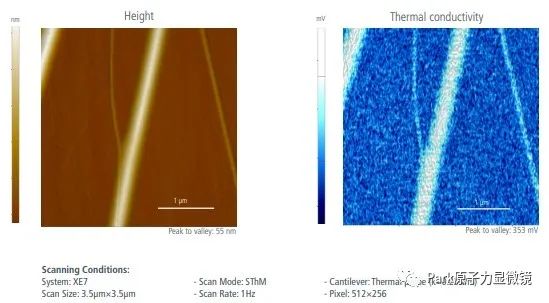
SThM–硬盘磁头的极尖沉降

自动缺陷复检作为
半导体行业缺陷复检的在线方法
现代技术中半导体器件尺寸不断减小的问题,原子力显微镜为半导体行业的缺陷复检提供了一种高分辨率和无损分析方法。由Park引入的自动缺陷复检(ADR)AFM是一个自动化过程,它简化并加快了先前耗时的缺陷表征的工作流程。由于可见光的衍射极限,传统的自动光学检测(AOI)无法在该范围内实现足够的分辨率,这会损害定量成像和随后的缺陷分类。另一方面,ADR原子力显微镜以原子力显微镜的纳米分辨率特性显示三维缺陷。特别是对于纳米范围内的缺陷尺寸,ADR AFM补充了传统的AOI的不足,AFM的高垂直分辨率有助于可靠的三维缺陷分类。非接触测量模式确保了非破坏性表面表征,并防止AFM针尖磨损,从而确保在许多连续测量中保持高分辨率。
ADR AFM 可实现:
• AFM中缺陷表征的简单且省时的工作流程;
• 每小时四到十个缺陷的全自动缺陷表征;
• 以纳米分辨率显示三维缺陷;
• 非接触测量保障无损表面表征和低针尖磨损。自动光学检查 (AOI) vs. ADR AFM

直接比较通过自动光学检查(AOI)和ADR AFM确定的缺陷尺寸,见左侧表格。右侧显示了所有六种缺陷的相应AFM形貌扫描。突出的缺陷称为Bump,凹陷的缺陷称为Pit。
ADR AFM vs. ADR SEM
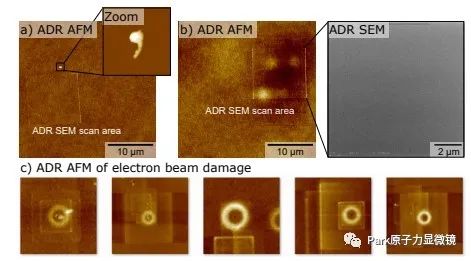
ADR-AFM 和 ADR-SEM 之间的比较,a) ADR-SEM 之前遗漏的凸出缺陷的 AFM 图像。ADR-SEM 扫描区域在 AFM 形貌扫描中显示为矩形。b) 低高度 (0.5 nm) 缺陷的成像,ADR-SEM 无法解析该缺陷。c) ADR-SEM 测量后晶圆表面上的电子束损伤示例,可见为缺陷周围的矩形区域。
400-878-6829
www.parksystems.cn
Park北京分公司
北京市海淀区彩和坊路8号天创科技大厦518室
Park上海实验室
上海市申长路518号虹桥绿谷C座305号
Park广州实验室
广州市天河区五山路200号天河北文创苑B座2112022-09-22 -
免责声明
①本网刊载上述内容,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任
②若本站内容侵犯到您的合法权益,请及时告诉,我们马上修改或删除。邮箱:hezou_yiqi

-
 仪网通银牌会员 第
5 年
仪网通银牌会员 第
5 年Park原子力显微镜公司
认证:工商信息已核实
- 产品分类
- 品牌分类
-
仪企号
 Park System Corp.
Park System Corp.
-
友情链接
-
手机版开启全新的世界m.yiqi.com/zt3413/





