Sensofar S neox用于二氧化硅掩膜薄膜的精确厚度测量
1.我们研究嵌入在光子晶体光腔中、导致发射增强(赛尔效应)的量子点的光学性质(图 1a),或者基由于二氧化硅层的厚度为 40-80 nm,因此在此测量中我们需要达到 1 nm 的精度。这项研究的目的是获得用作硬掩模的二氧化硅 (SiO2) 薄膜厚度 (40-80 nm) 的高精度 (1 nm) 测量值。
嵌入耦合 L3PhC 腔中的量子点(暗点)网络的 SEM 图像;b) 光子晶体的 SEM 图像,顶部带有一个输出耦合器,并包含六个量子点(用红色三角形表示)。
2.到目前为止,每天只能使用触针式轮廓仪来测量二氧化硅掩模的厚度,并且此测量是在另一家实验室中在使用校准标准和 Sopra GES 5E 光谱椭偏仪进行全局校准之后进行的。
但是,轮廓测量法需要在二氧化硅层中湿法蚀刻“台阶”,相当耗时,并且在处理完整晶片时并不实用。此外,轮廓测量法中的典型噪声为 5 nm RMS,因此需要大量平均才能获得所需的 1 nm 精确度 。
触针式轮廓仪在二氧化硅薄膜中的台阶轨迹;b) 同一薄膜的反射光谱,模型拟合显示厚度 (84±1 nm)
我们以裸露的砷化镓基板为参考,首先使用内置的单层模型测量位于砷化镓之上的二氧化硅层的反射光谱。如图 2b 所示,得到的反射率光谱非常平坦,没有显示出较厚 (d>λ) 膜所特有的振荡。尽管如此,模型拟合效果仍然非常好,膜厚度 (84 nm) 的精确度为1 nm。
显示了相同类型的测量,即测量了 38 nm 的膜。 在砷化镓膜结构的例子下,砷化镓基板上有 3 层(二氧化硅/砷化镓/GaAs/Al0.7Ga0.3As)结构。在这个例子中,我们仍将砷化镓作为参考,以便将这个完整的结构输入到模型中。
3. 二氧化硅薄膜的反射光谱,模型拟合显示厚度 (38±1 nm)
4.在第一项测试中,我们测量不含二氧化硅的裸露半导体多层结构的反射率。测得的光谱(图4a)显示出具有良好的拟合度,产生了正确的(通过 X 射线衍射验证)砷化镓和 Al0.7Ga0.3As 层厚度,以及模型顶部二氧化硅层的零厚度。这一次,反射率曲线显示出典型的振荡,通常出现在较厚的 (d>λ) 层中。
在验证裸露半导体后,我们测量了另一个样品,该样品涂覆有二氧化硅(图 4b)。测得的光谱拟合不仅显示了半导体层的厚度,而且还显示了正确的二氧化硅层的厚度 (79 nm)。
在最后一项测试中,我们尝试测量涂覆有二氧化硅和 PMMA 层的样品(图 4c)。这一次,频谱显示出更复杂的振荡,并且模型拟合不如以前好。尽管如此,拟合值仍然正确,证明了该方法的功能和速度。
砷化镓/Al0.7Ga0.3As/砷化镓样品的反射光谱,模型拟合显示半导体厚度(255 和 994 nm)。拟合显示顶部没有二氧化硅层;b) 涂覆有二氧化硅的砷化镓/Al0.7Ga0.3As/砷化镓样品的反射光谱,模型拟合显示半导体厚度(269 和 953 nm)和二氧化硅层厚度 (79 nm);c) 涂覆有二氧化硅和 PMMA 的砷化镓/Al0.7Ga0.3As/砷化镓样品的反射光谱,模型拟合显示半导体厚度(255 和 1022 nm)以及二氧化硅层厚度 (276 nm) 和 PMMA 层厚度 (1044 nm)。
总结
我们使用触针式轮廓仪和 Sopra GES 5E 光谱椭偏仪以及商业校准标准品(硅上涂的二氧化硅层,Micromasch 提供)作为对照 ,检查了使用此方法获得的值,发现 Sensofar 系统的精确度为 1 nm,符合我们的要求。
为了处理复杂的光子纳米结构器件,我们需要对沉积在砷化镓或多层半导体顶部的二氧化硅薄层(通常 <100 nm)进行高精确度 (1 nm) 的快速厚度测量。Sensofar 的 S neox 3D 光学轮廓仪提供的反射光谱是解决此需求的理想工具,可提供我们需要的高精确度、高测量速度和易用性。
全部评论(0条)
推荐阅读
-
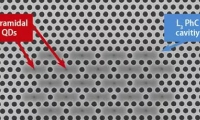
- Sensofar S neox用于二氧化硅掩膜薄膜的精确厚度测量
- “为获得所需的 1 nm 精确度,我们现在将 3D 光学轮廓仪 S neox(光谱反射法模式)作为测量 SiO2层厚度的一种快速且简便的方法。”
-
- 案例分析 | Sensofar共聚焦白光干涉仪用于二氧化硅掩膜薄膜的精确厚度测量值
- 我们研究嵌入在光子晶体光腔中、导致发射增强(赛尔效应)的量子点的光学性质,或者基于嵌入在波导中、用于生产光子多路复用器件的量子点的光学性质
-

- Sensofar 三维共聚焦干涉显微镜S neox实际应用案例
- Sensofar三维共聚焦干涉显微镜S neox是一款综合性多功能三维形貌测量仪器,可以满足用户对三维表面测量的复杂要求——在多重聚焦模式下,可实现极为粗糙表面的三维测量。
-

- 西班牙Sensofar S neox共聚焦白光干涉仪用于汽车发动机缸套的纹理几何形状评估
- 在MTC表面纹理的研究中,西班牙的Sensofar S neox三维共聚焦白光干涉光学轮廓仪发挥了关键作用。
-

- Sensofar S neox三维共聚焦白光干涉仪用于汽车发动机缸套的纹理几何形状评估
- 激光加工可通过应用纹理来开发工程表面,可以产生增强的功能性能,如表面摩擦、触感行为、润湿性能等。使用皮秒和飞秒级的超短脉冲进行激光加工,可加工出具有高度精确的微观几何形状、边缘和表面的表面纹理。五轴激
-
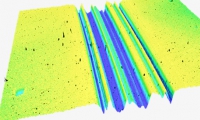
- Sensofar S mart三维轮廓仪用于摩擦涂层的表面表征
- Sensofar Smart三维轮廓仪用于摩擦涂层的表面表征:磨损性能、厚度和粗糙度。
-
- 产品推荐|Sensofar 5轴空间3D共聚焦白光干涉轮廓仪S neox Five Axis
- 产品推荐|Sensofar 5轴空间3D共聚焦白光干涉轮廓仪S neox Five Axis
-
- 椭圆偏振光谱仪在薄膜厚度测量中的应用
- 椭偏仪凭借其高速、高精度以及非破坏性的显著优势,成为了测量薄膜膜厚与结构的重要工具,广泛应用于多个前沿领域,包括半导体制造、光学薄膜分析、材料科学、生物传感器以及微纳加工等。
-
- 产品介绍 | S neox、S mart 2和S wide为您带来全方位测量解决方案
- 技术应用 | S neox、S mart 2和S wide为您带来全方位测量解决方案
-

- 分光干涉膜厚仪:精确测量薄膜厚度的关键工具
- 分光干涉膜厚仪是一种用于测量薄膜厚度的高精度仪器,广泛应用于半导体制造、光学镀膜、生物医药等高科技领域。
-

- 如何运用S neox五轴数据集进行CAD对比?
- 我们做一个切割刀具比较,您可以看到五轴和这里的样本位置。而在这里的实时图像中,我们可以看到部分样本。
-
- 案例分析 | Sensofar共聚焦白光干涉仪用于膜光子晶体器件的无损表征
- Sneox 可提供最多 4 种不同光源(红光、绿光、蓝光和白光),这对本研究中尤其重要
-
- 技术应用 | 探索 S neox Cleanroom 可集成头无尘系统的技术优势
- 技术应用 | 探索 S neox Cleanroom 可集成头无尘系统的技术优势
-

- 薄膜厚度椭偏仪:精确测量薄膜厚度的核心工具
- 薄膜厚度椭偏仪是一种高精度的光学测量仪器,广泛应用于半导体、光电子、太阳能电池等行业中,用于测量薄膜的厚度、折射率及其他光学常数。
-
- 案例分享 | 如何运用S neox五轴数据集进行CAD对比?
- 案例分享 | 如何运用S neox五轴数据集进行CAD对比?
①本文由仪器网入驻的作者或注册的会员撰写并发布,观点仅代表作者本人,不代表仪器网立场。若内容侵犯到您的合法权益,请及时告诉,我们立即通知作者,并马上删除。
②凡本网注明"来源:仪器网"的所有作品,版权均属于仪器网,转载时须经本网同意,并请注明仪器网(www.yiqi.com)。
③本网转载并注明来源的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品来源,并自负版权等法律责任。
④若本站内容侵犯到您的合法权益,请及时告诉,我们马上修改或删除。邮箱:hezou_yiqi



















参与评论
登录后参与评论