XPS作为一种表面灵敏的分析技术,可以探测样品表面10 nm以内的信息,而在材料分析中深度分析是获取不同深度下组分和化学态信息的重要方法。在XPS深度分析中,有3个采样深度值得关注:(1)0-10 nm,这是基于常规Al Kα X射线XPS的探测深度,对于超薄膜层结构的深度分析可以通过变角度XPS实现;(2)0-30 nm,这是基于硬X射线XPS (HAXPES)的探测深度,可以通过切换X射线能量进行无损深度分析;(3)0-1000 nm,需要采用离子束剥离的破坏性深度剖析。氩离子刻蚀是常用的样品减薄技术,但是对于一些氧化物薄膜,氩离子刻蚀存在着择优溅射的问题,会导致部分的金属氧化物被还原,生成中间价态的金属离子或金属单质。而在微电子行业中,越来越多的具有膜层结构信息的超薄膜样品需要被分析,有损的氩离子刻蚀方法可能并不是很适用,因此,变角度XPS作为一种无损的检测方法是非常适用的。
角度分辨X射线光电子能谱(Angle resolved XPS,ARXPS)是通过改变光电子起飞角,能量分析器检测到样品表面不同深度区域激发出来的光电子,进而得到样品化学信息的深度分布。从图1中可以看出信号采集的深度与光电子的起飞角度有关,通过倾斜样品改变光电子的起飞角度,就可以采集不同深度的成分信息。当光电子的起飞角越小时,能量分析器采集的信号越来自于样品表面。

图1.黑色箭头指向分析器,箭头与样品平面之间的夹角为起飞角θ,d 代表 ARXPS 测试的探测深度
ARXPS常用于对具有不同膜层结构的超薄膜样品进行分析,通常测试的膜层厚度要小于7.5 nm。如图2中(a)和(b)所示,当样品的膜层厚度大于7.5 nm时或样品表面组分分布比较均匀时,此时的样品并不适合ARXPS测试,主要是由于样品表面组分分布比较均匀,不同原子(红色原子和蓝色原子表示)激发的光电子总信号强度的比值是不随起飞角的改变而改变。但是对于具有不同膜层结构的超薄膜样品,如图2(d)和(e)所示,表面红色原子的信号强度随着起飞角的减小而增加,红色原子与蓝色原子的信号强度的比值随起飞角的减小而呈指数增长。
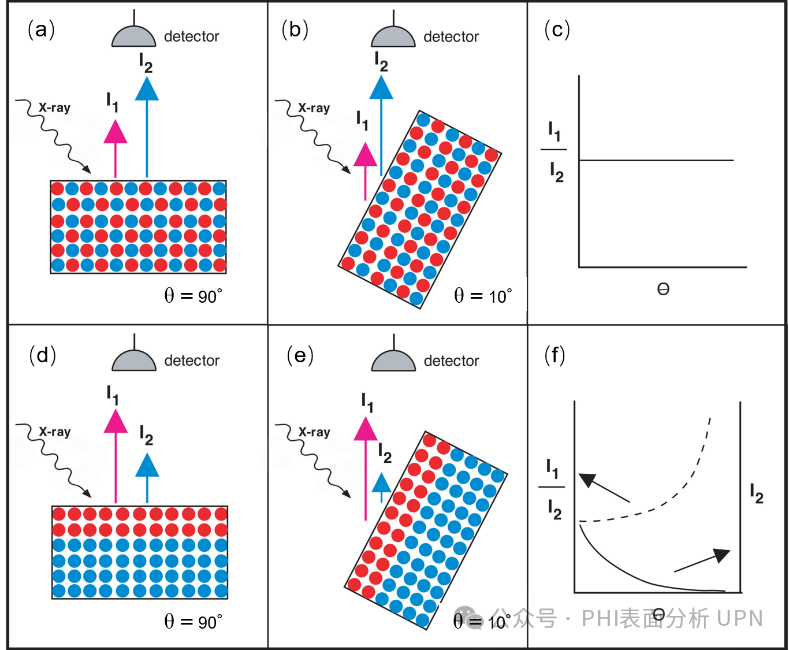
图2.样品表面的组分分布影响XPS信号强度与起飞角的关系
等离子体处理可以对聚合物表面进行改性,是提高材料表面性能的重要改性工艺。以聚苯乙烯为例,经过等离子体处理后,样品表面的化学态发生了明显的改变。采用XPS测试C 1s谱图对表面化学态进行分析,结果如图3(a)所示:当光电子起飞角为90°时,拟合结果表明C主要以CHx、C-O/C-N、C=O、N-C=O形式存在,其相对原子百分含量分别为86.1%、9.5%、1.8%、2.6%。为了提高表面灵敏度,将光电子的起飞角减小到10°,测试结果如图3(b)所示,CHx、C-O/C-N、C=O、N-C=O的相对原子百分比分别为46.5%、27.2%、11.8%、14.5%,掠出射模式下C-O/C-N、C=O、N-C=O比例的显著增加表明改性组分主要分布在表面。可见ARXPS减小光电子的起飞角可以显著提高XPS表面灵敏度。

图3.等离子体改性后聚苯乙烯样品的ARXPS测试结果对比
Si晶圆衬底上生长着一层SiO2氧化层薄膜,通过倾斜样品台改变光电子起飞角的大小,可以得到薄膜表面到几纳米层厚的成分变化情况。如图4中(a)所示,当光电子起飞角为10°时,Si 2p谱图主峰位于高结合端,是来自于氧化物层SiO2;随着起飞角的增大,Si 2p谱图中位于低结合端的谱峰越来越明显,也就是衬底Si单质信号越来越明显。图4(b)展示了ARXPS深度曲线,可以看到ARXPS表征了膜层深度分析,样品表面SiO2占比较高,而样品内部单质Si的占比较高。

图4.样品表面Si 2p不同的化学态随起飞角的变化
ARXPS主要用于超薄膜样品的深度分析。由于ARXPS测试中,需要倾斜样品改变光电子起飞角,因此样品的尺寸无法太大,同时也需要标准样品建立数学模型来计算膜层的结构。但是与常规的氩离子刻蚀方法相比,ARXPS对超薄膜样品提供一种非破坏性的深度分析方法。后面章节中会有详细说明如何利用ARXPS计算薄膜厚度,请持续关注更新。
参考资料:
1.https://www.phi.com/news-and-articles/angle-resolve-part-1-spotlight.html
2.John F. Watts, John Wolstenholme.An Introduction to Surface Analysis by XPS and AES. Wiley, Rexdale, 2003.
3.John C. Vickerman and Ian S. Gilmore. Surface Analysis : The Principal Techniques.2009.

 认证会员 第
6 年
认证会员 第
6 年 爱发科费恩斯(南京)仪器有限公司
爱发科费恩斯(南京)仪器有限公司





