飞行时间二次离子质谱(TOF-SIMS)是一种非常灵敏的表面分析技术。可以广泛应用于物理,化学,微电子,生物,制药,空间分析等工业和研究方面。TOF-SIMS可以提供表面,薄膜,界面以至于三维样品的元素,分子等结构信息。

技术参数:
. 并行探测所有离子,包括有机和无机分子碎片。
. 无限的质量探测范围(实际测量中大于1000m/z 原子量单位)。
. 完全透过率下实现高的质量分辨率。
. 极高的横向和纵向空间分辨率(横向小于100纳米,纵向小于1纳米)。
. 探测灵敏度可达ppm或ppb量级。
. 质量探测分辨率(M/ΔM) >1000
. 质量探测准确度 ≥20 milli 质量单位
. 反射性分析器
. 5 分钟样品腔真空度可从大气环境达到真空工作环境
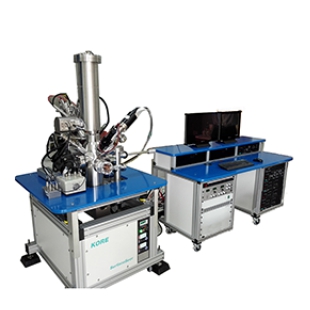
报价:面议
已咨询1728次半导体测试设备

报价:¥8000000
已咨询606次SEM 扫描电子显微镜

报价:面议
已咨询3250次飞行时间质谱
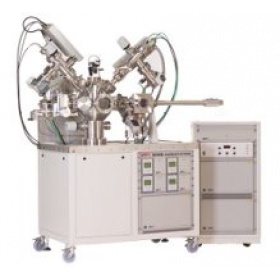
报价:面议
已咨询4900次等离子体-材料表面

报价:面议
已咨询399次飞行时间二次离子质谱仪

报价:面议
已咨询854次半导体材料测试设备

报价:面议
已咨询4789次等离子体-材料表面

报价:面议
已咨询1282次质子传递反应质谱