-
产品文章
-
Nature I 含有n沟道和p沟道过渡金属硫化物的范德华结场效应晶体管
发布:Park System Corp.浏览次数:2846过去的十几年里,二维(2D)过渡金属硫化物(TMD)被公认在未来纳米电子学中存在了巨大的潜力,在材料和器件两个方面都得到了广泛的研究。主要的焦点是2D TMD半导体器件,这可能是现有或未来技术中最重要的部分。因此,目前为止,已经发表了很多关于使用2D TMD沟道的金属绝缘体半导体场效应晶体管(MISFET)的报道,以及它们在互补金属氧化物半导体晶体管逆变器中的应用。
与此同时,具有范德华(vdW)接口的异质结2D TMD PN(PN)二极管也受到了研究人员的广泛关注。这些vdW PN结接口在设备运行中会经历跨结的平面外或垂直电流。实际上,相同的vdW PN结结构可用于另一个重要的器件应用,即结场效应晶体管(JFET),其中平面内电流与2D–2D异质结接口一起的形式可能会实现。然而,尽管一些可能性已经在黑磷/氧化锌纳米线结系统中得到了应用,但似乎尚未报道vdW JFET应用。
June Yeong Lim, Minju Kim, Yeonsu Jeong, Kyeong Rok Ko, Sanghyuck Yu, Hyung Gon Shin, Jae Young Moon, Young Jai Choi, Yeonjin Yi, Taekyeong Kim & Seongil Im 研究团队,将vdW JFET制成了平面半导体器件,在半导体 p-MoTe2(或p-WSe2)和n-MoS2 TMD之间具有异质结。下面就是针对以上研究课题所进行的实验过程阐述与内容讨论。
图1a显示了研究者在285nm厚的SiO2/p-Si晶圆上制造的p-MoTe2/n-MoS2沟道JFET器件的光学显微镜(OM)图像。在MoTe2和MoS2沟道中,Pt和Au分别用作源/漏欧姆电极。如图1c的3D示意图所示,六角形2H-MoS2沟道在两个沟道彼此交叉时重叠在2H-MoTe2上。如图1b所示,通过显微拉曼光谱同时清晰地识别出两个半导体TMD,为此对重叠区域的ZX点进行了探测(请参见图1a中的红色点)。由于p沟道和n沟道材料是交叉的,使用Pt和Au电极可能形成了四种不同的PN二极管,并证实了这种二极管的行为。此外,通过相同的结构,还确认了p型和n型MISFET的行为以及传输曲线特性中的大滞后现象。
图1 材料特性和器件示意图
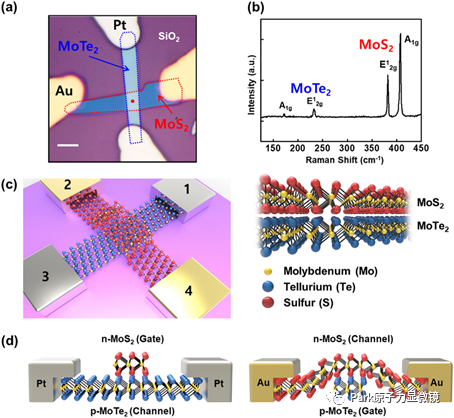
a.在285nm厚度的SiO2/p-Si晶片上制造的JFET器件的光学显微(OM)图像。红色和蓝色虚线分别描绘了MoS2和MoTe2覆盖区域。比例尺= 5μm。b.从重叠区域的红点获得的拉曼光谱。c. MoS2和MoTe2结器件的3D示意图。基本上可以形成四个异质结PN二极管对。d. p-MoTe2沟道(n-MoS2栅极)和n-MoS2沟道(p-MoTe2栅极)JFET器件的3D截面图。
根据JFET结构的OM,进行了原子力显微镜(AFM;图2a,b)和扫描开尔文探针显微镜(SKPM,图2c) 对同一装置的矩形区域进行探测,该矩形区域包含图2a所示的四个各自的表面:SiO2衬底,MoTe2,MoS2和MoTe2上的MoS2覆盖层。根据原子力显微镜的结果(图像对比度),MoTe2和MoS2沟道的厚度分别约为 16nm和6nm。根据SKPM结果,单个MoTe2和MoS2的功函数完全相同,为4.54eV,而MoTe2覆盖在MoTe2上的MoS2的功函数略高,为4.56eV。略高的值可能是因为MoTe2上的MoS2不受SiO2表面上的陷阱电荷的影响,还因为两个TMD之间有一些电子电荷转移。根据SKPM数据,我们可以预期并构建MoTe2/MoS2 PN结,MoS2 n沟道和MoTe2 p沟道的能带图,分别如图2d-f所示。PN结应在MoTe2和MoS2之间包含〜0.3nm vdW间隙。在没有栅偏压的情况下,沟道几乎没有势垒,而是内置势能(n沟道 qΦi= 0.02eV)。当对n沟道的p型栅极施加反向偏压时,MoS2沟道应该在p栅(重叠)区域(图2e)具有能垒,费米能量位于该区域的中间。带隙,指示电荷载流子耗尽(用于OFF状态)。类似地,MoTe2沟道在施加于p沟道的反向偏压下,在n栅极区域(图2f)具有能垒。如果没有漏极偏压电压,则带势垒的能带图必须对称。但是,它在漏极偏压下会变得不对称。
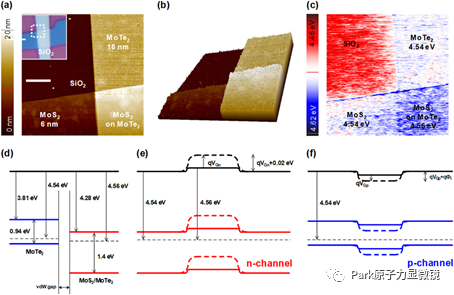
图2 AFM和SKPM的设备能带图
a.JFET结构的2D AFM图像。b.JFET结构的3D AFM图像。比例尺= 1μm。c.JFET的SKPM图像。a图中的白色虚线框表示AFM和SKPM(a–c)的扫描区域。d. MoTe2 / MoS2,e. MoS2 n沟道的能带图。f. MoTe2 p沟道的能带图。VGn和VGp分别表示施加在n沟道和p沟道上的栅极偏压
正如平面方向带图(图2e,f)所预期的那样,n沟道JFET在图3a–f中得到了实验证明。图3a显示了另一个JFET的OM图像,该JFET与图1a的不同,但具有相似的沟道厚度尺寸:对于MoS2和MoTe2沟道,分别为〜12和7nm 。图3d中器件的输出特性(漏极电流-漏极电压;ID-VDS)显示典型晶体管的三个阶段:线性(i)、夹断(ii)和饱和至早期效应(iii)。这三个阶段通过图3c中不同VDS下的JFET横截面示意图得到了很好的解释,虽然在图3b的示意性3D视图中,器件的每个材料组件通过颜色来识别。图3c中的横截面(i)显示了在微小VDS下用于线性状态ID的传导沟道。随着VDS向正电压增加, 漏极侧相对于p栅极产生反向偏压,在源端保持正向偏压和沟道开放的情况下发生不对称沟道耗尽(交叉阴影区)。随着VDS进一步增加,n沟道达到夹断状态(ii)甚至沟道长度(L)调制(iii)。这种沟道长度调制导致长度(L′)缩短和电流升高(偏离饱和;早期效应)。从另一个JFET(支持信息图S3a)观察到,这种沟道调制在我们的JFET器件中非常普遍。图3e显示了传输特性(漏极电流-栅极电压;ID-VGS),其中观察到良好的开/关 ID比为5×104,SS为〜100mV/dec。在图3e中,栅极漏电流(IG)似乎随着施加的栅极电压(VGS)而增大,并且可以肯定地理解为源于n-MoS2和p-MoTe2之间的PN结的正向偏压引起的漏电流。
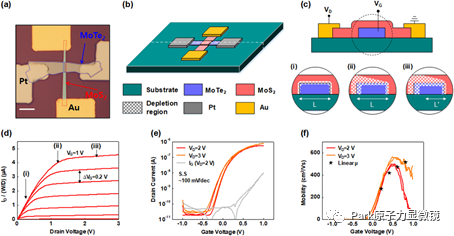
图3 p-MoTe2/n-MoS2 JFET的n沟道
a. n沟道JFET的OM图像。比例尺= 10μm。b. n沟道JFET的简单3D示意图。c.根据(i)微小,(ii)夹断和(iii)大VDS的2D横截面设备视图以及n沟道设备b中的白色虚线剖开的视图。d. n沟道JFET的ID–VDS输出特性。e. n沟道JFET的ID–VGS传输特性。f. n沟道JFET的移动性。红色和橙色线表示饱和迁移率,黑色星号表示在不同VGS(分别为0.2、0.4、0.6、0.8 V)下的线性迁移率。
JFET的饱和迁移率也是从同一个图中提取出来的。根据图3e,f,阈值电压和峰值饱和迁移率分别为−0.2V和500–600cm2/V·s。饱和迁移率由以下等式(1)驱动,该等式需要MoS2 n沟道中载流子浓度Nd和跨导gm的信息。在图3e中,我们从转移曲线中提取作为VGS函数的gm图。

(1) 因此,可将迁移率计算如下:

(2) 式中,Nd是载流子密度(单位:cm3);q是电荷;t、W和L分别是沟道的厚度、宽度和长度。在图3d中,使用以下在小VDS下的简单等式(3),也可以从图3d中不同VGS处的输出特性中提取线性移动性。

(3) ZD线性迁移率似乎与饱和状态相当。
对于饱和度和线性迁移率的估计,Nd值将是最重要的信息。为了获得室温下的Nd值,实验实际上尝试了用Au接触16nm薄MoS2和Pt接触7nm薄MoTe2进行四点van der Pauw Hall测量。图4a,b显示了在SiO2/p-Si衬底上的样品的两个OM图像,而每个样品的厚度都是通过AFM扫描测量的,如图4c所示。尽管图4a,b中的样品形状不是理想的对称形状,但是MoTe2和MoS2样品在磁场(H)扫描下相对磁阻[RH(H)–RH(0)]与H场图如图4d所示。这些斜率清楚 地 标 识或区分了p型和n型传导。根据斜率,计算出在300K下的空穴和电子浓度(Na和Nd)分别为2.43×1017和2.5×1016/cm3。计算详细信息在支持信息部分。
图4 MoS2和MoTe2的Hall测量
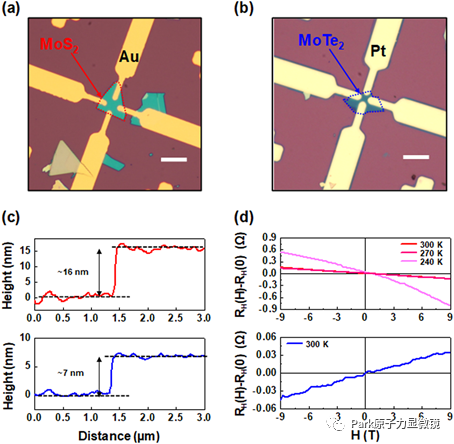
a,b.用于四探针Hall测量的n-MoS2和p-MoTe2的OM图像。c.从AFM扫描获得的MoS2(红色)和MoTe2(蓝色)的薄片厚度分布图,以及在磁场(H)下MoS2(顶部负斜率)和MoTe2(正)的d RH(H)-RH(0)数据坡)。a,b = 10μm的比例尺
实验的所有JFET器件都与MISFET不同,仅显示了一些滞后现象,这是因为vdW PN结界面处的电荷陷阱密度很小。无论器件是n沟道还是p沟道JFET(实际上是同时使用两个沟道的单个器件),图3f中的迁移率图显示了0.05-0.1µV的微小滞后。图5a显示了第三个带有p沟道的JFET,实际上,该JFET的沟道厚度约为10nm,与图3a中的n沟道JFET相当。图5d中的输出曲线特征显示了三种ID模式:线性(i),夹断(ii)和饱和(iii)。乍一看,p沟道ID的输出曲线与图3d中的n沟道的曲线相当。然而,从细节观察可以看出,在MoTe2p沟道中,夹断阶段显得较慢;p沟道的饱和电压(对于VGS = -1V,VSAT = -1.5V)大于MoS2 n沟道的饱和电压(对于VGS = 1 V,VSAT =〜0.8V)。它与p沟道的空穴载流子密度有关,p沟道的空穴载流子密度比n沟道的大。在相同的VGD(VGS-VDS)下,p沟道的电荷耗尽比n沟道的电荷耗尽更加困难。图5b,c展示了p沟道JFET的示意性3D和截面图。如图5c所示,在正VGD下,MoS2栅极(反向偏压)比MoTe2 p沟道更容易耗尽,而MoTe2 p沟道需要进一步的VDS才能收缩。在图5e中,p沟道JFET的ID比n沟道JFET的ID低一个数量级,与n沟道器件的SS(200 mV / dec)和ON/OFF ID比(5×103)比低。困难的沟道耗竭或沟道关闭可能与这种劣势密切相关。根据图5f,p沟道JFET的饱和度(13–14cm2 /V·s作为峰值迁移率)和线性迁移率(4cm2/V·s)看起来与以前的p-MoTe2 MISFET的报告相当,但是远远低于MoS2 JFET的值。由于p沟道中载流子浓度高一个数量级而导致的杂质散射是MoTe2的固有能带结构以及迁移率低的主要原因,此外,还可以怀疑MoTe2沟道/SiO2接口上的许多陷阱是器件几何结构方面移动性低的另一个原因。
图5 p-MoTe2/n-MoS2 JFET的p沟道
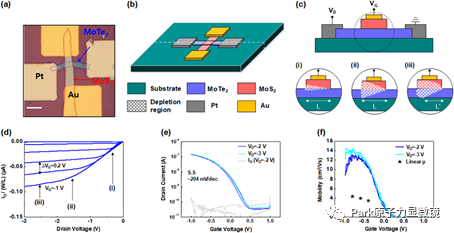
a.p沟道JFET的OM图像。比例尺= 10μm。b.我们的p沟道JFET的简单3D示意图。c.根据(i)小型,(ii)夹断和(iii)大VDS的2D横截面设备视图以及我们p沟道设备b中的白色虚线剖开的视图。d. p沟道JFET的ID–VDS输出特性。e. p沟道JFET的ID–VGS传输特性。f.我们的p沟道JFET的移动性。蓝线和天蓝色线表示饱和迁移率,黑星线表示不同VGS(分别为-0.2,-0.4,-0.6,-0.8V)下的线性迁移率
作为ZZ设备,p-WSe2/n-MoS2 JFET的制造目的是为了确认任何p-TMD/n-TMD JFET原则上都可以正常工作。p-TMD充当n-TMD沟道的栅级,而n-TMD充当p-TMD沟道的栅级。图6a,b分别显示了JFET的OM和3D示意图,其中p-WSe2和n-MoS2沟道FET共同使用Au触点。图6c显示了通过探测重叠位置(图6a中的红点)一次获得的来自两个薄片的拉曼光谱。根据图6d的输出曲线特性,尽管Au和p-WSe2之间的接触电阻看起来很严重,但p沟道和n沟道JFET仍能很好地工作。由于接触电阻的这种缺陷,p-WSe2 JFET表现出较差的I–V特性,只有几nA的ON状态,而p沟道WSe2的导电性较差,导致其对n-MoS2 JFET的栅级不足。因此,如图6d,e的输出和传输特性所示,p-WSe2/n-MoS2系统中的n-MoS2 JFET的导通状态ID比p-MoTe2/n-MoS2 JFET情况的导通状态ID低一个数量级。但是,此p-WSe2/n-MoS2 JFET器件的演示仍支持任何p-TMD/n-TMD JFET通常原则上都使用两个沟道工作。
图6 p-WSe2/n-MoS2 JFET
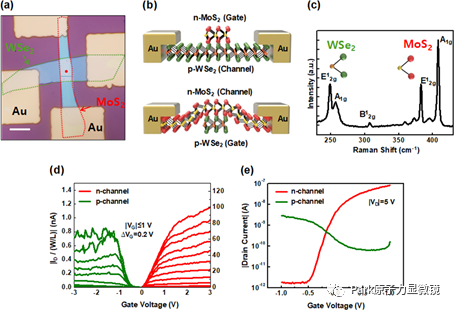
a.SiO2/p-Si上p-WSe2/n-MoS2 JFET的OM图像。比例尺= 10μm。b. p-WSe2和n-MoS2沟道JFET的3D示意性横截面。Au用作两个沟道的接触金属。c.通过探测a中的红点获得的WSe2和MoS2的拉曼光谱。d. p-WSe2和n-MoS2沟道JFET的ID–VDS输出特性。p-WSe2和n-MoS2沟道JFET的ID-VGS传输特性
总而言之,本研究将vdW JFET制成了平面电流器件,在半导体p-MoTe2和n-MoS2TMD之间具有异质结。由于当p型材料用作n沟道的栅极时,该vdW JFET在异质结界面处将具有低密度陷阱,反之亦然,因此实现了0.05–0.1V的微小迟滞和100mV/dec的良好亚阈值摆幅(SS)。此外,vdW JFET始终在〜1V的低漏极电压下表现出易于饱和的特性,并且在接近0V的阈值下再现性地显示出较低的工作栅极电压(p-JFET为+0.2V,n-JFET为-0.2V)。普通的vdW 2D MISFET很少同时实现上述特性。对于具有MoS2沟道的n沟道JFET,ZG迁移率达到〜>500cm2/V·s,而具有MoTe2的p沟道JFET的迁移率要低出一个数量级(〜13cm2/V·s)。这些值与2D FET的先前结果相当或接近。对于低压JFET器件,观察到的开/关电流比为〜> 104。带有超薄vdW 2D TMD的两个沟道JFET的操作被认为是独特的,不同于一般的三维(3D)JFET和MISFET的操作,并且原则上两个相对的(p和n)沟道可以用作彼此的栅极。实验也通过另一个p-TMD / n-TMD JFET(p-WSe2/n-MoS2结) 再次证实了这一原理。因此,可以得出的结论是,类似于2D的超薄沟道JFET在其工作原理,结构和制造简便性方面都足够新鲜,可以影响基于2D半导体的纳米电子学的未来。
本研究使用的SKPM测量是在具有非接触模式的Park XE7进行的。在SKPM成像中, 镀金的探针(PPP-NCSTAu, nanosensors)施加了1.5 V的交流偏压(频率为17kHz)。
Park XE7原子力显微镜

该研究使用了Park XE7原子力显微镜设备完成。Park XE7是一款具备优质性能和ZG性价比的研究型原子力显微镜。
- 通过消除扫描器串扰进行准确的XY扫描
- 具有全面的原子力显微镜解决方案
- 人性化设计的软件和硬件功能
- 可满足各种条件下,对各种样品进行非接触式扫描
2021-04-09相关仪器 -
免责声明
①本网刊载上述内容,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任
②若本站内容侵犯到您的合法权益,请及时告诉,我们马上修改或删除。邮箱:hezou_yiqi

-
 仪网通银牌会员 第
5 年
仪网通银牌会员 第
5 年Park原子力显微镜公司
认证:工商信息已核实
- 产品分类
- 品牌分类
-
仪企号
 Park System Corp.
Park System Corp.
-
友情链接
-
手机版开启全新的世界m.yiqi.com/zt3413/






