5G时代Z重要的半导体材料:碳化硅(SiC)的膜厚测量
作者:Kevin Hu,优尼康科技有限公司高级技术工程师
随着5G大潮的到来,新一代的移动通信产品大多具备高功率,耐高温等特性,传统原料中的硅(Si)无法克服在高温、高压、高频中的损耗,逐渐被淘汰,跟不上时代的发展,无法满足现代工艺的要求,这就使得碳化硅(SiC)新工艺在半导体行业崭露头角。
目前SiC 产品格局还处于三足鼎立的状态,美国、欧洲、日本占据产值的八成,其中又以美国独大,ZG虽以即将进入5G时代,但是半导体在SiC方面仍属于发展初期,目前在基底、磊晶和零组件方面均有布局。
为了把控和检测产品工艺,提高技术生产水平,SiC工艺中管控各种膜厚厚度显得尤为重要。
我们优尼康提供的Filmetrics的光学膜厚仪,因为光学测量具有快速无损等优点,已经广泛使用在半导体相关的企业中,尤其在Z近新兴的SiC器件量测应用中。例如国内SiC生产的企业,中车、华润上华、启迪新材料等等。
SiC工艺中常见测量膜层有:SiO2/PESiO2、SiNx、C膜、多晶硅、非晶硅、光刻胶、BPSG/USG等。
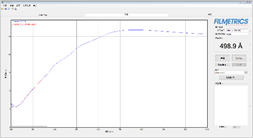

为了更好的解决不断出现的SiC新工艺上的测量问题,也为了能够帮助半导体企业更快更好的提高制作工艺,我们优尼康公司愿意和广大厂家一起进步,为ZG芯片添砖加瓦,有任何相关的测量需求,均可来电和我们技术工程师沟通探讨。
全部评论(0条)
推荐阅读
-
- RTP快速退火炉能提升碳化硅(SiC)芯片欧姆接触的稳定性
- 通过精准调控退火工艺参数,RTP能够快速激活金属与SiC界面处的化学反应,促进“化合物降低势垒”或“碳空位减薄势垒”机制的发生,从而显著提升欧姆接触的稳定性。
-

- 5G的重要开局之年,各压铸企业将如何应对?
- 5G基站和滤波器的高需求也带动了其产业链上的压铸供应商,如滤波器腔体和基站散热壳体的发展。
-
- 二维材料:开启智能设备 “芯” 时代的神奇钥匙
- 研究背景随着科技发展,智能设备需求剧增,传统材料在满足高性能、低维度和多功能需求方面逐渐受限,摩尔定律面临挑战
-

- 赛默飞半导体助力后摩尔时代的“芯”航程
- 这些新技术的诞生为半导体器件生产过程中的良率提升及失效分析带来了新的挑战。
-

- 直播报名 | 半导体制造材料的检测分析与应用
- 7月20日上午09:00-11:15
-
- 真空烘箱?No!先进半导体材料更好的选择源自气氛烘箱
- 华为Mate 60 Pro,让”中国芯“闪耀世界华为闪电发布最新手机Mate 60 Pro引发了全球关注,尽
-

- 半导体需求上升驱动碳化硅价格上涨 仪器行业如何抓牢科技发展机遇?
- 加强技术创新是仪器行业发展的关键。随着科技的不断进步,科学仪器行业将继续迎来技术创新的高潮。未来,科学仪器将更加智能化、自动化,实现更高精度、更高灵敏度的测量和检测。
-

- 【新方法】基于ODPL的化合物半导体材料GaN晶体质量评价
- 由两种或两种以上元素以确定的原子配比形成的化合物,并具有确定的禁带宽度和能带结构等半导体性质的称为化合物半导体材料,化合物半导体材料种类繁多,性质各异,如Ⅲ-Ⅴ族和Ⅱ-Ⅵ族化合物半导体及其固溶体材料,
①本文由仪器网入驻的作者或注册的会员撰写并发布,观点仅代表作者本人,不代表仪器网立场。若内容侵犯到您的合法权益,请及时告诉,我们立即通知作者,并马上删除。
②凡本网注明"来源:仪器网"的所有作品,版权均属于仪器网,转载时须经本网同意,并请注明仪器网(www.yiqi.com)。
③本网转载并注明来源的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品来源,并自负版权等法律责任。
④若本站内容侵犯到您的合法权益,请及时告诉,我们马上修改或删除。邮箱:hezou_yiqi






















参与评论
登录后参与评论