-

-
Bruker FilmTek CD椭偏仪

- 品牌:德国布鲁克
- 型号: FilmTek CD
- 产地:欧洲 德国
- 供应商报价:面议
-
上海尔迪仪器科技有限公司
 更新时间:2025-05-14 09:04:51
更新时间:2025-05-14 09:04:51 -
销售范围售全国
入驻年限第10年
营业执照已审核
- 同类产品椭偏仪(4件)

立即扫码咨询
联系方式:021-61552797
联系我们时请说明在仪器网(www.yiqi.com)上看到的!
扫 码 分 享 -
为您推荐
产品特点
- FilmTekTM CD光学临界尺寸系统是我们解决方案,可用于1x nm设计节点及更高级别的全自动化、高通量CD测量和高级薄膜分析。该系统同时提供已知和完全未知结构的实时多层堆叠特性和CD测量。
FilmTek CD利用多模测量技术来满足与开发和生产中复杂的半导体设计特征相关的挑战性需求。这项技术能够测量极小的线宽,在低于10纳米的范围内进行高精度测量。 详细介绍
Bruker FilmTek CD椭偏仪
——多模态临界尺寸测量和薄膜计量学
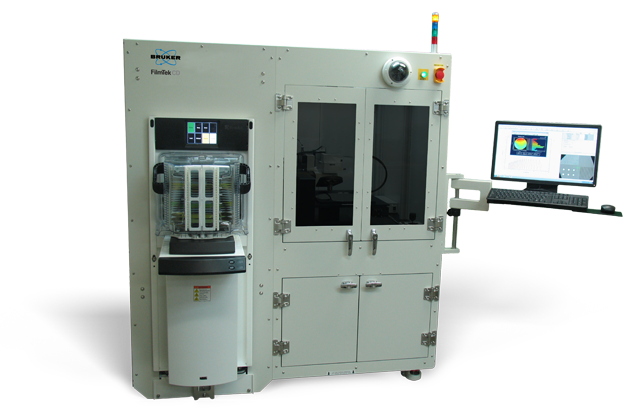
FilmTekTM CD光学临界尺寸系统是我们解决方案,可用于1x nm设计节点及更高级别的全自动化、高通量CD测量和高级薄膜分析。该系统同时提供已知和完全未知结构的实时多层堆叠特性和CD测量。
FilmTek CD利用多模测量技术来满足与开发和生产中复杂的半导体设计特征相关的挑战性需求。这项技术能够测量极小的线宽,在低于10纳米的范围内进行高精度测量。
依赖传统椭圆偏振仪或反射仪技术的现有计量工具在实时准确解析CD测量的能力方面受到限制,需要在设备研究和开发期间生成繁琐的库。FilmTek CD通过获得多模态测量技术克服了这一限制,该技术甚至为完全未知的结构提供了精确的单一解决方案。
FilmTek CD包括具有快速、实时优化功能的专有衍射软件。实时优化允许用户以小的设置时间和配方开发轻松测量未知结构,同时避免与库生成相关的延迟和复杂度。测量能力:
·厚度、折射率和光盘计量
·未知薄膜的光学常数表征
·超薄膜叠层厚度
·广泛的关键尺寸测量应用,包括金属栅极凹槽、高k凹槽、侧壁角、抗蚀剂高度、硬掩模高度、沟槽和接触轮廓以及间距行走系统组件:
标准:
可选:
用于在1x nm设计节点及更远处实时多层堆叠特性和CD测量的多模测量技术
具有专有严格耦合波分析(RCWA)的 多角度散射测量
正入射椭圆偏振光谱法
旋转补偿器设计的光谱广义椭圆偏振法(4×4矩阵广义法)
多角度、DUV-NIR偏振光谱反射(Rs、Rp、Rsp和Rps)
全CD参数测量,包括周期、线宽、沟槽深度和侧壁角度
独立测量薄膜厚度和折射率
抛物面镜技术–在50×50µm功能范围内测量小光斑尺寸
快速、实时优化允许以最短的设置时间实现广泛的应用程序(无需生成库)
模式识别(Cognex)
盒式到盒式晶片处理
FOUP或SMIF兼容SECS/GEM
为了适应广泛的预算和终用途应用,该系统还可作为手动负载、台式设备用于研发 典型应用包括:
半导体研发与生产
技术文章
- 布鲁克x射线衍射仪 D8产品介绍
- bruker台阶仪,可在上海尔迪仪器购买
- 产品介绍|布鲁克纳米红外光谱nanoIR3
- 产品介绍|Bruker FilmTek 2000M TSV
- 产品介绍|Bruker布鲁克 JV-QCVelox
解决方案