技术特性:物理与化学协同的纳米级操控
等离子体刻蚀通过高能等离子体与材料表面的物理轰击和化学反应,实现原子级精度的材料去除。
其技术特性可拆解为:
等离子体生成与活性控制
在低压环境下,射频电源激发反应气体(如CF₄、SF₆)电离,形成由电子、离子和活性自由基(·F、·Cl)组成的等离子体。
通过气体配比调节(如CF₄/CHF₃混合气),可精准控制活性基团浓度,从而优化刻蚀速率与选择比。
方向性刻蚀机制
离子轰击方向由电极偏压调控,实现垂直方向的各向异性刻蚀,侧壁倾斜角可控制在±1°以内,满足高深宽比结构(如通孔、沟槽)需求。
对比湿法刻蚀的各向同性(横向与纵向同步刻蚀),等离子体刻蚀可避免“毛边”或不规则轮廓,确保图形保真度。

表面质量与材料兼容性
刻蚀后表面粗糙度(Ra)可低于1nm,避免应力集中,提升器件可靠性。
覆盖硅基材料(Si、SiO₂)、金属(Al、Cu)及III-V族化合物(GaAs、InP),支持多元化器件制造。
二、工艺优势:精度、效率与可靠性的平衡
突破物理极限的加工能力
实验室已实现0.1μm以下线宽刻蚀,支撑3nm及以下节点芯片研发。
通过自适应控制技术,实时调节等离子体参数(如功率、压力),实现刻蚀速率与选择比的动态优化。
批量生产效率提升
单片反应室设计结合晶圆旋转,保证300mm晶圆刻蚀均匀性<±3%,适配大规模制造。
新型设备(如ICP、IBE)将刻蚀速度提升至微米级/分钟,例如氢氩混合气体工艺中,GaAs刻蚀速率超700nm/min。
解决行业痛点
避免湿法缺陷:替代湿法刻蚀硅基结构,消除液体表面张力导致的粘连问题,提升MEMS器件成品率。
低温工艺支持:结合碳氟聚合物沉积,在<100℃下实现表面改性,防止热应力损伤敏感材料。
全部评论(0条)
 磁控溅射镀膜设备 半导体设备厂家
磁控溅射镀膜设备 半导体设备厂家
报价:¥50000 已咨询 0次
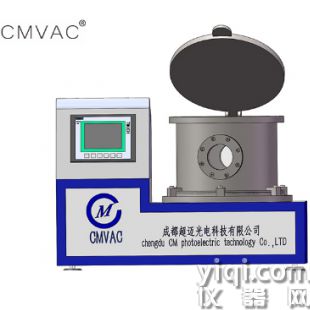 ICP等离子刻蚀设备 刻蚀机品牌厂家
ICP等离子刻蚀设备 刻蚀机品牌厂家
报价:¥300000 已咨询 0次
 IBE350干法刻蚀设备
IBE350干法刻蚀设备
报价:¥400000 已咨询 0次
 大口径等离子刻蚀设备 干法刻蚀机
大口径等离子刻蚀设备 干法刻蚀机
报价:面议 已咨询 0次
2020-04-09
 Syskey 离子束刻蚀机 IBE特点
Syskey 离子束刻蚀机 IBE特点
2025-12-12
2023-10-11
2023-02-16
2021-08-31
2021-08-31








①本文由仪器网入驻的作者或注册的会员撰写并发布,观点仅代表作者本人,不代表仪器网立场。若内容侵犯到您的合法权益,请及时告诉,我们立即通知作者,并马上删除。
②凡本网注明"来源:仪器网"的所有作品,版权均属于仪器网,转载时须经本网同意,并请注明仪器网(www.yiqi.com)。
③本网转载并注明来源的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品来源,并自负版权等法律责任。
④若本站内容侵犯到您的合法权益,请及时告诉,我们马上修改或删除。邮箱:hezou_yiqi
 一机搞定全场景成像!全光谱系统,解码活体生命的“全景密码”
一机搞定全场景成像!全光谱系统,解码活体生命的“全景密码”
参与评论
登录后参与评论