-

-
Park NX-Wafer 业界引领的用于产线计量方案的自动化AFM


- 品牌:Park原子力显微镜
- 型号: NX-Wafer
- 产地:韩国
- 供应商报价: 面议
-
Park原子力显微镜公司
 更新时间:2024-04-08 10:16:50
更新时间:2024-04-08 10:16:50 -
企业性质生产商
入驻年限第5年
营业执照已审核
- 同类产品晶圆厂AFM(3件)
联系方式:帕克客服400-8226768
联系我们时请说明在仪器网(www.yiqi.com)上看到的!
-
为您推荐
- Park NX-Wafer 业界引领的用于产线计量方案的自动化AFM 核心参数
- 详细介绍
概览
晶圆厂专业自动化缺陷检测的原子力显微镜
用于高吞吐量CMP轮廓测量的高精 准低噪声原子力轮廓仪
Park NX-Wafer是业界前沿的半导体及相关制造业自动化AFM计量系统。该系统能提供晶圆制造厂检查和分析、裸晶圆和衬底的自动缺陷检测以及CMP轮廓测量。Park NX-Wafer具有较高的纳米级表面分辨率和亚埃级的高精度。在持续扫描后,探针针尖的变化可以忽略不计,仍具有出众的针尖锐度保护力。
Park NX-Wafer以其专有的自动系统功能而崭露头角,成为目前业界引领的半导体AFM工具。该自动系统包括自动探针更换、实时监控、无参考标记的目标定位和自动分析。
Park NX-Wafer
低噪声原子力轮廓仪,用于更精 准的CMP轮廓测量
亚埃级表面粗糙度测量具有高精度和出众的探针使用寿命
用于缺陷成像和分析的全自动AFM解决方案
全自动系统,包括自动探针更换、机器人晶片搬运
能够扫描300 mm晶圆
应用
为在线晶圆厂计量提供高生产率和强大特性
光片和基板的自动缺陷检测
新的300mm光片ADR提供了从缺陷映射的坐标转换和校正到缺陷的测量和放大扫描成像的全自动缺陷复查过程,该过程不需要样品晶片上的任何参考标记,是重映射过程。与扫描电子显微镜(SEM)运行后在缺陷部位留下方形的破坏性辐照痕迹不同,新的帕克 ADR AFM能够实现坐标转换和更强的视觉,利用晶圆边缘和缺口来自动实现缺陷检查设备和AFM之间的连接。由于它是完全自动化的,因此不需要任何单独的步骤来校准目标缺陷检查系统的移动平台,从而将吞吐量增加到1000%。

基于强大视觉进行自动传送和缺陷映射的校正
利用Park的专有坐标转换技术,新型Park ADR AFM能够将激光散射缺陷检测工具获得的缺陷映射精 准地传送到300mm Park AFM系统。

自动搜索 & 放大扫描
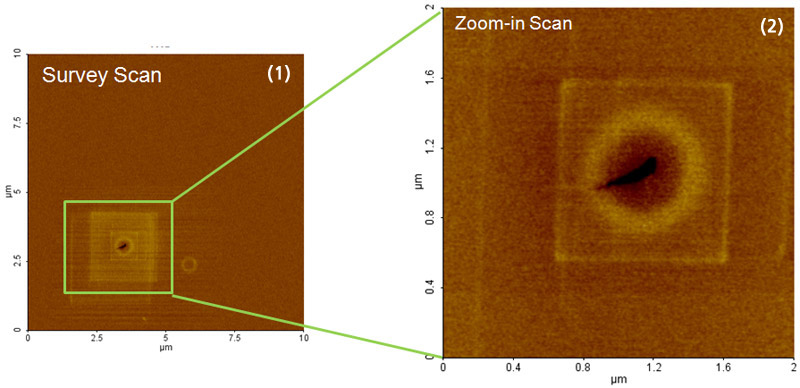
缺陷分两步成像;(1)检测成像,通过AFM或增强光学视觉来完善缺陷定位,然后(2)放大AFM扫描来获得缺陷的详细图像,呈现缺陷类型和随后缺陷尺寸的自动分析。
CMP进行表征的长范围轮廓扫描
平坦化是在使用金属和介电材料的后段工艺中特别重要的步骤。化学机械抛光(CMP)后的局部和全局均匀性对芯片制造的产量有很大的影响。精 准的CMP轮廓扫描是优化工艺条件、获得高平坦度以及提高生产率的关键计量。
结合Park NX-Wafer的滑动平台,为CMP计量提供了远程轮廓分析能力。由于Park自动化原子力显微镜专有的平台设计,组合系统提供非常平坦的轮廓扫描,并且一般在每次测量之后不需要复杂的背景去除或前处理。Park NX-Wafer实现了高精度CMP测量,包括凹陷、侵蚀和边缘过度侵蚀(EOE)的局部和全局的平坦度测量。
亚埃级表面粗糙度控制
半导体供应商正在开发平坦晶圆,以解决不断缩小元件尺寸的需求。然而,从来没有一个计量工具能够给这些拥有亚埃级粗糙度的衬底表面提供准确和可靠的测量。通过在整个晶圆区域提供低于0.5 A的业界低噪声下限,并将其与真正非接触模式相结合,Park NX-Wafer可以对平坦的基底和晶圆进行精 准、可重复和可再现的亚埃级粗糙度测量,并精 准控制针尖的变量。即使对于扫描尺寸达到100μm×100μm的远距离波度,也能够获得非常准确和可重复的表面测量。
高吞吐量晶圆厂检测和分析
• 自动换针
• 设备前端模块(EFEM)用于自动晶圆传送
• 洁净室兼容性和远程控制接口
• 沟槽宽度、深度和角度测量的自动数据采集和分析Park NX-Wafer的特征
长范围轮廓仪
长范围轮廓仪是原子力轮廓仪(AFP)的重要组成部分,并且具有用于自动CMP轮廓扫描和分析的专用用户界面。
• 200mm : 10 mm
• 300mm : 25 mm (optional 10 mm or 50 mm)采用闭环双伺服系统的100μm×100μm柔性导向XY扫描器
XY扫描仪由对称的二维挠曲和高-力的压电堆组成,它们提供高度正交的运动,同时具有较小的平面外运动,以及纳米尺度上精 准样品扫描所必需的高响应性。两个对称的低噪声位置传感器被结合在XY扫描仪的每个轴上,以便为大扫描范围和样品大小保持高水平的扫描正交性。非线性和非平面位置误差的次级传感器校正和补偿是由单个传感器引起的。
拥有低噪声位置传感器的15μm高速Z扫描器
NX-Wafer通过利用其低噪声Z探测器代替通常使用的非线性Z电压信号,为用户提供高测量精度。行业引领的低噪声Z探测器取代应用Z电压作为形貌信号。由高-力压电堆驱动并由挠性结构引导,标准Z扫描器具有高的谐振频率,能够进行更精 准的反馈。Z扫描范围可由15μm扩展到30μm,采用可选的长距离Z扫描仪。
自动测量控制,使您可以获得准确的扫描避免繁琐的工作
 NX-Wafer配备了自动化软件,使操作几乎不费吹灰之力只要选择所需的测量程序,就可获得精 准的多点分析悬臂调整,扫描速率,增益和设定点参数的优化设置。
NX-Wafer配备了自动化软件,使操作几乎不费吹灰之力只要选择所需的测量程序,就可获得精 准的多点分析悬臂调整,扫描速率,增益和设定点参数的优化设置。Park的用户友好的软件界面为您提供了创建定制操作例程的灵活性,以便您可以全方面使用NX-Wafer以获得所需的测量。
创建新例程很容易。从零开始,大约需要10分钟,或不到5分钟修改现有的一个。
Park NX-Wafer的自动化系统特点:
• 无论是自动模式,半自动模式还是手动模式,都可以迅速掌握
• 每个自动例程的可编辑测量方法
• 对测量过程进行实时监测
• 对获得的测量数据的自动分析选项
生产率满足精度要求
自动换针 (ATX)
ATX通过图案识别自动定位针尖,并使用一种新颖的磁性方法使用过的探针脱离并拾取新的探针。然后通过电动定位技术自动对准激光光斑。.

用于更稳定扫描环境的离子化系统
我们创新的离子化系统快速有效地去除了样品环境中的静电电荷。由于该系统总是产生并维持正负离子的理想平衡,因此它可以创建一个特别稳定的电荷环境,几乎不会污染周围区域,且样品处理过程中产生意外静电的风险低微。

自动晶圆装卸器 (EFEM or FOUP)
NX-Wafer可配置各种自动晶圆装卸器(Cassette 或 FOUP 或其他)。高精度、非破坏性的晶圆装卸器的机器人臂充分确保用户始终获得快速可靠的晶圆测量。
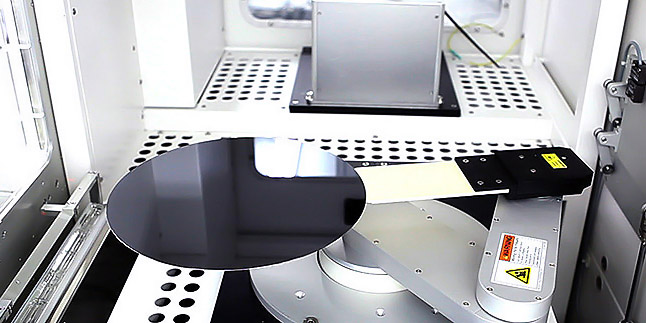
技术参数
Park NX-Wafer技术参数
系统
规格电动XY平台200mm : 行程可达275 mm × 200 mm, 0.5 μm 分辨率
300mm : 行程可达400 mm × 300 mm, 0.5 μm分辨率, 1 µm重复性
电动 Z 平台25 mm Z行程距离,
0.08 µm分辨率, < 1 µm重复性电动聚焦平台9 mm行程Z轴光学距离
样品厚度厚至20 mm
Full scan range Z run-out< 2 nm, repeatability < 1nm
COGNEX图像识别图像校正分辨率 1/4 pixel
扫描仪性能XY扫描器100 µm × 100 µm (大范围模式)
50 µm × 50 µm (中范围模式)
10 µm × 10 µm (小范围模式)
具有闭环控制的单模块挠性XY扫描器
XY扫描器分辨率0.15 nm (大范围模式)
Z扫描器范围15 µm (大范围模式)
Z扫描器分辨率
2 µm (小范围模式)0.016 nm (大范围模式)
Z扫描器噪声
0.002 nm (小范围模式)0.03 nm, rms (typical)
AFM and XY Stage
Control ElectronicsADC18 channels
4个高速通道 ADC通道
X、Y和Z位置传感器(24位ADC)DAC17 channels
2个高速通道 ADC通道
X、Y和Z的定位(20位DAC)合规CESEMI S2/S8标准
振动,噪声,静电防护(ESD)性能地板振动要求< 0.5 µm/s (10 Hz to 200 Hz w/ Active Vibration Isolation System)
噪音>20 dB attenuation w/ Acoustic Enclosure
基础设施需求待机室温10 °C ~ 40 °C
工作室温18 °C ~ 24 °C
湿度30% to 60% (不凝结)
地板振动要求VC-D (6 µm/sec)
噪音Below 65 dB
气动式真空度 : -80 kPa
CDA (or N2): 0.7 MPa
电源额定值208V - 240 V,单相, 15 A (max)
总耗电量2 KW (typical)
接地电阻低于100欧姆
OptionsLong Range Sliding Stage• 200mm : 10 mm
• 300mm : 25 mm (optional 10 mm or 50 mm)自动换针 (ATX)ATX通过图案识别自动定位针尖,并使用一种新颖的磁性方法使用过的探针脱离并拾取新的探针。然后通过电动定位技术自动对准激光光斑。
总动晶圆装卸器 (EFEM or FOUP)NX-Wafer可配置各种自动晶圆装卸器(Cassette 或 FOUP 或其他)。高精度、非破坏性的晶圆装卸器的机器人臂充分确保用户始终获得快速可靠的晶圆测量。
用于更稳定扫描环境的离子化系统我们创新的离子化系统快速有效地去除了样品环境中的静电电荷。由于该系统总是产生并维持正负离子的理想平衡,因此它能够在样品处理期间产生特别稳定的电荷环境,并对周围区域几乎没有污染,且样品处理过程中产生意外静电的风险低微
尺寸 & 重量200 mm系统2732 mm(w) × 1100 mm(d) x 2400 mm(h)
w/ EFEM, 2110 kg approx. (包括控制箱)
升限高度2000 mm or more
操作者工作空间3300 mm (w) x 1950 mm (d), Minimum
300 mm系统3486 mm(w) × 1450 mm(d) x 2400 mm(h)
w/ EFEM, 2950 kg approx. (包括控制箱)
升限高度2000 mm or more
操作者工作空间4770 mm (w) x 3050 mm (d), Minimum
[ Park NX-Wafer 300mm安装布局 ]
| 仪器分类: | AFM |
-
 Park NX20 300mm 用于300毫米晶圆测量和分析的自动化纳米计量工具
Park NX20 300mm 用于300毫米晶圆测量和分析的自动化纳米计量工具
-
 马尔文帕纳科 Morphologi 4 快速自动化粒度和粒形分析
马尔文帕纳科 Morphologi 4 快速自动化粒度和粒形分析
-
 卓立汉光 Finder 930系列全自动化拉曼光谱分析系统
卓立汉光 Finder 930系列全自动化拉曼光谱分析系统
-
 全自动化拉曼光谱分析系统
全自动化拉曼光谱分析系统
-
 CNW dSPE萃取管(AOAC 2007.01),自动化袋装缓冲盐,粉粒状硫酸镁
CNW dSPE萃取管(AOAC 2007.01),自动化袋装缓冲盐,粉粒状硫酸镁
-
 CNW dSPE萃取管(AOAC 2007.01),自动化袋装缓冲盐,粉粒状硫酸镁
CNW dSPE萃取管(AOAC 2007.01),自动化袋装缓冲盐,粉粒状硫酸镁
-
 MicrotracBEL全自动化学吸附仪BELCAT II
MicrotracBEL全自动化学吸附仪BELCAT II
-
 全自动化学反应仪 Flexy-ALR
全自动化学反应仪 Flexy-ALR
-
 安捷伦 Bravo 自动化液体处理平台
安捷伦 Bravo 自动化液体处理平台
-
 安捷伦 4150 TapeStation自动化电泳系统
安捷伦 4150 TapeStation自动化电泳系统
-
 安捷伦 自动化液体处理应用 Bravo NGS
安捷伦 自动化液体处理应用 Bravo NGS
-
 安捷伦 自动化液体处理平台 BenchCel 工作站
安捷伦 自动化液体处理平台 BenchCel 工作站