分析CMP Slurry中的大颗粒
化学机械抛光(CMP)工艺的质量取决于抛光设备和浆料,浆料由包含多种化学添加剂的液体中定义明确的固体颗粒组成。
当今主要的生产问题之一是根据浆液的规格保证其质量,以及在使用时(POU)免受任何形式的降解的稳定性。许多浆料是不稳定的胶体体系,具有相对较短的保存期限。同样,将浆液从容器传输到CMP工具可能是由于剪切,沉降或团聚而导致降解的原因。影响浆料性能的一个关键方面是在CMP过程中会导致缺陷(例如晶片上的微划痕)的大颗粒的存在。
在这里,我们对微电子制造工厂中使用的商用CMP浆料进行详细分析。由于这种特殊的浆料会引起微划痕,因此我们使用扫描电子显微镜检查了其粒径分布,以区分出形成大颗粒的可能原因。与CMP过程工程师密切合作进行的这项研究用于故障排除。
CMP工艺有缺陷
该研究是在有缺陷的CMP工艺运行后开始的;从不同批次的相同类型浆料中选择样品进行比较。
对于每个样品,表1列出了浆液批号,取样位置(移动罐或分配系统),CMP后在晶圆上观察到的平均微划痕数以及微滤器的影响(1.5μm)在POU之前。
另外,我们已经报道了使用来自粒度测量系统公司(PSS,加利福尼亚州圣巴巴拉)的光散射Accusizer 780仪器测量的大颗粒(> 2.1μm)的总密度。
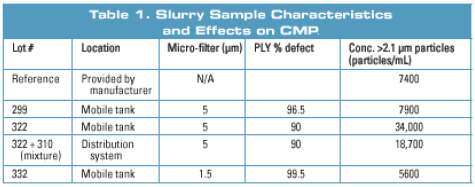
除参考样品外,该列表对应于在工厂中进行的CMP运行的实际顺序。
由微划痕揭示的缺陷的DY个迹象出现在299号批中(PLY缺陷的正常水平为96.5%)。将浆料容器更改为批次322无法解决问题,并且微划痕的数量继续急剧增加。批号322与新批号310混合在一起,并且在POU上安装了微过滤器,但这并不能立即解决问题。
ZZ,由于再次使用批次322时,微划痕消失了,微过滤器开始起作用。有限的一系列实验的过程结果似乎令人惊讶,特别是当考虑到降低过滤孔隙率并不能立即解决问题时。这意味着可以先验地考虑以下几种原因:
·浆料的制造不良,不符合参考样品的原始规格。
·移动罐中的泥浆被污染或降解。
·浆料分配系统中的降解(剪切或沉降的影响)。
·CMP工具本身受到污染。
但是,仅测量大颗粒(> 2.1μm)的总体浓度显然不足以完全决定这些替代方法
请注意,参考样品已包含〜7400颗粒/ mL,在40-200 nm的指定正常范围之外。
扫描电镜观察
在以液体形式取样之后,将浆液进行短时干燥预处理并在过滤器支架上进行制备,这不会导致任何其他颗粒污染。然后将制备的样品引入SEM设备中,以观察和近似计数不同类型和尺寸的颗粒。

Figure 1: Small slurry particles in the specified size distribution.
图1显示了所有在指定范围内的原始浆料颗粒集合。然而,这些小颗粒中的一些趋于形成微米级的附聚物。这些可以分为两类:弱结合的团块,显然仅通过范德华相互作用来连接(图2a);牢固粘结的合金显示出部分烧结的迹象(图2b)。
此外,这些牢固结合的团聚体中的一些团聚体可以达到非常大的尺寸(ZD10μm),并呈现出具有相对尖锐角度的不规则形状,如图2c所示。

a) weakly bonded agglomerates
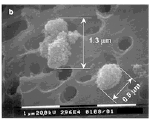
b) strongly bonded agglomerate

c) large agglomerate with sharp angles
Figure 2: Agglomerates of small slurry particles
除参考样品外,在所有样品中也观察到完全不同类型的颗粒。它们由WM球形的球形颗粒组成,它们大多数在微米大小的范围内,并且通常被小的浆料颗粒覆盖(图3a)。但是其中一些球形颗粒达到了10μm(图3b)。

Figure 3: Ball-like particles present in slurries from lots #299 and #322 and due to a defective slurry manufacturing process.
讨论
表2概括了表1中显示的一系列样品中不同类型的团聚体和球形颗粒的出现。值得注意的是,在参考样品中只能检测到弱结合的团聚体,因此可以解释大于2.1μm的7400颗粒/ mL,用Accusizer 780测量.
但是,在生产中使用的所有浆料批次中,甚至在直接从移动储罐中取样的样本中,都观察到了无论大小,都非常牢固的团聚体。

这表明它们未在分配系统中形成,但可能是由于浆料在其容器中的沉降和老化所致。但是,在浆液的储存或分布的温和温度条件下,批号322中观察到的大球形颗粒无法通过任何小颗粒的烧结过程形成。
因此,它们肯定是在这些特定批次的有缺陷的浆料制造过程中生产的。
通过比较这些结果和表1中的观察结果,可以得出微划痕主要是由ZD的团聚体和ZD的球形颗粒(批号322)引起的,而亚微米的团聚体和球形颗粒则具有不可检测的影响,至少对于此特定的CMP过程。
结论
至关重要的是要确保注入CMP工具中的浆料的粒度分布,以避免严重的缺陷,例如微划痕。在这方面,浆料制造商给出的原始粒度规格不足以保证。
有几种因素会导致浆料降解,包括沉降,老化和容器中的部分烧结,这会形成牢固结合的团块。
浆料制造过程中的事故也是可能的,从而导致大的球形颗粒。在POU处进行微过滤,并使用常规的粒径监测仪对> 2.1μm的颗粒进行整体测量可以解决该问题,但是更精细的分析对于追踪大颗粒的起源很有用。
尽管在这项研究中分析的样品数量有限,但SEM仍可以根据颗粒的类型和形状对其进行区分,并且揭示了加工晶圆上微划痕的真正起因。
相关产品
全部评论(0条)
推荐阅读
-
- 半导体应用专题 | CMP Slurry均一性的一体化解决方案
- CMP是通过表面化学作用和机械研磨相结合的技术来实现晶圆表面平坦化。CMP过程中将Slurry(抛光液,也称抛光液)滴在晶圆表明,用抛光垫以一定的速度进行抛光,使得晶圆表面平坦化。
-
- 半导体行业应用专题 | CMP Slurry均一性的一体化解决方案
- 化学机械抛光(CMP)是一种广泛应用于半导体晶圆加工,通过结合化学力和机械力对晶圆表面进行抛光、平坦化。CMP Slury(抛光液研磨液)是用于CMP工艺中的重要原料,通常由纳米及亚微米级别原料组成。
-
- 大颗粒(LPC)对抛光效率和良品率的影响 — TEOS层的CMP抛光研究
- TEOS 是一种特殊的二氧化硅,以四乙基硅酸盐为原料沉积而成,作为阻挡层下的牺牲层。TEOS的均匀性和表面质量对集成电路的可靠性有着至关重要的作用,因此,本文探讨了LPC对TEOS表面质量和抛光过程的影响。
-
- 汽车清洁度分析中,不同种类颗粒的危害性分析
- 飞纳 ParticleX TC 为客户的研发以及生产提供快速、准确和可靠的定量数据支持。
-
- 汽车清洁度分析中,不同种类颗粒的危害性分析
- 飞纳 ParticleX TC 为客户的研发以及生产提供快速、准确和可靠的定量数据支持。
-
- 半导体行业应用专题 | 大颗粒(LPC)对抛光效率和良品率的影响 -- TEOS层的CMP抛光研究.
- 通过实验验证,LPC对MRR(材料去除率)、WIWUN(片内非均匀性)、RMS(均方根粗糙度)都有显著影响:LPC的存在导致边缘MRR增加、WIWNU和RMS粗糙度恶化,使得TEOS晶圆表面质量下降,影响到抛光效率和良品率。
-
- CMP抛光液的平均粒径与Zeta电位分析
- 化学机械抛光/平坦化(CMP)是微电子行业广泛使用的一种通过化学力和机械力结合使表面光滑的工艺。该工艺使用研磨腐蚀性抛光液来帮助晶圆表面平坦化。
-
- 一种利用商用研磨液颗粒评估CMP过滤器拦截效率的新方法
- 通过比较商用研磨液和PSL颗粒之间的拦截差异,使用这种新方法可以进一步确定过滤拦截效率。这有助于推进新的100纳米以下的CMP过滤介质的发展。
-

- 质量流量控制器在半导体CMP设备中的详细应用
- 化学机械抛光(Chemical Mechanical Polishing, CMP)是半导体制造中实现晶圆表面纳米级平坦化的关键工艺。
-
- CMP浆料的快速稳定性研究
- 利用LUM稳定性分析仪进行快速稳定性分析,可用以快速筛选浆料配方,优化工艺。
-
- 用于 CMP 浆料的 AccuSizer系统
- CMP浆料是纳米级磨粒和其他化学品的复杂混合物,包括表面活性剂、pH 调节剂、氧化剂、有机酸和络合剂。磨料的粒度分布是以多种方式影响整个过程的关键参数。磨料平均尺寸和分布宽度会影响材料去除率(MRR)。
-
- 案例分析|Sensofar共聚焦白光干涉仪用于CMP中垫面光泽监测及3D测量
- 用于CMP中垫面光泽监测及3D测量
-
- 磨料粒度和粒形同步检测,异常大颗粒无所遁形
- “千磨万击还坚劲,任尔东西南北风。”不仅坚韧顽强的竹子担得起如此赞美,高强度高硬度的磨料也具有相似的性质。磨
①本文由仪器网入驻的作者或注册的会员撰写并发布,观点仅代表作者本人,不代表仪器网立场。若内容侵犯到您的合法权益,请及时告诉,我们立即通知作者,并马上删除。
②凡本网注明"来源:仪器网"的所有作品,版权均属于仪器网,转载时须经本网同意,并请注明仪器网(www.yiqi.com)。
③本网转载并注明来源的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品来源,并自负版权等法律责任。
④若本站内容侵犯到您的合法权益,请及时告诉,我们马上修改或删除。邮箱:hezou_yiqi





















参与评论
登录后参与评论