SU-8 2000 永 久性环氧负性光刻胶:SU-8 2025,SU-8 2035,SU-8 2050,SU-8 2075
SU-8 2000是一种高对比度的环氧树脂基光刻胶,适用于微加工和其他微电子应用领域,需要厚、化学和热稳定的图像。SU-8 2000是SU-8的改进配方,多年来被MEMS生产厂家广泛使用。采用更快的干燥速度,更极性的溶剂体系,可改善涂层质量,提高工艺吞吐量。SU-8 2000有12种标准粘度可供选择。薄膜厚度0.5到>200微米,可以通过一个单一的涂层工艺实现。暴露的和随后的热交联部分的薄膜是不溶性的液体显影液。SU-8 2000具有良好的成像特性,能够产生非常高的展弦比结构。SU-8 2000在360纳米以上具有非常高的光学传输能力,这使得它非常适合在非常厚的薄膜中近垂直侧壁成像。SU-8 2000最适合yong久应用,它是成像,固化和留在设备上。
SU-8 2000 特性
•高纵横比成像
•0.5 > 200 m 膜 厚度 在 一 个 外套
•改善涂层性能
•加快干燥速度,提高产量
•近UV (350-400 nm)加工
•胎侧垂直
处理指南
SU-8 2000光刻胶最常用的是传统的UV (350-400 nm)辐射,尽管i-line (365 nm)是推荐的波长。SU-8 2000也可以用电子束或x射线照射。在曝光后,交联过程分为两个步骤(1)在曝光过程中形成强酸,接着是(2)在曝光后烘烤(PEB)过程中酸催化、热驱动环氧交联。正常的工艺是:旋涂、软烤、曝光、PEB,然后显影。当SU-8 2000结构仍将作为设备的一部分时,建议使用受控硬烘焙技术进一步交叉连接这些结构。整个过程应针对具体应用进行优化.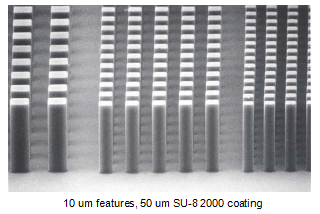
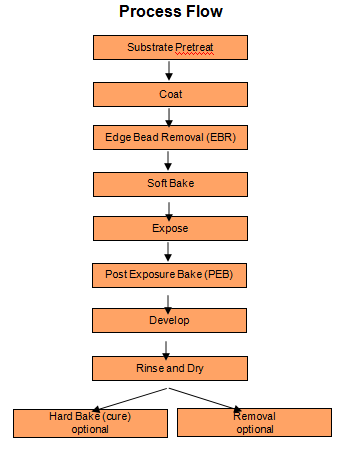
衬底制备
为了获得最大的工艺可靠性,在使用SU-8 2000抗蚀剂之前,基板应保持清洁和干燥。为了达到zui佳效果,底物应该用食人鱼湿蚀刻(使用H2SO4和H2O2)清洗,然后用去离子水冲洗。基片也可以用反应离子蚀刻法清洗(RIE)或任何装有氧气的桶式装置。通常不需要附着力促进剂。对于包括电镀在内的应用,推荐使用MCC引物80/20 (HMDS)对基体进行预处理。
COAT
SU-8 2000有12种标准粘度。本加工指南文件涉及四种产品:SU-8 2025、SU-8 2035、SU-8 2050和SU-8 2075。图1所示。提供所需的信息,以选择合适的SU- 8 2000抗蚀剂和旋转条件,以达到所需的薄膜厚度。
推荐项目
1)。为每英寸(25mm)的衬底直径分配1ml的抗蚀剂。
2)。以每分钟500转的速度旋转5-10秒,加速度为每秒钟100转。
3)。以每分钟2000转的速度旋转30秒,加速度为每秒钟300转。
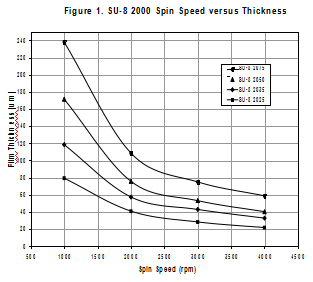
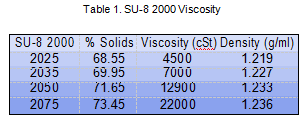
边缘去除(EBR)
在自旋涂覆过程中,光刻胶可能在基板边缘形成。为了最大限度地减少热板的污染,应该去除这个厚珠。这可以通过在晶圆片顶部或底部边缘使用少量溶剂(MicroChem的EBR PG)来实现。大多数自动旋转涂布机现在都有这个功能,可以通过编程自动完成。
通过移除任何边缘珠,掩模可以与晶圆片紧密接触,从而提高分辨率和长宽比。
软烤
建议在软烘烤过程中使用具有良好热控制和均匀性的水平热板。不建议使用对流烤箱。在对流烤箱烘烤过程中,抗蚀剂上可能会形成一层表皮。这种皮肤可以YZ溶剂的进化,导致薄膜不完全干燥和/或延长烘烤时间。表2。显示各种SU-8 2000产品在选定薄膜厚度下的推荐软烘焙温度和时间。
注意:要优化烘烤时间/条件,请在规定时间后将晶圆片从热板中取出,并将其冷却到室温。然后,将晶圆片返回到热板。如果薄膜“起皱”,将晶圆片放在热板上几分钟。重复冷却和加热循环,直到“皱纹”不再出现在影片中。
光学参数
色散曲线和柯西系数如图3所示。这一信息对于基于椭圆度和其他光学测量的薄膜厚度测量是有用的。

曝光
为了在SU-8 2000抗蚀剂中获得垂直侧壁,我们建议使用长通滤波器来消除350NM以下的紫外线辐射。欧米茄光学公司(www.omegafilters.com)或旭硝子科技玻璃公司(AsahiTechnoglass)推荐的V-42型和UV-D35型滤镜(www.atgc.co.jp)的推荐滤镜(PL- 360-LP)需要增加约40%的曝光时间才能达到zui佳的曝光剂量。
注:在zui佳曝光条件下,将显影潜影置于PEB热板上后5-15秒内,而不是之前。应进行接触矩阵实验,以确定zui佳剂量。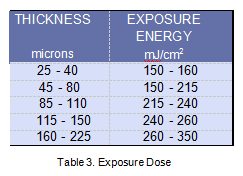
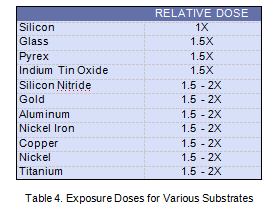
曝光后烘烤(PEB)
PEB应在暴露后直接进行。表5所示。显示推荐的时间和温度。
注:在95°C条件下,经PEB处理1分钟后,SU-8 2000光刻胶涂层应能看到掩膜的图像。如果在PEB期间或之后没有看到可见的潜影,这意味着没有足够的曝光、加热或两者兼备。

发展
SU-8 2000型光刻胶已与MicroChem公司的SU-8显影剂一起被设计用于浸没、喷雾或水坑工艺。其他溶剂型显影剂,如乳酸乙酯和二丙酮醇也可以使用。当发展高展弦比和/或厚膜结构时,强烈搅拌是推荐的。表6给出了浸入式工艺的推荐开发时间。这些发展时间是近似的,因为实际溶解速率可能随搅拌作用而变化很大
注:使用超声波或megasonic浴可能有助于开发通过或孔的模式或结构与紧密节距。
清洗和干燥
使用SU-8显影剂时,喷洗显影剂图4。光学透过率图像用新鲜溶液冲洗约10秒,然后用异丙醇(IPA)再喷/洗10秒。空气干燥与过滤,加压空气或氮气。
注:IPA冲洗过程中产生的白色薄膜表明未曝光的光刻胶发育不良。只需简单地用额外的SU-8显影剂浸没或喷洒基板即可除去白色薄膜并完成显影过程。重复清洗步骤。
使用超声波或megasonic浴将激活溶剂,并允许更有效地开发未暴露的抗蚀剂。
物理性质(近似值)

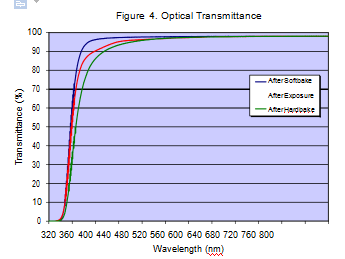
光学性质
图4的流程条件。软烤:5分钟,在95°C暴露:180 mJ/cm2
硬烘焙:300°C, 30分钟
硬烤
SU-8 2000具有良好的机械性能。然而,对于那些将成像电阻作为设备的一部分保留的应用程序,可以将硬烘焙加入到该过程中。这通常只有在设备或部件在常规操作中进行热处理时才需要。一个硬烘焙或zui后的固化骤,以确保SU-8 2000的性质不改变在实际使用。SU-8 2000是一种热树脂,因此,当暴露在比以前更高的温度下时,它的性能可以继续变化。我们建议使用比设备最大运行温度高10℃的烘烤温度。根据需要的固化程度,通常使用的烘焙温度范围在150°C到250°C之间,时间在5到30分钟之间。
注:硬烘烤步骤也适用于退火任何表面裂纹,可能是明显的发展后。推荐的步骤是在150°C的温度下烘烤几分钟。这适用于所有的薄膜厚度。
等离子体去除
SU-8 2000被设计为一种yong久性、高交联的环氧树脂材料,用传统的溶剂型抗剥离剂很难去除。MicroChem的去除剂PG将膨胀,并发射最小交联SU-8 2000。然而,如果使用OmniCoat (30-100 nm),浸泡在去除剂PG中,可以使SU- 8 2000材料得到干净彻底的提升。如果不使用OmniCoat,则不能完全固化或硬烘焙SU-8 2000。
去除最小交联SU-8 2000,或使用Omnicoat时:将去除剂PG浴加热到50-80℃,并将底物浸泡30-90分钟。实际带钢时间将取决于抗蚀剂厚度和交联密度。有关微化学Omnicoat和去除剂PG的更多信息,请参阅相关产品数据表。
重新工作完全交联的SU-8 2000:晶圆片可以剥离氧化酸溶液,如食人鱼蚀刻,等离子灰,RIE,激光烧蚀和热解。
等离子体去除
RIE 200W, 80sccm O2, 8sccm CF4, 100mTorr, 10℃
存储
在40-70°F(4-21°C)的温度下,将SU-8 2000储存在阴凉干燥的环境中,避免阳光直射。远离光、酸、热和火源。保质期为自生产之日起十二个月。
处理
根据当地的州和联邦法规,SU-8 2000的抗蚀剂可以和其他含有类似有机溶剂的废物一起被丢弃销毁或回收。客户有责任确保处置符合所有联邦、州和当地环境法规的SU-8 2000抗蚀剂和残留物。
环境、健康和安全
在使用SU-8 2000抗阻剂前,请参阅产品材料安全数据表。小心轻放。在处理SU-8 2000耐药时,应戴上化学护目镜、化学手套及适当的防护服。不要进入眼睛、皮肤或衣服。使用时应通风良好,避免吸入蒸汽或薄雾。如与皮肤接触,请用肥皂和清水冲洗患处。如不慎与眼睛接触,应立即用清水冲洗,并经常提起眼睑冲洗15分钟。寻求紧急医疗援助。
这些信息基于我们的经验,我们认为是可靠的,但可能不完整。对于这些产品的信息、使用、处理、存储或拥有,或本协议中描述的任何过程的应用或期望的结果,我们不作任何明示或暗示的担保或保证,因为这些产品的使用和处理条件超出了我们的控制。
- 产品分类
- 品牌分类
- 光刻机/3D打印机/电子束直写仪
- 镀膜沉积系统
- 离子刻蚀与沉积系统
- 匀胶涂覆系统
- 半导体辅助工艺/光刻胶
- 半导体微纳检测仪
- 实验检测仪器
- 太阳能检测仪
- 紫外线UV光清洗/等离子清洗
- 晶圆贴片/贴膜/UV解胶机/晶圆清洗机
- (美国)美国SCIEX
- (美国)美国Denton Vacuum
- (日本)日本SEN
- (美国)美国海马
- (德国)德国iplas
- (美国)美国Jelight
- (美国)美国Sinton Instruments
- (美国)美国Nano-Master
- (美国)美国novascan
- (美国)美国Neocera
- (美国)美国Trion
- (美国)美国UVOCS
- (成都)中科院
- (台北)台湾正恩科技
- (比利时)比利时宝镭泽
- (德国)德国Allresist
- (瑞士)瑞士Sawatec
- (德国)德国Diener
- (美国)美国AZ technology
- (美国)美国劳瑞尔
- (美国)美国Uvitron
- (英国)英国EMS
- (美国)美国MicroChem
- (德国)德国Optosol
- (深圳)深圳一正
- (德国)德国FS Bondtec
- (美国)美国Newport
- (英国)英国MML
- (美国)美国Nisene
- (美国)美国VTI
- (美国)美国FEI
- (美国)美国RKD
- (德国)德国PVA TePla
- (日本)日本理学
- (英国)英国AML
- (美国)美国PI
- (日本)富士
- (日本)日本Advance Riko
- (美国)美国Sonoplot
- (香港)托普斯
- (美国)美国Quantum Design
- (美国)美国泰德派勒
- (丹麦)丹麦NIL TECHNOLOGY
- (日本)日本RIBM
- (美国)美国SCS
- (瑞典)瑞典Obducat
- (德国)德国布鲁克
- (韩国)韩国ATI
- (德国)德国海德堡
- (日本)日本伊领科思
- (美国)赛默飞世尔
- (西班牙)西班牙Mecwins
- (德国)德国纳糯
- (德国)徕卡生物系统
- (美国)美国泰克
- (美国)美国Harrick
- (德国)德国SUSS MicroTec
- (日本)日本基恩士
- (瑞士)瑞士nanosurf
- (德国)德国ParcanNano
- (德国)德国蔡司
- (奥地利)奥地利EVG
- (美国)美国MMR
- (英国)英国牛津
- (德国)德国Raith
- (日本)日本 Ulvac
- (韩国)韩国ECOPIA
- (德国)凯斯安KSI
- (德国)德国Eulitha
- (苏州)苏州纳维科技
- (新竹)台湾智果整合
- (德国)德国Nanoscribe
- (俄罗斯)俄罗斯Optosystem
- (法国)法国Annealsys
- (德国)德国Klocke Nanotechnik
- (荷兰)荷兰TSST
- (英国)英国Durham Magneto Optic
- (德国)德国Finetech
- (日本)日本AND
- (日本)日本Tohuko
- (瑞典)瑞典Mycronic
- (日本)日本理音
- (美国)美国KLA
- (美国)美国D&S
- (瑞士)瑞士Swisslitho AG
- (德国)德国MBE-Komponenten
- (美国)美国RTI
- (英国)英国牛津真空
- (日本)日本电子
- (德国)德国UniTemp
- (美国)美国Nanovea
- (美国)美国德龙
- (日本)日本尼康
- (美国)湖岸LakeShore
- (美国)美国SONIX
- (德国)德国YXLON
- (美国)美国OAI
- (美国)美国阿兹特克
- (美国)美国Royce
- (美国)美国OGP
- (美国)美国相干
- (深圳)杰普特
- (美国)美国Filmetrics
- (美国)美国Thorlabs
- (美国)美国nanoArch
- (英国)英国Quorum
- (美国)美国Anasazi
- (美国)美国Montana Instruments
- (芬兰)芬兰Picosun
- (土耳其)土耳其ADLEMA
- (苏州)苏州纽迈
- (法国)法国Alyxan
- (英国)英国NanoBeam
- (德国)德国YXLON
- (德国)德国neaspec
- (瑞典)瑞典NanOsc
- (德国)德国Sentech
- (德国)德国Attocube Systems
- (东莞)庆达VIPUV
- (英国)英国HHV
- (德国)德国耐驰
- (英国)NanoMagnetics
- (法国)法国Plassys
- (美国)美国Associated Research
- (日本)日立
- (英国)牛津仪器
- (德国)德国克吕士
-
仪企号
 深圳市蓝星宇电子科技有限公司
深圳市蓝星宇电子科技有限公司
-
友情链接
































































































































