-

-
多点纳米膜厚测量仪 C11295
- 品牌:日本滨松
- 型号: C11295
- 产地:亚洲 日本
- 供应商报价:面议
-
滨松光子学商贸(中国)有限公司
 更新时间:2025-02-24 10:56:46
更新时间:2025-02-24 10:56:46 -
销售范围售全国
入驻年限第10年
营业执照已审核
- 同类产品膜厚测量系统(12件)

立即扫码咨询
联系方式:400-074-6866
联系我们时请说明在仪器网(www.yiqi.com)上看到的!
扫 码 分 享 -
为您推荐
产品特点
C11295型多点纳米膜厚测量系统使用光谱相干测量学,用以测量半导体制造过程中的薄膜厚度,以及安装在半导体制造设备上的APC和薄膜的质量控制。C11295可进行实时多点测量,也可以在膜厚测量中同时测量反射率(透射率)、目标颜色以及暂时变化。
详细介绍
- 详细参数
型号 C11295-XX*1 可测膜厚范围(玻璃) 20 nm to 100 μm*2 测量可重复性(玻璃) 0.02 nm*3 *4 测量准确性(玻璃) ±0.4 %*4 *5 光源 Xenon light source *6 光斑尺寸 Approx. φ1 mm*4 工作距离 10 mm*4 可测层数 Max. 10 layers 分析 FFT analysis, Fitting analysis 测量时间 19 ms/point*7 光纤连接头 SMA 外部控制功能 Ethernet 电源 AC100 V to AC240 V, 50 Hz/60 Hz 功耗 At 2ch: Approx. 330 VA, at 15ch: Approx. 450 VA 测量波长范围 320 nm to 1000 nm 接口 USB 2.0 (Main unit - Computer) RS-232C (Light source - Computer) 测量点数 2 to 15
* 1:-XX表示测量点的数量。
* 2:转换时玻璃的折射率= 1.5。
* 3:测量400nm厚的玻璃膜时的标准偏差(公差)。
* 4:取决于要使用的光学系统或物镜放大倍率。
* 5:测量范围保证在VLSI标准记录保证范围内。
* 6:卤素光源型号为C11295-XXH。
* 7:最短曝光时间。产品特性● 多达15点同时测量
● 无参照物工作
● 通过光强波动校正功能实现长时间稳定测量
● 提醒及警报功能(通过或失败)
● 反射(透射)和光谱测量
● 高速、高准确度
● 实时测量
● 不整平薄膜精确测量
● 分析光学常数(n,k)
- ● 可外部控制
外形尺寸(单位:mm)

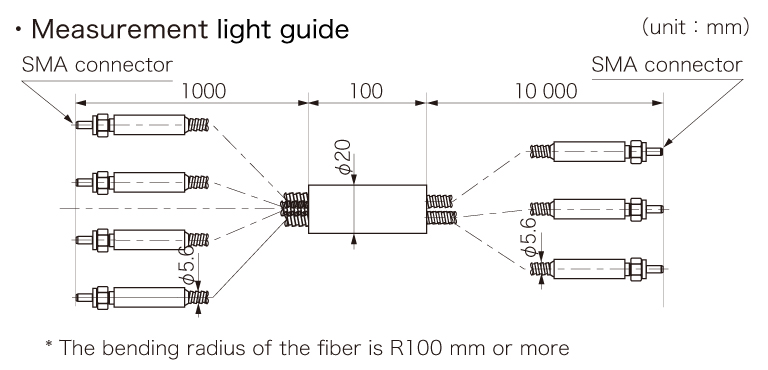

技术资料


























