


 德国 ALLRESIST 紫外光刻胶
德国 ALLRESIST 紫外光刻胶
 德国 ALLRESIST 紫外光刻胶
德国 ALLRESIST 紫外光刻胶
 德国 ALLRESIST 紫外光刻胶
德国 ALLRESIST 紫外光刻胶
 德国Allresist 特殊工艺用光刻胶
德国Allresist 特殊工艺用光刻胶
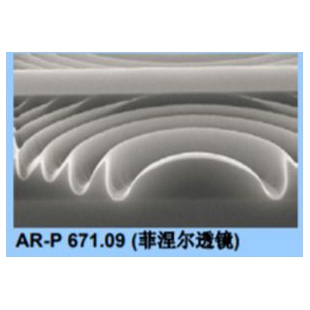 德国Allresist 电子束光刻胶AR-P 617
德国Allresist 电子束光刻胶AR-P 617
德国 ALLRESIST 紫外光刻胶
1. 紫外光刻胶(Photoresist)
1)各种工艺:喷涂专用胶,化学放大胶,lift-off胶,图形反转胶,高分辨率胶,LIGA用胶等。
2)各种波长: 深紫外(Deep UV)、I线(i-line)、G线(g-line)、长波(longwave)曝光用光刻胶。
3)各种厚度: 光刻胶厚度可从几十纳米到上百微米。
电子束光刻胶(电子束抗蚀剂)(E-beam resist)
1)电子束正胶:PMMA胶,PMMA/MA聚合物, LIGA用胶等。
2)电子束负胶:高分辨率电子束负胶,化学放大胶(高灵敏度电子束胶)等。
特殊工艺用光刻胶(Special manufacture/experimental sample)
电子束曝光导电胶,耐酸碱保护胶,聚酰亚胺胶(耐高温保护胶),全息光刻用胶,长波曝光胶,深紫外曝光胶等特殊工艺用胶。
4.配套试剂(Process chemicals)
显影液、除胶剂、稀释剂、增附剂(粘附剂)、定影液等。
一.紫外光刻胶(Photoresist)
1. 正胶:
AR-P 1200 喷涂用光刻胶(Spray Coating)
适合喷涂(Spray Coating)的正性光刻胶,高灵敏度。胶层表面非常平整,且可很好的保护粗糙的衬底表面,可用于复杂工艺。

AR-P 3100 薄胶
高灵敏度光刻胶,胶膜薄且均匀。在玻璃和镀铬表面附着力好,可用于光学器件加工、掩膜制作、激光干涉曝光等。另有,AR-P 3170 可以做出 100nm,甚至更小的线条(几十纳米)。

AR-P 3200 厚胶
黏度大,可得到厚胶膜,厚度可达几十微米,甚至上百微米。胶膜覆盖能力好,适合粗糙的 Wafer 表面涂胶,可很好的保护结构边缘。图形剖面边缘陡直。适合做LIGA或电镀工艺等。
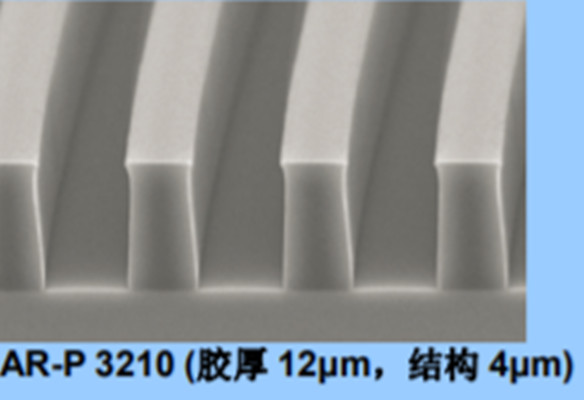
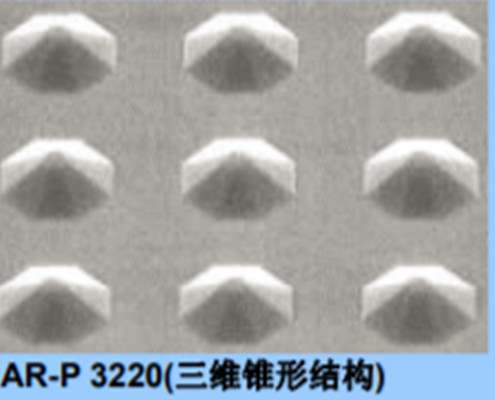
AR-P 3500,AR-P 3500T 通用型光刻胶
适于集成电路制造中的掩膜加工。高敏感、高分辨率且在金属和氧化物表面附着力好。其中,AR-P 3500T是针对 AR-P 3500 系列进行优化,而新研制的一种光刻胶;性能和AR-P 3500相似,同时还具备了良好的耐等离子刻蚀性能,以及大的工艺宽容度。
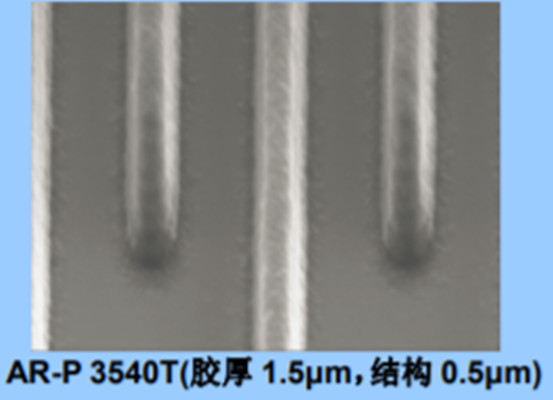
AR-P 3700/3800 高分辨率光刻胶
可用于制作亚微米结构,如高集成电路等。甩胶层表面平整均匀,高敏感度,高对比,良好的结构稳定性,工艺要求范围宽。AR-P 3840为染色的光刻胶,可以降低驻波和散射等的影响。

AR-P 5300 单层Lift-Off工艺用胶
Lift-off工艺用胶,利用普通的光刻工艺便可很容易得进行剥离工艺。高敏感、高分辨率,且与金属和氧化物表面附着良好。
2. 图形反转胶
AR-U 4000 图形反转胶
通过调整工艺参数可实现正胶或负胶性能。图形反转工艺后,光刻胶呈现负胶性能,可以得到非常明星的倒梯形结果,用于lift-off工艺。

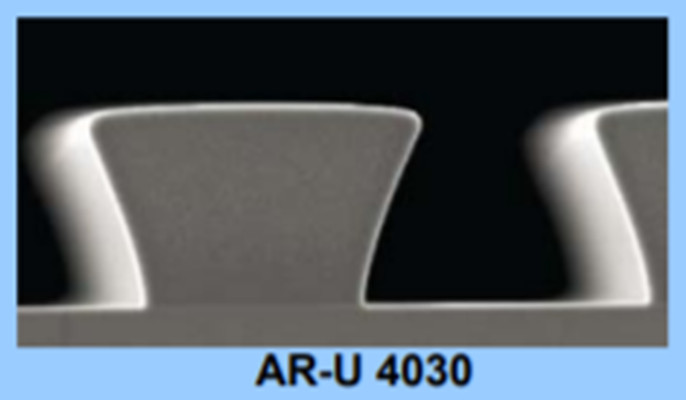
3.负胶
AR-N 2200
适合喷涂(Spray Coating)的负性光刻胶,高灵敏度。胶层表面非常平整,且可很好的保护粗糙的衬底表面,可用于复杂工艺。
AR-N 4240 紫外、深紫外曝光,可做lift-off工艺
i线、深紫外曝光。适合制作亚微米图形,专为满足先进集成电路制造中的关键工艺要求而设计。良好的耐等离子体刻蚀性能,在金属和氧化物表面的附着力好,并可用于lift-off工艺。

AR-N 4340 化学放大胶,紫外曝光,可做lift-off工艺
i线、g线曝光。化学放大胶,高灵敏度,高分辨率,高对比度,在金属和氧化物表面附着力好,可用于lift-off工艺。
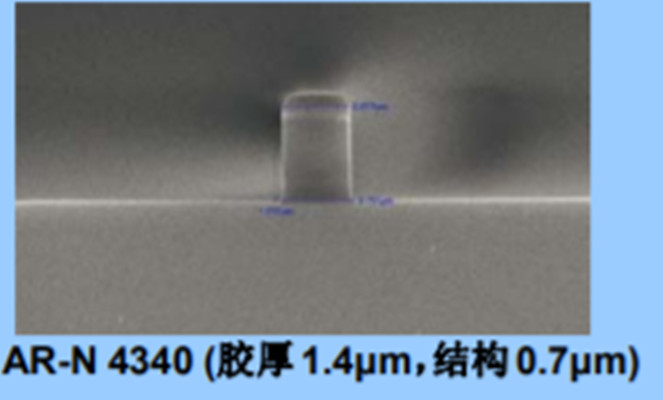
AR-N 4400 厚胶,化学放大胶,可以做lift-off工艺
i线、g线、深紫外、X-ray、电子束等都可以实现曝光。涂胶厚度从几十微米到上百微米,覆盖能力好,可用于表面粗糙的wafer表面涂覆,且剖面陡直,高分辨率。化学放大胶,灵敏度也非常高。可用于LIGA、电镀等工艺。采用碱性水溶液显影,除胶非常容易,可以提到传统的SU8胶。

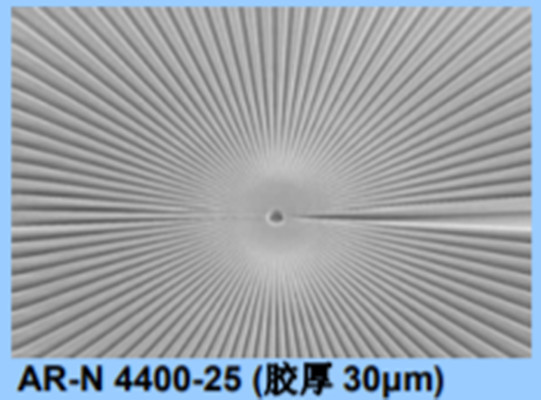
二.电子束抗蚀剂
1.正胶
PMMA(AR-P 631~ 671,AR-P 639~ 679,AR-P 672)
PMMA胶最主要的特点是高分辨率、高对比度、低灵敏度。
PMMA胶种类齐全,不同的系列中包含了各种分子量(50K, 200K, 600K, 950K),各种溶剂(氯苯,乳酸乙酯,苯甲醚)以及各种固含量的PMMA胶,以满足各类电子束光刻的工艺要求。另外,厂商还可以根据客户的具体需求来生产其他分子量、固含量的PMMA胶。
PMMA胶可用于单层或双层电子束曝光、转移碳纳米管或石墨烯、绝缘层等多种工艺。
(注:工厂可根据用户的需求,定制所需分子量、固含量的PMMA胶。)
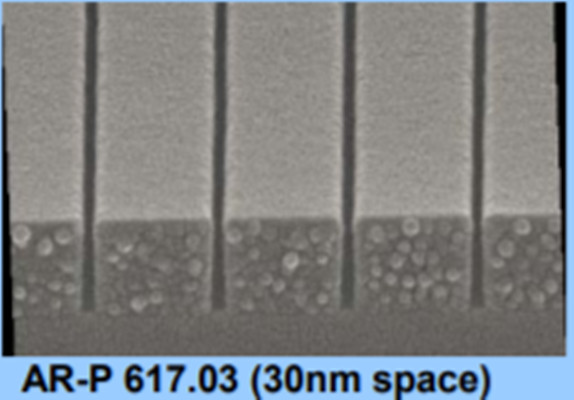
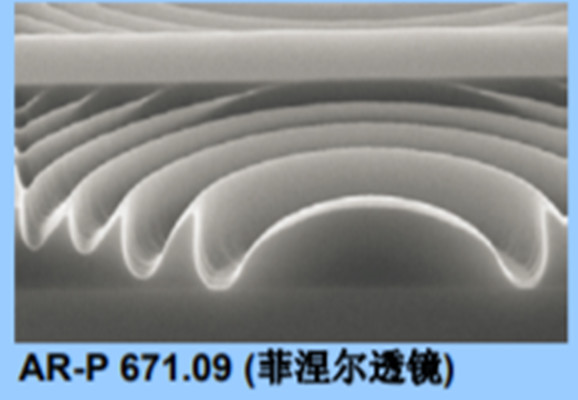
AR-P 617 (PMMA/MA共聚物)
适合目前各种应用需要的电子束光刻胶。灵敏度高,是普通PMMA胶的3~ 4倍,对比度亦高于PMMA。 PMMA/MA共聚物也可以和PMMA通过双层工艺实现lift-off工艺。
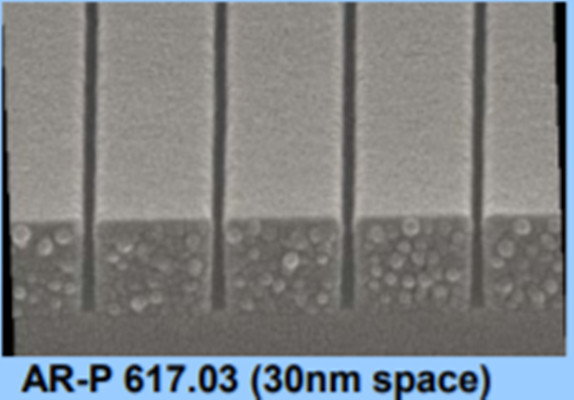
AR-P 6200 超高分辨率、高耐刻蚀电子束正胶
高分辨率,通过简单的工艺即可得到10nm甚至更小的结构。高深宽比(可达20:1),高对比度(>15)。良好的耐干法刻蚀性能,是PMMA胶的2倍。完全可以取代ZEP胶,经济实惠,并且采购简单,包装规格多样化。
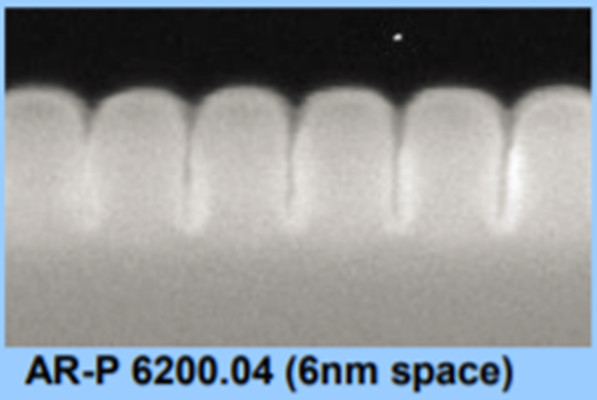
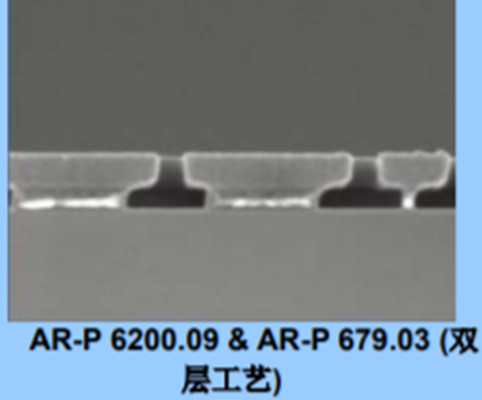
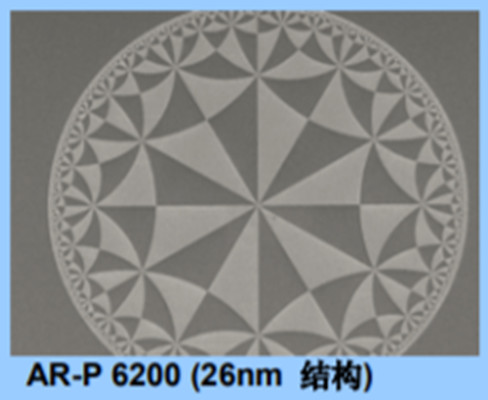
AR-P 6510 (PMMA厚胶)LIGA工艺用正胶
以PMMA为基础开发出的电子束厚胶,厚度从10~250μm不等,图形剖面陡直。主要用于LIGA工艺和X-Ray 曝光工艺。

2.负胶
AR-N 7500, AR-N 7520 电子束负胶,高分辨率
分辨率高(30nm),对比度高(> 5),良好的耐等离子刻蚀性能,可以用于混合曝光。灵敏度中等,介于AR-N 7700和PMMA之间。
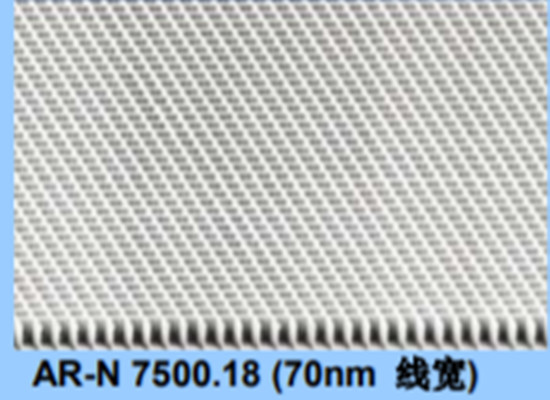

AR-N 7700 电子束负胶,化学放大胶,高灵敏度
化学放大负胶,高灵敏度,高对比度,良好的耐等离子刻蚀刻蚀性能,可以用于混合曝光。
AR-N 7720 电子束负胶,三维曝光
化学放大负胶,高灵敏度,对比度非常小(<1),非常适合制作三维结构;也可以用于衍射光学及全息器件的加工。

X AR-N 7700/30,SX AR-N 7700/37 电子束负胶,化学放大胶,超高灵敏度
化学放大负胶,超高高分辨率,良好的耐等离子刻蚀能力,适合混合曝光。高灵敏度,灵敏度比AR-N 7700更高。
三 .特殊用途的光刻胶
AR-PC 5090.02 /5091.02电子束曝光用导电胶,不含光敏物质。
在绝缘衬底上做电子束曝光时,为了避免电荷累积,大家通常会选择涂一层导电胶,来消除电荷累积。在正常的曝光结束后,导电胶会溶于水中,非常容易去除,不会影响正常的电子束曝光工艺。
AR-BR 5400 双层Lift-Off工艺底层胶
可以得到稳定的Lift-off结构,利于金属的沉积。在制作双层工艺时,需要和正胶AR-P 3500或AR-P 3500T配合使用。从270nm到红外区,有良好的光学透明性,热稳定性好。
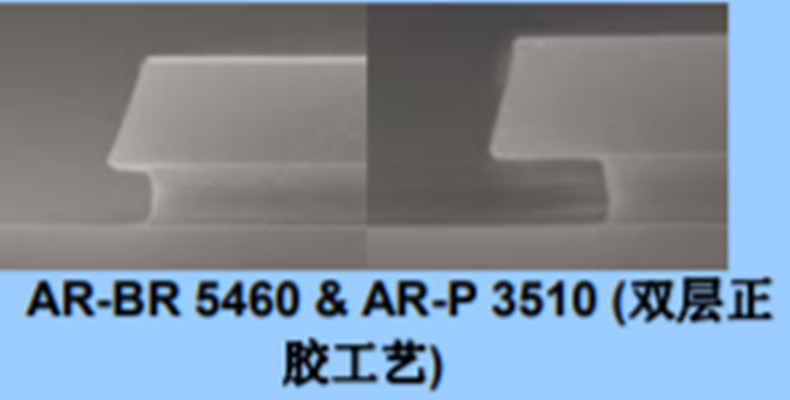
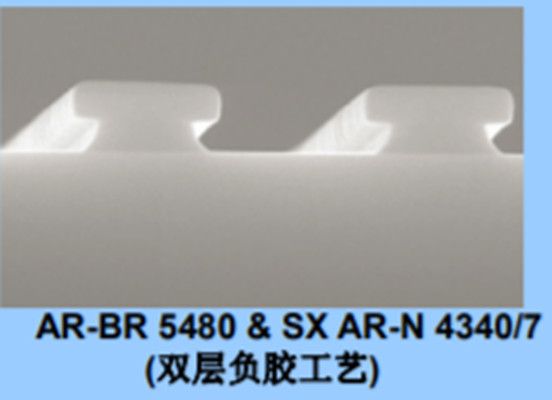
AR-PC 500 耐酸碱保护胶
在酸碱中有很好的耐刻蚀性能,不含光敏物质。尤其在碱性环境(40% KOH)中非常稳定。一般涂于衬底背面,防止刻蚀工艺中的化学物质损害其背面结构。503颜色为黑色,较504耐刻蚀性能稍弱。

SX AR-PC 5000/40 耐酸碱保护胶
在酸碱中有很好的耐刻蚀性能,不含光敏物质。在40%的KOH和50%的HF中,具有很好的保护作用的,耐刻蚀时间可以长达数小时。另外,还可以和正胶配合使用,通过双层工艺来制作图形。

AR-P 5910 耐HF酸刻蚀光刻胶,正胶
对基底有很好的粘附性,一般用于低浓度的HF,在5% 以下的HF 酸中有很好的保护作用。
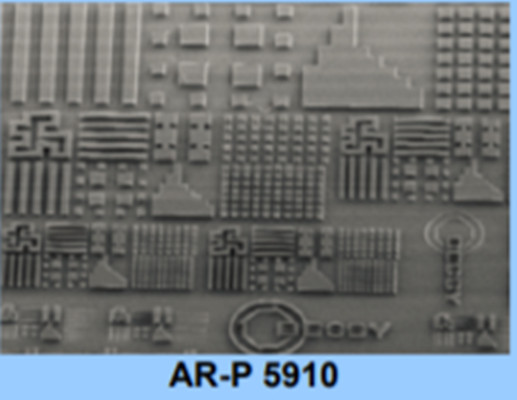
X AR-P 5900/4 耐碱刻蚀光刻胶,正胶
主要用于耐碱刻蚀以及保护层。光刻胶可以在2n(2mol/L)的NaOH中可以稳定很长时间。
SX AR-PC 5000/80 聚酰亚胺光刻胶,不含光敏物质
热稳定性光刻胶,在400°C时仍然很稳定。不含光敏物质,但是可以和正胶配合使用,通过双层工艺来制作图形。可以用于制作传感器材料、保护层及绝缘层。
SX AR-PC 5000/82 聚酰亚胺光刻胶,紫外正胶
热稳定性光刻胶,正胶,在400°C时仍然很稳定。具有良好的耐等离子刻蚀性能,可用于离子注入工艺。
X AR-P 5800/7 深紫外曝光胶,正胶
深紫外曝光(248 - 265 nm 和300 - 450 nm),在这个波长范围内,光刻胶的透射率高。耐刻蚀性能好。适合接触曝光,曝光过程中,产生的氮气少,可以提高图形质量。
SX AR-P 3500/6 全息曝光用胶,正胶
在长波段具有很好的灵敏度,敏感波段为(308 – 500nm),主要用于全息曝光工艺。
SX AR-N 4800/16 有机溶剂显影光刻胶(用于无水环境),负胶
基于PMMA的负胶,曝光波长230 – 365nm。主要用于工艺中衬底材料对水敏感,需要无水环境操作的情况。采用有机溶剂显影,避免了水或潮气对衬底材料的破坏。
四.配套试剂
显影液
多种配套显影液,可用于紫外光刻胶,电子束光刻胶、特殊用途用等光刻胶的显影。
定影液
主要用于电子束光刻胶用定影液。
除胶剂
多种配套除胶剂,可用于紫外光刻胶,电子束光刻胶、特殊用途用等光刻胶的除胶。
稀释剂
多种配套稀释剂,可用于紫外光刻胶,电子束光刻胶、特殊用途用等光刻胶的稀释。
增附剂
除了传统的HMDS可作为增附剂外,我们还可以提供AR 300-80型增附剂,AR 300-80使用更简单,毒性更小。

报价:面议
已咨询1263次光刻胶

报价:面议
已咨询2842次光刻胶

报价:面议
已咨询577次光刻胶

报价:面议
已咨询534次光刻胶

报价:面议
已咨询1425次光刻胶

报价:面议
已咨询1137次光刻胶
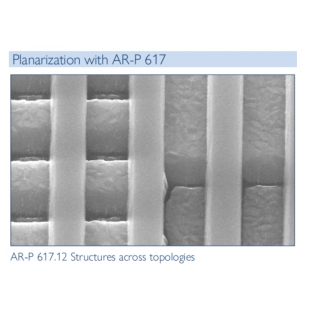
报价:面议
已咨询1668次光刻胶

报价:面议
已咨询818次光刻胶

IXION 193 SLM 是一款单频全固态激光系统,适用于光学计量、193 nm 步进光学元件校准或高功率 ArF 准分子激光器的带宽控制等应用。

IXION 193 SLM 是一款单频全固态激光系统,适用于光学计量、193 nm 步进光学元件校准或高功率 ArF 准分子激光器的带宽控制等应用。

ASML 光刻机 Twinscan NXT:1980Di

Syskey 紧凑式溅射系统 Compact Sputter,灵活的基板尺寸,最大可达6英寸,基板架加热温度最高可达500℃,出色的薄膜均匀性,误差小于±3%, 最多可配备5个6英寸磁控溅射源(可选配3或4个),支持射频、直流或脉冲直流电源,最多可支持3条气体管路,支持顺序沉积和共沉积。

Syskey 紧凑式热蒸发系统 Compact Thermal ,灵活的基板尺寸,最大可达6英寸, 基板架加热温度最高可达500℃,出色的薄膜均匀性,误差小于±3%,可选配电子束或热舟蒸发源(最多3个),速率控制沉积,可沉积多层薄膜,选用特定目标材料

高真空溅射系统 HV Sputter,灵活的基板尺寸,最大可达12英寸或200×200毫米, 基板架加热温度最高可达800℃,出色的薄膜均匀性,误差小于±3%

超高真空磁控溅射镀膜机 UHV Sputter,• 基板支架加热至 800 °C • 优异的薄膜均匀性小于 ±3% • 磁控溅射源(数量最多 8 个),可选强磁版本

Syskey 高真空热蒸发镀膜机HV Thermal 高真空热蒸发系统可提供的真空环境 用于常见薄膜沉积,包括金属、有机物、钙钛矿和化合物。全自动系统可满足各种应用要求,包括OLED、OPV、OPD等。