
 德国 ALLRESIST 紫外光刻胶
德国 ALLRESIST 紫外光刻胶
 德国 ALLRESIST 紫外光刻胶
德国 ALLRESIST 紫外光刻胶
 德国 ALLRESIST 紫外光刻胶
德国 ALLRESIST 紫外光刻胶
 德国Allresist 特殊工艺用光刻胶
德国Allresist 特殊工艺用光刻胶
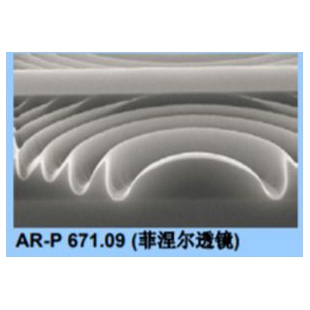 德国Allresist 电子束光刻胶AR-P 617
德国Allresist 电子束光刻胶AR-P 617
德国Allresist 特殊工艺用光刻胶
Special manufacture/experimental sample
型号 | 特性 | ||
导电胶 | 电子束曝光用导电层,不含光敏物质。 | ||
AR-BR 5400 | 双层Lift-Off工艺底层胶 | ||
AR-PC 500 | 耐酸碱保护胶 | ||
SX AR-PC 5000/40 | 耐酸碱保护胶 | ||
AR-P 5910 | 耐HF酸刻蚀光刻胶,正胶 | ||
X AR-P 5900/4 | 耐碱刻蚀光刻胶,正胶 | ||
SX AR-PC 5000/80 | 聚酰亚胺光刻胶,不含光敏物质 | ||
SX AR-PC 5000/82 | 聚酰亚胺光刻胶,紫外正胶 | ||
X AR-P 5800/7 | 深紫外曝光胶,正胶 | ||
SX AR-P 3500/6 | 全息曝光用胶,正胶 | ||
SX AR-N 4810/1 | 有机溶剂显影光刻胶(用于无水环境),负胶 | ||
SX AR-P 8100.04/1 | PPA直写胶 | ||
配套试剂
(Process chemicals)
类型 | 型号 | 特性 |
显影液 | AR 300-26, -35 | 紫外光刻胶用 显影液 |
AR 300-44,-46,-47, -475 | 紫外/电子束光刻胶用 显影液 | |
AR 600-50,-51,-55,-56 | PMMA胶用 显影液 | |
定影液 | AR 600-60,-61 | 电子束光刻胶用 定影液 |
除胶剂 | AR 300-70, -72, -73,600-70 | 紫外/电子束光刻胶用 除胶剂 |
稀释剂 | AR 600-01…09 | PMMA胶 稀释剂 |
AR 300-12 | 紫外/电子束光刻胶用 稀释剂 | |
增附剂 | AR 300-80, HMDS | 紫外/电子束光刻胶用 增附剂 |

报价:面议
已咨询1427次光刻胶

报价:面议
已咨询1263次光刻胶

报价:面议
已咨询2842次光刻胶

报价:面议
已咨询818次光刻胶

报价:面议
已咨询1138次光刻胶

报价:面议
已咨询577次光刻胶

报价:面议
已咨询534次光刻胶
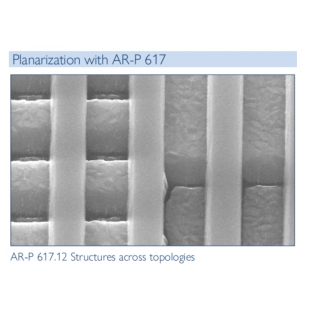
报价:面议
已咨询1668次光刻胶

IXION 193 SLM 是一款单频全固态激光系统,适用于光学计量、193 nm 步进光学元件校准或高功率 ArF 准分子激光器的带宽控制等应用。

IXION 193 SLM 是一款单频全固态激光系统,适用于光学计量、193 nm 步进光学元件校准或高功率 ArF 准分子激光器的带宽控制等应用。

ASML 光刻机 Twinscan NXT:1980Di

Syskey 紧凑式溅射系统 Compact Sputter,灵活的基板尺寸,最大可达6英寸,基板架加热温度最高可达500℃,出色的薄膜均匀性,误差小于±3%, 最多可配备5个6英寸磁控溅射源(可选配3或4个),支持射频、直流或脉冲直流电源,最多可支持3条气体管路,支持顺序沉积和共沉积。

Syskey 紧凑式热蒸发系统 Compact Thermal ,灵活的基板尺寸,最大可达6英寸, 基板架加热温度最高可达500℃,出色的薄膜均匀性,误差小于±3%,可选配电子束或热舟蒸发源(最多3个),速率控制沉积,可沉积多层薄膜,选用特定目标材料

高真空溅射系统 HV Sputter,灵活的基板尺寸,最大可达12英寸或200×200毫米, 基板架加热温度最高可达800℃,出色的薄膜均匀性,误差小于±3%

超高真空磁控溅射镀膜机 UHV Sputter,• 基板支架加热至 800 °C • 优异的薄膜均匀性小于 ±3% • 磁控溅射源(数量最多 8 个),可选强磁版本

Syskey 高真空热蒸发镀膜机HV Thermal 高真空热蒸发系统可提供的真空环境 用于常见薄膜沉积,包括金属、有机物、钙钛矿和化合物。全自动系统可满足各种应用要求,包括OLED、OPV、OPD等。